芯片级深度解读:IBM、3M合攻3D芯片市场
发布时间:2011-10-18 19:08
发布者:Liming

【OFweek电子工程网原创】:经历了近十年的半导体工程研究之后,3D集成电路有望于明年开始实现商业化。 过去几年,芯片制造商一直在改进可实现3D芯片互联的硅通孔技术(TSV)。现在TSV技术已经发展到可完成2D任务,比如将数据从平板芯片的正面传送到反面凸点,3D IC时代即将到来。 在去年冬天举行的国际固态电路会议(ISSCC)上,三星展示了其大力宣传的1Gb 移动DRAM。三星的2.5D技术使得DRAM晶圆叠层与TSV以及系统级封装上的微凸点紧密结合。 除此之外,赛灵思公司打算在今年秋推出一个multi-FPGA解决方案,采用一种封装工艺技术将四个并行的Virtex-7 FPGA通过硅转接板上的微凸点互相连接起来。台积电生产的硅转接板可通过TSV技术重新分配FPGA芯片的互联。台积电表示将于明年为其他代工厂客户提供可实现2.5D到3D过渡的技术。 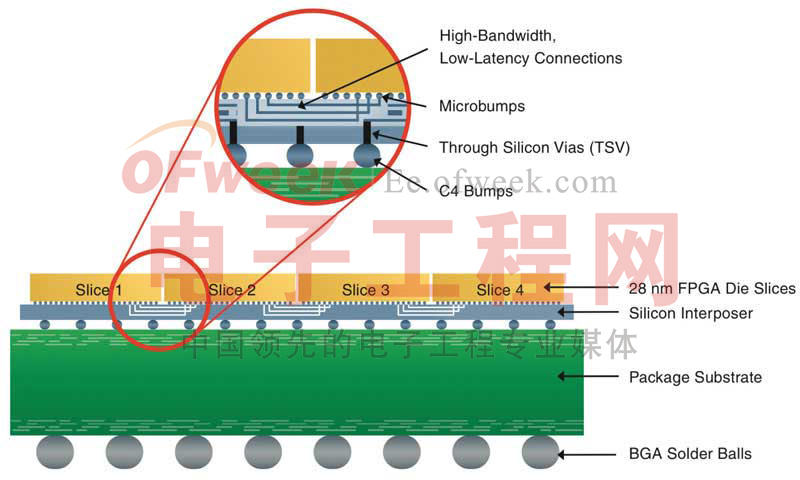
IBM最近透露公司正大量生产用于大容量移动设备中的发展成熟的3D IC,使用的是低密度TSV。IBM声称已经找到了影响3D IC发展的其它工程障碍,并期望能在2012年前全部克服。 IBM研究副总裁Bernard Meyerson表示:“如果仅单独依靠材料、芯片架构、网络、软件或集成中的一项,将不可能在3D IC领域获胜,我们必须将所有这些资源尽可能的利用起来。” 上个月,IBM宣布与3M合作开发一种粘接材料,解决3D IC的最后一个障碍:过热。3M将开发一种粘接材料,这种材料可以实现芯片密集叠放,导热性要比硅好,而且是电绝缘体。3M表示将在两年内使这种神奇的材料投入商用。 3M电子市场材料部技术总监程明(Ming Cheng)表示:“目前我们正在反复试验,希望在2013年前研发出适合商用的材料配方。” 一些分析师们表示不太相信IBM和3M的合作一定会引领他们到达3D IC领域的前端。 MEMS Investor Journal先进封装技术首席分析师Françoise von Trapp表示:“3M正在研发一种粘接材料,解决3D芯片堆叠的散热问题。这的确是3D IC实现量产前必须解决的问题之一,但我不认为这是解决所有遗留问题的最后关键。” 3D无处不在 IBM在3D IC领域的领先地位也并不是没有挑战的。Tezzaron Semiconductor公司多年来一直为其钨TSV工艺提供3D IC设计服务。Tezzaron的FaStack工艺能够用于生产厚度仅为12微米的3D芯片。 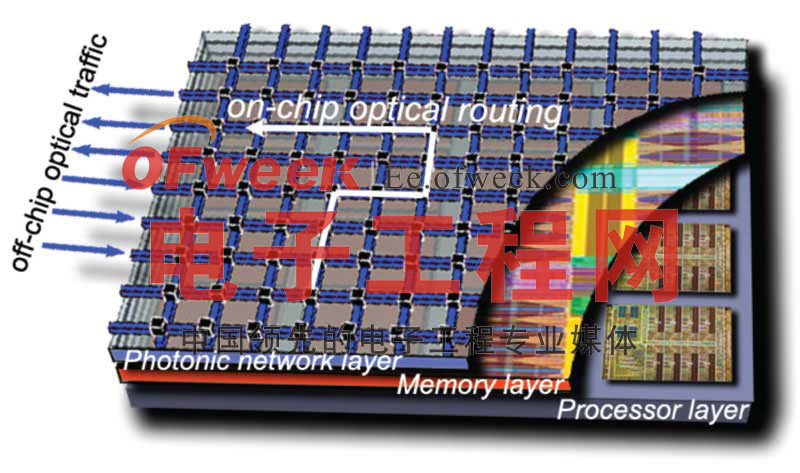
连续创业者Zvi Or-Bach认为,3D IC设计师应该将重点从TSV转向超高密度的单片型3D上。Or-Bach这么说并不意外,因为他的最新身份是IP开发商Monolithic 3D公司的总裁兼首席执行官。初创公司BeSang也声称将在2012年推出不需要依靠TSV的单片型3D存储芯片。 但是,如今工艺的最高水平是基于TSV的3D芯片叠放技术,而主要的半导体公司都一直致力于这一技术的研发。Envisioneering Group总监Richard Doherty表示:“IBM正通过与3M的合作来实现这一技术的突破,摆脱当前限制。但IBM在3D芯片领域的每一个进步都会激发三星、英特尔和TSMC等竞争对手的创造力,他们也有各自的3D芯片研发计划。” 3D IC的制造工艺并不是才有的,当前的努力是为了进一步改进。例如,目前很多CMOS成像器都采用TSV技术传送像素数据,而芯片堆叠这个想法本身也可追溯到1958年晶体管之父William Shockley获得的专利。从此之后,堆叠技术就得到了广泛使用,比如将一个微机电传感器叠放在ASIC上,或是将一个小DRAM叠放在处理器内核上,不过通常是采用丝焊技术进行芯片的互连。从丝焊向TSV技术的转变使芯片互联更紧密。 Doherty表示:“3D IC引出了许多关于芯片设计的新创意。现在设计师们可以将CPU、存储器和I/O功能以创新的方式结合起来。” 各半导体行业协会也正积极地为3D技术制定标准。国际半导体设备材料产业协会(SEMI)设立了四个工作组从事3D IC技术标准的制定。SEMI成立的三维堆叠集成电路标准委员会包括SEMI成员Globalfoundries、惠普、IBM、英特尔、三星、联电、Amkor、 ASE、 IMEC、ITRI、Olympus、高通、Semilab、东电电子以及赛灵思。 半导体制造联盟(Sematech)设立了一个3D芯片设计启动中心,其成员包括Altera、Analog Devices、LSI、安森美半导体和高通。另外,Sematech也在奥尔巴尼大学纳米科学与工程学院学院设有一条300mm 3D IC试点产品线。 Fraunhofer IZM也表示能在2014年前将处理器、存储器、逻辑、模拟、微机电系统和RF芯片集成到单片型3D IC中。 台湾工业技术研究所(ITRI)发起了一个拥有20个成员的3D IC联合。其中大部分成员可能在明年初提供端对端的3D IC代工服务。 9月,在台湾国际半导体展览会3D IC技术论坛上,英特尔声称正致力于3D芯片堆叠技术。同时,Elpida Memory公司表示与Powertech Technology和UMC在2Gb DRAM方面的合作取得进展。 联合电子设备工程委员会(JEDEC)也在为3D IC 制定Wide I/O标准,预计年底出台。JEDEC标准将可支持512-bit位宽的接口。 法国研究机构CEA-Leti与意法半导体以及另一家硅转接板厂商Shinko Electric Industries公司展开合作,推进2.5D到3D IC的过渡。他们目前正在一个300mm晶圆制造厂进行原型设计,有望于2012年初推出商业设计。 另外,欧洲的CMOSAIC项目正努力研究单片型3D芯片叠层散热的创新方法。这个为期4年的项目成员包括IBM苏黎世、洛桑联邦理工学院(巴黎)以及瑞士联邦理工学院(苏黎世)。 IBM、3M合攻3D芯片市场 IBM研究副总裁Bernard Meyerson表示,3M公司拥有3D芯片生产的技术平台。 在对3D IC的每一项器件技术进行了多年研究之后,IBM发现仍然缺少一种重要的材料,因此与3M合作共同开发。IBM表示,这缺少的重要材料是3D IC发展的一个关键障碍,是一种同时具备电绝缘性和导热性的粘接材料。 Meyerson指出,3M公司能够满足这种3D IC粘接材料的要求。 3M电子市场材料部技术总监程明表示,3M公司能改善粘合剂和聚合物的性能以满足各种相互冲突的需求。3M的粘合剂是由不同类型的聚合物、低聚物、单聚体、以及必要的助粘剂等组成,能够满足IBM的性能要求。 3M表示,公司尚未决定是否将这种3D IC粘合剂出售给其他芯片制造商。 3M与IBM的合作是于近期才宣布,而其实3M公司对3D解决方案的研究已经有一段时间了。 |






网友评论