гЂЬиЖћЃКНўШыЪНЙтПЬФмбгЩьЕН11ФЩУз
ЗЂВМЪБМфЃК2010-2-26 10:09
ЗЂВМепЃКЧЖШыЪНЙЋЩч
|
гЂЬиЖћЕФЯШНјЙтПЬКЭжЦдьВПЕФYan BorodovskyБэУї,гЂЬиЖћЯЃЭћEUVЛђепЮобкФЃЕчзгЪјЙтПЬФмзїЮЊ193ФЩУзНўШыЪНЙтПЬдк11 ФЩУзЕФКѓВЙеп,ВЂЩљГЦ11 ФЩУзПЩФмЗЂЩњдк2015ФъЁЃ BorodovskyБэЪО193nmНўШыЪНЙтПЬММЪѕПЩФмбгЩьЕНЗжБ№дк2011КЭ2013ФъЕФ22nmМА16nm жаЁЃ 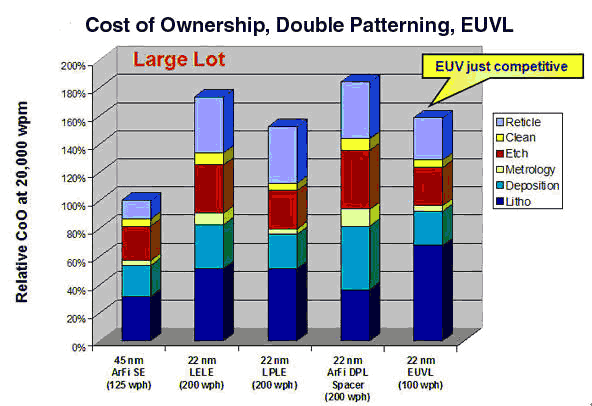
дкNikonЕФФъЛсЩЯаэЖрЦфЫќЕФзЈМвЫЦКѕЖдгкEUVЙтПЬвВгаЯрЫЦЕФПДЗЈЁЃШчNikonЕФЙтПЬЛњЩшМЦВПзмОРэMasato HamataniШЯЮЊ,ЕБEUVДяЕНЫљгаЕФдЄЖЈФПБъЪБ,НјШыСПВњПЩФмвЊЕН2019Фъ,МД16nmвдЯТЫЎЦНЁЃвђДЫEUVЖдгк22nmАыМфОрМКОЬЋГйСЫ,ЫљвджЛФмШУ16nmМАвдЯТЕФПЭЛЇЪЙгУЁЃДгСНДЮЦиЙтКЭEUVЙтПЬЕФГЩБОПДЕНEUVгыЦфЫќММЪѕЯрБШШБЗІОКељадЁЃ HamataniЬИЕНЖдгкEUVММЪѕДцдкВЛЩйЦфЫќЕФЬцДњЗНЗЈ,ШчЭЈЙ§бкФЃдДГЬађЕФзюМбЛЏКЭЖЈжЦееУїРДбгЩьЕЅИіЭМаЮММЪѕЁЃHamataniЫЕдкПЩЙЉбЁдёжЎжагаПЩЙЉ32nmАыМфОрМАвдЯТЕФЫљЮНМфОрСНДЮЦиЙт,pitch splittingСНДЮЦиЙт,ШчГЦжЎЮЊLELE,LFLEМАline cutting ЙтПЬММЪѕЁЃФмЙЛОЋШЗКЭЮШЖЈЕФЭМаЮВтСПЪЧЙиМќ,АќРЈЪЙгУЮЊСЫМѕЩйЮѓВюЕФДјИЩЩцвЧЕФБрТыЯЕЭГ,КЭEUVЯрБШНЯСНДЮЭМаЮЦиЙтБШНЯЪЁЧЎЁЃ Ш§аЧЕчзгЕФЪзЯЏММЪѕЙйJeong Ho YeoБэЪОЯЃЭћВЩгУСНДЮЭМаЮЦиЙтКЭEUVФмМЬајЕФАбДцДЂЦїЕФГпДчЫѕаЁЁЃYeoгжЫЕЫќЕФЙлЕуЪЧгЩгкГЩБОМАЭМаЮЕФИДдгад,ВЩгУЖрЪјаЮГЩЭМаЮзїЮЊвЛжжНтОіЗНАИПЩФмВЛЯжЪЕЁЃЮЊСЫНЕЕЭДцДЂЦїЩњВњжаЕФГЩБО,ЕЭГЩБОЕФСНДЮЭМаЮЦиЙтММЪѕЪЧгаЧАЭОЕФЁЃ дкСНДЮЭМаЮЦиЙтММЪѕжаCDПижЦЪЧИіЬєеН,ашвЊДгММЪѕЩЯШЅЭЛЦЦЁЃЭЈЙ§ЦНЬЈЙІФмЛђепФГаЉздЖдзМЗНЗЈПЩвдДяЕНЫљашЕФЬззМОЋЖШЁЃ YeoШЯЮЊEUVЙтПЬБЛжЄУїПЩДяЕНаЁьЖ20nmЕФЗжБцТЪ,АќРЈ4XDRAMЕФНгДЅВуЁЃЫфШЛШчДЫ,YeoЫЕЖдгкEUVММЪѕЩаЛЙгаШ§ИіЬєеНЁЃМДЮоШБЯнЕФEUVбкФЃ;ИпЙІТЪEUVЙтдДМАЯргІЕФЙтПЬНКЁЃдкДѓСПжЦдьЪБПеАзбкФЃЕФШБЯнУмЖШдк25nmrвЊЧѓ<0,003/cm2ЁЃЖјФПЧАзДЬЌШдгаБШНЯДѓЕФВюОр,дк18nmЪБЮЊ1/cm2ЫЎЦНЁЃЙигкЙтПЬНКЗНУц,дкаЮГЩ22mАыМфОр pitch ЭМаЮrЩаДцдкВюОр,ШчНКЕФЕЙЫњ,ЗжБцТЪ,LWR,ЗХЦјКЭСщУєЖШЁЃ NikonЕФзмОРэ Takaharu MiuraШЯЮЊEUVзїЮЊЮДРДЕФЙтПЬММЪѕЩаЮДОЭаї,БэЪОФПЧАЗЧГЃПЩФмЪЧВЩгУбгЩьArFi 193nmЕФСНДЮЭМаЮЦиЙтММЪѕЁЃЫћШЯЮЊзїЮЊвЛЯюДѓЩњВњвЊЧѓЕФЩшБИБиаывЊФмЙЛОпБИЖрДњЪЙгУЕФММЪѕФмСІЁЃдк22nmМА16nmАыМфОрЪБ,ОЕЭЗЕФNA вЊ>0,3,Жјдк16nmМА11nmАыМфОрЪБNAвЊ>0,4ЁЃЙигкEUVЕФЙтдДЮЪЬт,MiuraжИГіЯЕЭГБиаыФмЬсЙЉГЄЪБМфдЫааЕФПМбщЁЃдкбкФЃЗНУцЩагаДѓСПЮЪЬташвЊНтОі,ашвЊЬсЙЉЙтЛЏбЇЕФМьбщгыбщжЄЩшБИЁЃ NikonЕФдКЪПSoichi Owa,ЫќЯЃЭћНўШыЪНЙтПЬММЪѕ,дйМгЩЯЫФБЖМфОрКЭline cuttingЙтПЬФмбгЩьЕНSRAMЕФ10nmАыМфОрФмСІЁЃФПЧАЕФЬєеНЪЧЪЪКЯгкEUVЕФЙтПЬНККЭвђЮЊашвЊЖрДЮЦиЙт,ЫљвдБиаыМѕЩйбкФЃГЩБОЁЃЭЌrдкЙЄвеЙ§ГЬжаЕФМьВтЪЎЗжЙиМќЁЃ SynopsysЙЋЫОЙтПЬВПОРэKevin LucasШЯЮЊФПЧАЕФЙЄвеКЭЩшБИМКОЮЊМфОрЗжРыЕФСНДЮЭМаЮЦиЙтММЪѕзїКУСЫзМБИ,ЮоТлТпМЛђепДцДЂЦїВњЦЗ,гШЦфЪЧНгДЅМАЛЅСЌВужаЪЙгУЁЃШЛЖј,ЮЊСЫШЁЕУГЩЙІашвЊдіМгЩшМЦгыбкФЃжЦдьЕФзлКЯЁЃЫќШЯЮЊДгЩшМЦЙцдђЖдгкТпМКЭДцДЂЦїВЩгУСНДЮЭМаЮЦиЙтЖМЪЧПЩФмЕФЁЃЕБАбећИіаОЦЌНјааИДдгЖШКЭГпДчЗжНтДІРэжЎКѓ,LucasШЯЮЊНгзХOPCКЭбщжЄЖдгкСНДЮЭМаЮЦиЙтЕФГЩЦЗТЪЪЎЗжживЊЁЃВЩгУЪЪЕБЕФЩшМЦЯожЦЖрДЮЦиЙтЭМаЮФмНјвЛВНЫѕаЁГпДчЁЃ 
РДдДЃКSemiconductor International |


ЭјгбЦРТл