јСДЬ 3D јјКх i ПЯ№вҝМ»ъҪ«КөПЦҙуРНёЯГЬ¶ИІјПЯ·вЧ°өДБҝІъ
·ўІјКұјдЈә2022-12-16 09:55
·ўІјХЯЈәeechina
|
АҙФҙЈәITЦ®јТ РҫЖ¬ЦЖФмөДәЛРДЙиұёФтКЗ№вҝМ»ъЎЈ№вҝМ»ъНЁ№э·ў№вҪ«№вСЪДӨЙПөДНјРОН¶ЙдФЪ№иЖ¬ЙПЈ¬ЦЖЧчіЙРҫЖ¬ЎЈЛжЧЕРҫЖ¬ҫ«ГЬіМ¶ИФҪАҙФҪёЯЈ¬№вҝМ»ъФЪ№иҫ§ФІЙПЦЖФміц°лөјМеРҫЖ¬өДЗ°өА№ӨТХЦ®әуЈ¬ОӘұЈ»ӨРҫЖ¬І»КЬНвІҝ»·ҫіөДУ°ПмЈ¬»№РиТӘПИҪшөД·вЧ°№ӨТХЈ¬ХвТ»ҪЧ¶Оұ»іЖОӘәуөА№ӨТХЎЈ ФЪәуөА№ӨТХЦРЈ¬ёЯГЬ¶ИөДПИҪш·вЧ°І»Ҫц¶Фҫ«ПёІјПЯТӘЗуёЯЈ¬¶шЗТ»№РиТӘНЁ№э¶аёц°лөјМеРҫЖ¬ҪфГЬПаБ¬өД 2.5D јјКх ј°°лөјМеРҫЖ¬ІгөюөД 3D јјКхАҙКөПЦЎЈ ОӘҙЛЈ¬јСДЬҪ«УЪ 2023 Дк 1 ФВЙПС®·ўКЫ°лөјМе№вҝМ»ъРВІъЖ· ЎӘЎӘi ПЯІҪҪшКҪ№вҝМ»ъЎ°FPA-5520iV LF2 OptionЎұЈ¬НЁ№э°лөјМеРҫЖ¬Ігөю¶шКөПЦёЯРФДЬөД 3D јјКхЈ¬ВъЧгҝН»§¶аСщ»ҜЎўёЯРФДЬРиЗуөДН¬КұЈ¬ЦъБҰҝН»§ҪөұҫФцР§ЎЈ 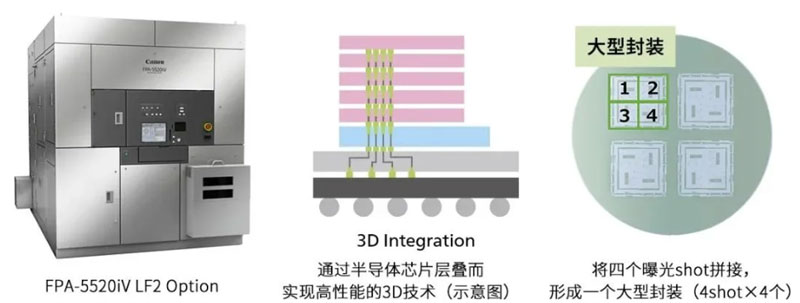
ОӘБЛјхЙЩН¶Йд№вС§ПөНіөДПсІоЈ¬РВІъЖ·КЧҙОҪ«УҰУГУЪЗ°өА№ӨТХ№вҝМ»ъөДРЈХэ·ЗЗтГжІЈБ§ҙоФШФЪәуөА№ӨТХөД№вҝМ»ъЙПЎЈУлТФНщ»ъРНЎ°FPA-5520iV LF OptionЎұПаұИЈ¬РВІъЖ·өДПсІоҝЙҝШЦЖЦБЛД·ЦЦ®Т»ТФПВЈ¬ёьЖҪЛіөШКөПЦ shot јдөДЖҙҪУЎЈ 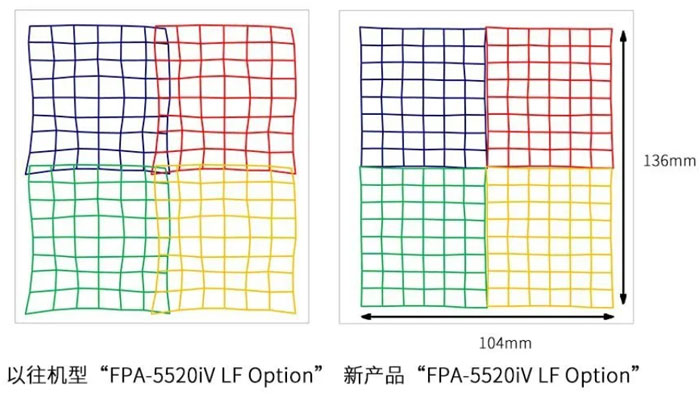
ұдПсПсІоөДёДЙЖЈЁКҫТвНјЈ© Н¬КұРВІъЖ·¶ФҫщЦКЖчҪшРРёДБјЈ¬ДЬ№»МбЙэХХГч№вС§ПөНіөДХХ¶ИҫщТ»РФЈ¬КөПЦ 52ЎБ68 mm ҙуКУіЎЦР 0.8ҰМmЈЁОўГЧЈ©өДі¬ёЯҪвПсБҰЎЈҙЛНвЈ¬РВІъЖ·ДЬ№»НЁ№эЛДёц shot өДЖҙҪУЖШ№вЈ¬КөПЦ 100ЎБ100mm ТФЙПөДі¬ҙуКУіЎЈ¬ҙУ¶шКөПЦ 2.5D әН 3D јјКхПаҪбәПөДі¬ҙуРНёЯГЬ¶ИІјПЯ·вЧ°өДБҝІъЈ¬ҪшТ»ІҪНЖ¶Ҝ 3D ·вЧ°јјКхөД·ўХ№ЎЈ 
ЖШ№вКУіЎКҫАэ ITЦ®јТБЛҪвөҪЈ¬РВІъЖ·јМіРБЛ°лөјМе№вҝМ»ъЎ°FPA-5520iVЎұөД¶аПо»щұҫРФДЬЎЈАэИзҝЙТФБй»оУҰ¶ФФЩ№№іЙ»щ°еЗМЗъөИФЪ·вЧ°№ӨТХЦР¶ФБҝІъФміЙЧи°ӯөДОКМвЈ¬ТФј°ФЪРҫЖ¬ЕЕБРЖ«ІоҪПҙуөДФЩ№№іЙ»щ°еЙПІвіц Alignment markЈ¬ҙУ¶шМбёЯЙъІъР§ВКЎЈ Ўс РВІъЖ·јМіРБЛЎ°FPA-5520iVЎұЦРКөПЦөД»щұҫРФДЬЎЈ Ўс РВІъЖ·ҙоФШБЛУҰ¶ФҪПҙуЗМЗъОКМвөД»щ°е°бФЛПөНіЈ¬ҝЙБй»оУҰ¶ФДҝЗ°УҰУГУЪТЖ¶ҜЦХ¶Л·вЧ°өДЦчБчјјКх ЎӘЎӘFOWLPЎщ6 ЦРҙжФЪөДФЩ№№іЙ»щ°еіцПЦҪПҙуЗМЗъөДОКМвЈ¬ХвТ»ОКМвТІКЗКөПЦБҝІъөДЧи°ӯЎЈ Ўс РВІъЖ·ҙоФШБЛҙуКУТ° Alignment scopeЈ¬Хл¶ФРҫЖ¬ЕЕБРЖ«ІоҪПҙуөДФЩ№№іЙ»щ°еЈ¬ТІҝЙТФІвіц Alignment markЎЈ Ўс РВІъЖ·ҝЙККУГУЪТФРҫЖ¬ОӘөҘО»ҪшРР¶ЁО»ІўЖШ№вөД Die by Die Alignment јјКхЎЈ 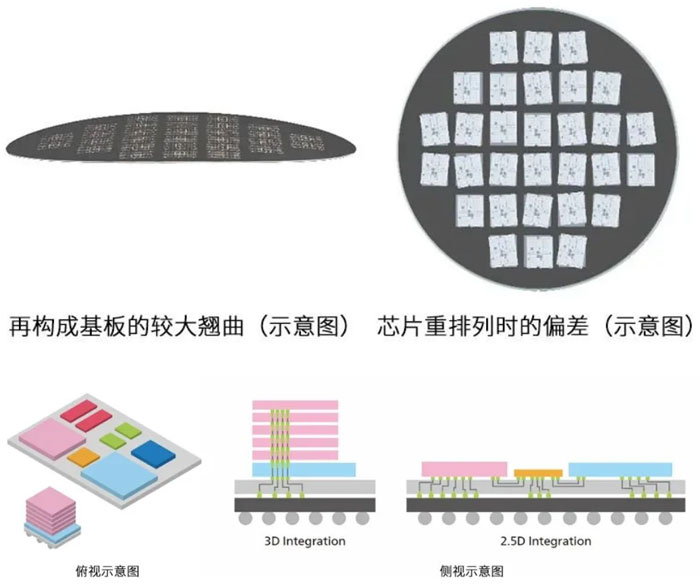
КІГҙКЗ°лөјМеЦЖФмөДәуөА№ӨТХ ФЪ°лөјМеРҫЖ¬өДЦЖФм№ӨТХЦРЈ¬°лөјМе№вҝМ»ъёәФрЎ°ЖШ№вЎұөзВ·Нј°ёЎЈФЪЖШ№вөДТ»ПөБР№ӨТХЦРЈ¬ФЪ№иҫ§ФІЙПЦЖФміц°лөјМеРҫЖ¬өД№ӨТХіЖОӘЗ°өА№ӨТХЎЈБнТ»·ҪГжЈ¬ұЈ»Өҫ«ГЬөД°лөјМеРҫЖ¬І»КЬНвІҝ»·ҫіөДУ°ПмЈ¬ІўФЪ°ІЧ°КұКөПЦУлНвІҝөДөзЖшБ¬ҪУөД·вЧ°№ӨТХіЖОӘәуөА№ӨТХЎЈ |




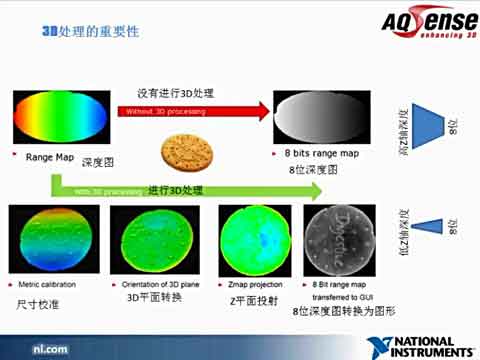


НшУСЖАВЫ