美光采用3D混合技术将内存传输速度提升15倍 功耗降低70%
发布时间:2011-12-7 08:11
发布者:eechina
|
IBM近日表示,美光的混合存储立方体(HMC)将成为第一个采用IBM TSV(through-silicon via;过孔硅)工艺的商业化CMOS制造技术。 IBM在一份声明中称,IBM的3D芯片制程TSV芯片制造技术能使美光的混合式存储立方体的传输速度达到当前技术的15倍。该产品部分组件将会在IBM位于纽约的晶圆厂生产,使用该公司32纳米high-K金属栅极工艺制造。IBM将会在12月5日于美国华盛顿举行的IEEE国际电子装置会议上展示它的TSV工艺技术。 美光的混合式存储立方为DRAM封装的一项突破,它的基本理念是将芯片层层叠起,较当前技术用到更多且速度更快的数据通路。 其最初的原型能以每秒128GB的速率执行,未来技术成熟后速率会更高,而目前的存储器芯片的速率为12.8GB/s。此外,HMC使用的电力也减少了70%。 |




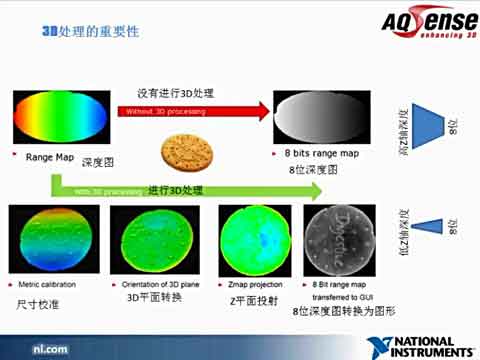


网友评论