2023 半导体制造工艺与材料论坛 —重塑供应链,从异构集成和Chiplet说起!
发布时间:2023-8-30 10:22
发布者:eechina
重塑供应链,从异构集成和Chiplet说起!
随着摩尔定律逐步逼近物理极限,行业很难再通过将晶体管数量翻倍来实现芯片性能的跃升,许多企业开始尝试从封装和板级、系统级等角度寻找新路径来实现摩尔定律的延续。在此趋势下,具有高性能、低功耗、高面积使用率以及低成本优势的Chiplet(芯粒)技术越发受到重视。据Omdia数据显示,预计到2024年,全球Chiplet市场将达58亿美元,而这一数字到2035年将发展至570亿美元。 在此背景下,荣格工业传媒将于9月14日在上海召开2023半导体制造工艺与材料论坛。从异构集成和Chiplet谈起,邀请Fabless,晶圆厂,OSAT,设备材料商齐聚一堂,围绕关键工艺、设备材料、封装测试领域的市场现状、前沿技术、发展瓶颈、国产替代进程等重要话题展开讨论。 热点议题: 主持嘉宾 沈磊,副总经理,上海复旦微电子集团股份有限公司副总经理、复旦大学博士生导师 趋势篇 半导体产业趋势及国产替代机遇与挑战 —Chiplet及异构集成工艺的发展空间及其对半导体产业链的影响 —布局先进封装的技术积累、潜在应用场景以及待攻克的难点 赵晓马,合伙人,灼识咨询 封装篇 展望下一代封装:异构集成如何助力性能、成本效益和小芯片数量的指数级增长? —异构集成工艺影响下先进封装技术的发展 —面向5G、HPC 汽车电子、物联网、AI等应用的先进封装技术 —2.5D/3D封装、Chiplet、系统级封装(SiP)、晶圆级封装(WLP) 孙鹏,总经理,华进半导体封装先导技术研发中心有限公司 吕书臣,副总经理,江苏中科智芯集成科技有限公司 张中,副总经理,江苏芯德半导体科技有限公司 设计篇 异质集成技术设计思考与技术探索 —半导体晶片级和封装级可靠性测试和失效分析解决方案 —多架构融合的XPU架构 —Chiplet领域EDA进展 —三维封装集成技术工艺、电、热、机械仿真设计 代文亮,联合创始人、高级副总裁,芯和半导体 紫光展锐/士兰微电子/韦尔半导体 设备篇 先进制造工艺&装备技术助力半导体产业升级 —半导体核心微纳加工工艺技术进展:光刻、薄膜沉积、刻蚀、CMP、清洗 —光刻技术突破:2.5D/3D先进封测光刻技术 —发展EUV光刻技术的难点、挑战和进展:光源、光学系统、全套设备 —未来智汇注塑展望 王骏,全国业务发展经理,奇石乐精密机械设备 (上海) 有限公司 张轶铭 博士,北方华创 检测篇 Chiplet和异构集成时代芯片测试的挑战与机遇 —光学测量在半导体行业产品介绍和应用 嘉宾待公布,马波斯 (上海) 商贸有限公司 —Chiplet测试技术与标准 罗军 博士,工业和信息化部电子第五研究所 生产篇 半导体集成电路芯片特色工艺的研发和生产制造 —晶圆厂智造升级,绿色生产实践 中芯/华宏/积塔半导体 材料篇 异构集成对半导体材料的要求 —适用于系统级封装(SiP)、堆叠封装、异构集成等新型封装架构的先进封装材料解决方案 —集成电路领域化学机械抛光液 —大尺寸硅片、先进光刻胶、聚酰亚胺、底部填充胶、高端塑封料、电镀液、键合胶等 —基于智能剥离技术的化合物半导体异质集成材料与器件 游天桂,研究员,中国科学院上海微系统与信息技术研究所 安集微电子/上海新昇半导体/新阳半导体 赞助商: 
报名链接: https://cgi.industrysourcing.cn/u/utEZF4 
联系我们: Ms. Lily Pan 电话:021-62895533-130 邮箱:lilypan@ringiertrade.com 会议网址:https://hdxu.cn/aa9s5 |




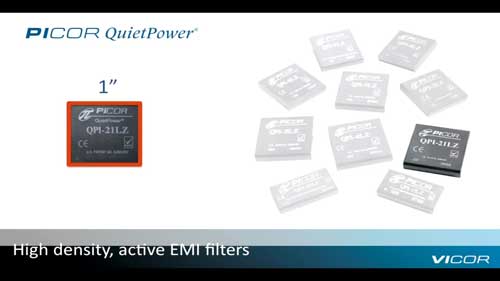


网友评论