边界扫描SRAM簇板级互连测试研究
发布时间:2010-8-30 12:12
发布者:techshare
|
1 引言 边界扫描技术已成为了VLSI和ASIC测试的重要方法,但是,尽管边界扫描器件越来越多,非边界扫描器件仍然大量存在。在复杂电路设计中,VLSI和ASIC虽然能够完成电路的许多功能,但并不是所有的逻辑功能都可以集成,相当多的功能仍需要采用分离器件或通用集成电路实现,而它们很少支持边界扫描。因此,由边界扫描器件和非边界扫描器件组装的非完全BS器件电路板仍将在今后相当长时间内广泛存在,它们的测试问题已成为板级边界扫描测试技术需要研究的关键问题。随机存取存储器(RAM)是一种应用极为广泛的电子元件,但由于成本和结构复杂性的原因,RAM的的设计很少包含边界扫描结构,设计中也无法用其他器件所替代。 RAM可分为动态(DRAM)与静态(SRAM)两种。本文以静态SRAM为研究对象,在定义 SRAM簇的电路模型和互连故障模型的基础上,利用"虚拟数据通道"测试方法,对多驱动冲突和SRAM簇的控制线、地址线和数据线之间的板级互连故障进行分析和研究,从而提出一种更优化的测试向量生成算法,并将此算法运用于测试程序产生测试图形序列。这些测试图形序列不仅易于产生,而且有短的测试序列和高的故障覆盖率。 2 SRAM簇板级测试的基本原理 文献中提出了一种测试RAM的I/O完整性的测试序列:首先写入走步"1"的测试向量到指定地址000…000,100…000,…,000…010,000… 001,然后从各地址读回相应写入的值。文献则提出了检测RAM数据线和地址线的互连故障的测试条件,通过对这些测试条件的合并和对地址、数据线互连故障测试的组合,提出了一种新的测试算法。这种算法在文献中带有边界扫描结构的RAM簇测试的示例中已有应用。但是,上面所提到的方法都没有涉及到数据线和地址线之间的桥接故障,没有考虑BSC的多驱动冲突。下面,我们将综合上述文献的测试条件和测试矢量的优点,研究数据线和地址线之间桥接的测试条件,并确定一般性的测试条件和禁止条件,开发一个完备的SRAM簇测试矢量算法。这种算法产生的测试矢量具有以下优点: ① 能够避免多BSC驱动冲突; ② 能够覆盖所有可测SRAM互连故障; ③ 测试序列短。 下面,首先提出SRAM簇的电路模型和故障模型,然后讨论数据线、地址线、控制线以及数据线和地址线之间的固定(开路)、桥接测试条件和相应的禁止条件,这些禁止条件描述了那些不能被插入到下面所描述的测试条件中去的测试图形。最后,通过对这些测试条件和禁止条件的重新排列和组合,在综合分析的基础上得到测试矢量的具体构成,提出了一种测试算法和相应的测试图形生成程序。 2.1 SRAM簇互连测试的电路模型 一种典型的SRAM簇的互连电路模型如图1所示。它包括:1、地址线(Am-1 ,…,A1,A0),可由2态或3态BS单元驱动;2、数据线(Dn -1,…,D1,D0 ),数据线为双向并由双向BS单元驱动;3、控制信号,包括芯片使能(CE),输出使能(OE)和写使能(WE),它们由2态或3态BS单元驱动。SRAM簇的每一个互连节点都可由多个3态的BS单元来驱动,需注意的是存在这种多驱动的情况下,必须要求任何时刻只能有一个3 态的BS单元的输出使能控制端有效,其他不能使能,以避免多驱动冲突。在本文中,我们假设只有一片SRAM,对于有多个与同一地址总线和数据总线相连的存储器芯片组成的存储器组件,只需对每一芯片分别进行互连故障测试即可,同时假定SRAM的内部逻辑无故障。 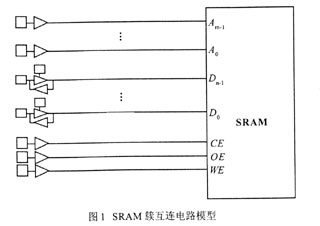 在SRAM簇的互连测试里,存储器的读写操作是通过边界扫描的"虚拟通道"来实现激励与采集,运用一组合适的测试图形序列输入到边界扫描单元中去控制地址线、数据线和控制线实现读写。图2为SRAM簇测试时实现一个SRAM的读(READ)写(WRITE)周期时序。 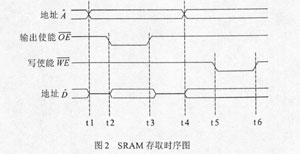 存储器读写信号都由写使能WE控制,WE为高电平时进行读操作,为低电平时进行写操作。同时规定地址信号、OE信号与WE信号不得同时改变。如图2所示,t1、t2和t3为一个读周期,t4、 t5和t6为一个写周期。 SRAM的读写操作的测试图形序列如表1所表示。表中DR表示从SRAM中读取的数据值,A和D分别表示所写数据单元的地址向量和所写数据向量,X表示任意值。本文正是按照一定的测试算法来产生SRAM簇的互连测试的测试图形。这些测试图形不仅能满足下面所描述的故障测试条件,而且能满足故障覆盖和避免多驱动冲突。  2.2 故障模式和测试条件 SRAM簇的互连故障有呆滞故障、开路故障以及在地址线、数据线和控制线间的桥接故障。SRAM簇的互连故障检测的基理是将一组测试向量的序列首先写入SRAM,读出SRAM簇的响应序列,通过分析得到互连网络上的故障行为。下面讨论是按单一故障模式分别进行,且开路故障为呆滞故障S-A-1 或S-A-0,桥接故障为"线与"或"线或"。四元组(RD,A,DR,[DE])代表对地址A的一个读操作,读取的数据值为DR,期望数据是 [DE];一个三元组(WR,A,D)代表了一个写操作,即在地址 写入数据。 和代表包含多位的向量,Ti ,j代表 的第j位。 2.2.1 地址线 (1)地址线i呆滞为v(开路)的故障测试  iii),(RD,A1,DR,[D1])若地址线i呆滞为v,则DR≠D1。 禁止条件 a) 在i)和iii)之间不允许有其他(WR,A1,D),其中D=X; b) 在ii)和iii)之间不允许有(WR,A2,D1 )    容易验证,走步"1"或"0"序列能满足以上地址线的呆滞和桥接故障的测试条件。 2.2.2 数据线 (1)数据线i的呆滞为v (开路)故障的测试 ● 测试条件 ii) (RD,A1,DR,[D1]),若数据线i呆滞为v ,则DR≠D1。 ● 禁止条件 i)和ii)之间不允许(WR,A,D),其中D=X。 (2)数据线i与数据线j 的桥接故障的测试  ii) (RD,A1,DR,[D1]),若数据线i与数据线j桥接,则DR≠D1。 ● 禁止条件 在i)和ii)之间不允许(WR,A,D1),其中D=X。 同样容易验证,在数据线上使用计数序列和走步"1"或"0"序列同样能够满足以上数据线呆滞和桥接故障的测试条件。 (3)地址线i和数据线j 之间的桥接桥接故障 数据线和地址线之间的桥接故障的测试较为复杂。我们同样假设数据线和地址线之间的桥接为"线与"或者为"线或"。这时只要保证两桥接线上的测试图形互补,再通过读出数据判断故障。用走步"1"序列测试"线或"桥接,用走步 "0"序列测试"线与"桥接故障,连续使用这两种序列即可满足故障覆盖。 ①地址线i电平占优,地址线 i与数据线j之间的桥接故障测试。 ● 测试条件  ii) (RD,A1,DR,[D1]),若地址线i为v占优与地址线 j桥接,则DR≠D1。 ● 禁止条件 i)和ii)之间不允许(WR,A1,D1),其中D=X ②数据线j电平占优,数据线 j与地址线i之间的桥接故障的检测  ● 禁止条件 a) (WR,A1,D)无可满足测试条件i)和iii),其中D=X; b) (WR,A2,D1)无可满足测试条件i)和iii)。 2.2.3 控制信号线 控制信号线上的故障包括控制信号的呆滞(开路)故障以及控制信号线和地址线或数据线的成对桥接故障。控制信号除OE和CE为S-A-0不影响SRAM的正常读写操作而无法检测故障外,控制信号线上的其余故障都将导致从SRAM读出的数据是任意的,或者在整个测试过程中只读出一个数据。这种故障检测比较容易,但不易确定其原因。 按照上述故障模式分类,并赋予相应的测试条件后,除控制信号CE和OE上的S-A-0的故障不能检测外,在数据线和地址线上的任何故障都能被检测。 2.3 测试算法的设计 由于SRAM一般都有很规则的结构,再考虑到在地址线和数据线上同时存在故障的测试条件,我们提出一种在SRAM簇的互连测试中易于产生的测试序列。假设SRAM的地址线和数据线的宽度分别为m和n,p、q分别代表 m和n的较大者和较小者。用0(1)表示全0(1)向量;=[h1 ,…,hW]表示一个宽度为w的one-hot vector,(hk=1,hi =0, ≠ k), 与互补。于是我们用下面的算法程序描述测试序列的生成和故障检测过程:  通过对此程序产生的测试序列去验证上述故障分类下的测试条件和禁止条件可以看出,此算法能够检测有 m位地址线和n位数据线的SRAM簇的所有可检测互连故障。而且这些测试序列也很容易由测试程序来产生。地址和数据可分别由一个m阶和 n阶的OHC来产生。OHC的输出端Q/Q提供所需的one-hot/cold 向量。 3 实验结果 下面以一个具有四位地址线和四位数据线的 SRAM为例,简单介绍测试地址线呆滞、桥接故障的过程。按照以上的测试条件与禁止条件,测试生成的过程可描述为:首先,在地址全"0"处写数据全"1",在地址全"1"处写数据全 "0",在地址走步"1"处写数据走步"0",在地址走步"0"处写数据走步"1";然后通过边界扫描链路得到响应矩阵;通过响应矩阵计算出故障矩阵,故障矩阵中"1"表示有故障,"0" 表示无故障。 "如表所示,若地址线A2固定为0,则在地址全"0"处所读出数据被地址"0100"处所写数据覆盖,在地址全"1"处所读出数据被地址 "1011"处所写数据覆盖,其故障矩阵只有F2 的地址全"0"和地址全"1"行对应数据为1。由此,可判断故障为地址线A 2固定为0。 桥接故障在本文中分为"线与"和"线或" 两种,前者0占优,后者1占优。若地址线A2与 A3发生"线与"桥接故障,0占优,则其响应矩阵和故障矩阵如下表所示。地址?quot;0"与"1000"处所读出数据被地址"0100"处所写数据覆盖,地址全 "0111"处所写入的数据被地址"1011"处所写数据覆盖,对应故障矩阵F 2与F3共有五处值为1,若数据线全"1"与走步"0" 对应故障矩阵中"1"的数目比数据线全"0"与走步"1"对应故障矩阵中"1"的数目多,则为0占优"线与"桥接故障,否则为1占优"线或"桥接故障。由此可判断表2中地址线A 2与A3发生0占优"线与"桥接故障。"线或"故障在故障表中的表现类似,可同样判决。" 数据线故障的诊断定位比地址线更为简单,限于篇幅,数据线与数据线、地址线与数据线、控制线之间的桥接故障与多故障测试在此不做详细讨论,读者可按类似方法分析。 4 结论 本文首先通过对SRAM簇的故障模型和对应测试条件进行定义,在进行综合分析的基础上创建了它在硅缺陷的分析当中有重要的作用,它能够直接观察缺陷的形态、分析缺陷的成分以及缺陷-缺陷的相互作用等等。它为我们分析研究硅缺陷提供了一种行之有效的手段。 |



网友评论