DELO开发出具有最佳流动特性的粘合剂,可应用于芯片顶部包封
发布时间:2016-11-9 10:58
发布者:eechina
|
德路(DELO)工业粘合剂有限公司开发出具有最佳流动特性的粘合剂,可应用于顶部包封。这一产品在芯片表面形成薄而均匀的涂层(厚度小于100 µm),且不会从芯片边缘溢出。 微电子封装的“小型化”,尤其是微机电系统(MEMS)封装技术不断取得进步,从而对采用的顶部包封材料提出了更高、更新的要求。例如,现在的移动电话生产商要求MEMS封装的高度不得超过0.6毫米。这意味着用于覆盖芯片顶部的模压涂层材料越薄越好。德路公司采用的加热固化丙烯酸酯表现出令人信服的结果。它最突出的性能是均匀且可靠地覆盖芯片顶部,且不会从芯片边缘溢出。 不仅仅是一种粘合剂 德路研发的这种粘合剂具有低粘度与特殊的流动性。因此可以采用喷射方式进行高效率加工。与传统模压涂层材料不同的是,这种新粘合剂只需寥寥几滴,即可形成厚度小于100 µm的均匀、平坦的涂层。此外,该产品柔韧性较高(肖氏硬度为A60),从而减轻了芯片和线芯承受的应力。 除了涂层厚度低以外,这种黑色的粘合剂还有一大优点:它不仅能够保护/保存芯片的表层,还可覆盖芯片顶部的逻辑结构。由于这种特殊的颜色,粘合剂即使是在涂层特别薄时候也能良好的覆盖到芯片边缘和角落。使用这种粘合剂还有一个好处:它的流动特性良好,可以覆盖各种式样的芯片。 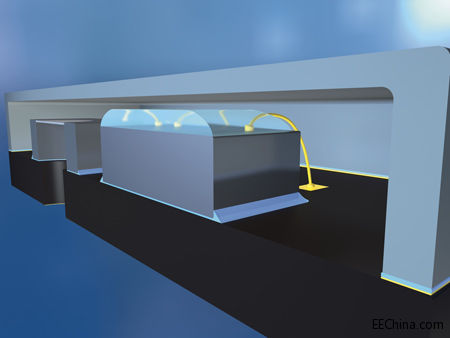
新研发的模压涂层材料可以形成厚度小于100µm的涂层 |


网友评论