可穿戴制造难点与趋势:微型元器件组装工艺
发布时间:2015-6-11 09:43
发布者:designapp
|
智能手表(Smart Watch)、智能眼镜商机应用势头正快速崛起,智能可穿戴产品毫无疑问已成为最热门的电子产品之一。可穿戴技术推进了人类生活的智能化、特别是移动健康、移动医疗技术的发展,与之相对应的各类元器件的设计也越来越微型化、结合FPC主板生产组装与整机装联应用,更成为电子制造业的热点与难点。 日前在NEPCON China 2015展“智能可穿戴论坛”上,关注焦点就定格在了智能可穿戴设备的制造挑战与应对趋势上。对于智能可穿戴产品的新特点,众多与会专家表示,内部元器件的微小型化、高集成度特点增加了电子制造的难度。中兴通讯股份有限公司物流体系工艺研究部总工刘哲表示:“智能可穿戴产品的出现使产品组装面临高密度、微型化的新挑战。其中包括裸晶圆(‘Naked’dies)、元器件堆叠(3D封装/PoP)、集成埋入式元件、更小的元件间隙、更好的构造以实现基板更小等特点,使元器件的微小型化和高密度组装受到工程师们的广泛重视。我们可以看到目前诸如01005微型元器件已大量使用在新型的智能手机和可穿戴产品中,而03015也已实验应用,相信不久就会出现在具体产品中。WLCSP等微型器件的大量应用、FC与PoP技术的应用、以及趋势性的埋入式技术的应用都对产品组装难度,工艺难点提出新要求。”  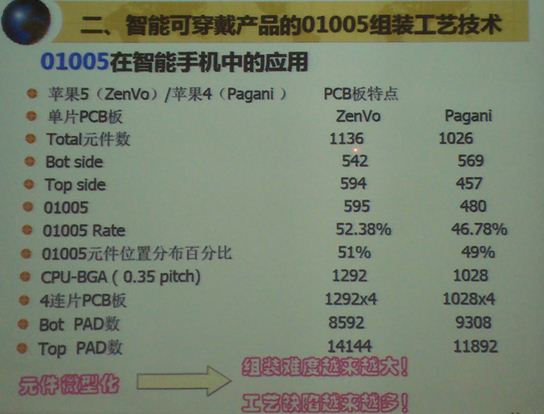 针对微型元器件的组装工艺与技术趋势,刘总工谈到了01005组装工艺技术、WLCSP组装工艺技术、FC组装工艺技术及埋入式技术,对智能可穿戴产品制造的影响及具体技术实现。“无源器件的尺寸变小已是绝对趋势,新型的极限尺寸将会达到0402、03015、0201(公制),目前公制03015元件正在评估做应用导入。”刘哲认为对于01005元件的成功组装,最优化设计及DFM的主要因素可包括:PCB或FPC的拼板尺寸、焊盘尺寸及形状、基准识别点、阻焊膜工艺及厚度;元件的料带精度,焊锡膏型号(Type4或Type4.5)及品质;钢网的制作及开孔工艺,载板治具的设计和制作精度,搞好FAI&CPK的管控;在机器设备方面,印刷机、贴片机精度(+/-0.05mm)、吸嘴的保养及Feeder,制程能力(CPK)应不低于B级(1.33>CPK>=1.0)等诸多方面。  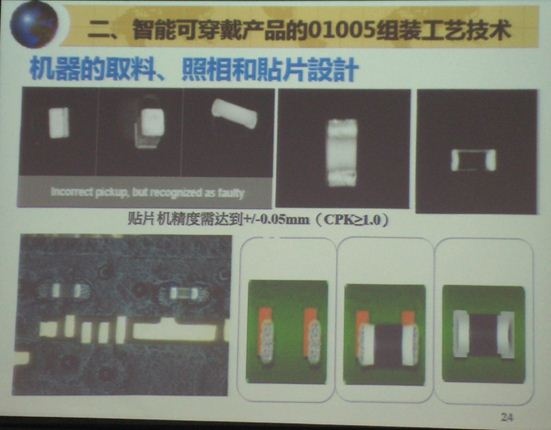 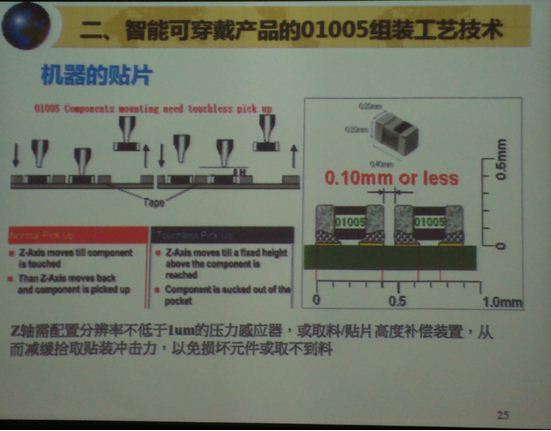 针对WLCSP封装,刘哲认为:“WLCSP封装是穿戴设备的核心组件,其设计和组装要充分考虑可靠性要求,需要情况采用Underfill以提高组件的长期可靠性。 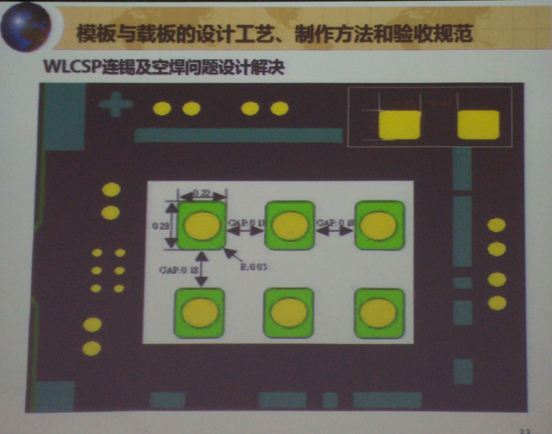 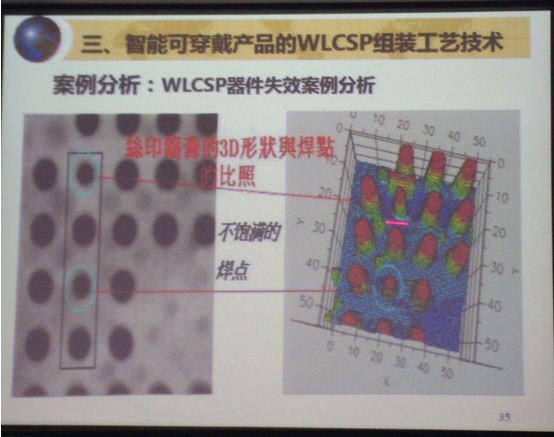 FC(Flip Chip 倒装芯片)是裸芯片封装技术之一,对于FC的组装工艺技术,刘哲表示,“FC是芯片互连技术,也是理想的芯片粘接技术。FC向制造者提出了一系列严峻挑战,为这项复杂的技术提供封装、组装及测试的可靠支持。超声热压焊可适用在金凸点与镀金焊盘的组合,可缩短加工处理时间,也会面临可靠性的缺陷。” 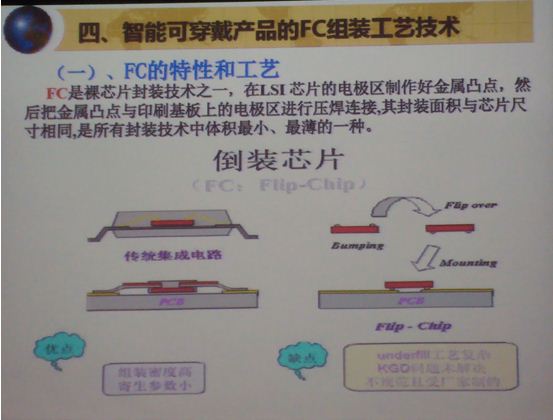  埋嵌式技术是智能可穿戴产品发展趋势性技术,主要包括埋嵌电阻、电容、电感及裸芯片等四类技术。据刘哲介绍:“埋嵌无源和有源器件集成PCB可以实现元器件的三维布局设计,在同面积布置更高密度的元器件,具有更高集成密度、提高可靠性、符合整机系统低成本、微小型化的要求。需要考虑设计、组装、加工的整合统一。”   对于参与或是想要参与可穿戴产品设计制造的工程师们,刘哲最后给出建议:“可穿戴产品的引入是一个结合点,是封装技术、PCB加工技术、SMT等相关技术的结合,使工程师们的专业界限变得模糊,我们需要成为整合PCB、SMT和封装各类技术支持的工程师。只有这样才能在可穿戴产品的制造过程中更游刃有余。” |


网友评论