ARM讨论14nm工艺挑战 英特尔探路10nm
发布时间:2012-9-21 15:25
发布者:李宽
|
作者: Peter Clarke, Rick Merritt ARM宣布将在今年10月底的ARM TechCon展会中探讨14nm工艺面临的挑战,来自IBM的工程师Lars Liebman和ARM资深研发工程师Greg Yeric都将在会中发表演讲,共同探讨这个业界瞩目的议题。 ARM的演讲将探讨IC定义所需的图形化以及在涉及非平面架构时的困难程度,同时也将讨论超紫外光(EUV)微影技术,并解释在EVU到位以前,如何将双重图案运用光学微影技术来弥合技术差距。另外也将讨论到多重图案的复杂性。 ARM将在这次活动中探索14nm节点时芯片的功耗、面积及成本。另外,活动中也将针对FinFET的基本原理,以及FinFET对实体IP和更高层处理器IP的影响。也就是说,会中还将讨论FinFET将对即将到来的ARM处理器核心及其周边带来哪些影响。 英特尔探路10nm 英特尔技术制造部总监Mark Bohr则是在稍早前的英特尔开发者论坛(IDF)中表示,已经找到采用浸入式微影技术来开发10nm工艺的方法,这家芯片制造商预计在2013年底开始14nm工艺生产芯片。 10nm制程预计在2015年或以后首度亮相。该制程的某些光罩将会需要四重图形(quadruple patterning),但“它仍具经济性,”Bohr强调。 Bohr并未透露英特尔的14nm或10nm工艺计划细节,仅强调了技术上的可行性。 一直以来,英特尔都致力于开发超紫外光(EUV)微影技术,最近也加入ASML的41亿美元投资计划,以推动该技术发展。“对我们而言,EUV相当重要,这就是为何我们投资ASML的主要原因,但我们仍然有许多选择,包括采用多重图形的浸入式技术等,”Bohr说。 英特尔预计,在14nm至少某些层将需要双重图形。若在10nm使用浸入式技术,则会有更多层需要双重图形,有些甚至会需要四重图形。 在14nm,Bohr表示,“增加的晶圆以及双重图形成本仍可由芯片密度提升来抵消,因此,每一代晶体管的成本也都会以稳定的趋势持续降低。” 他认为,即使是在10nm使用浸入式技术,该趋势也将会一直持续。截至目前,“EUV比我预想的还要迟,我无法肯定它何时到来,”他说。 “我们可能是最后一家坚守每隔两年投入新一代制程技术脚步的公司,”Bohr说。 英特尔位在俄勒冈州的元件和逻辑技术开发小组正在广泛地探索各种电晶体、互连、记忆体和其他技术的可能性,不过,他们可不是只做这些事,”Bohr说。 Bohr谈到了英特尔的芯片制造策略。“我们的目的并不在代工,但我们确实有着小规模的芯片制造业务,”他表示。除了销售晶圆,这项工作“也为我们提供了额外优势,就是能从其他的设计团队获得资讯,从而最佳化制程技术。” |


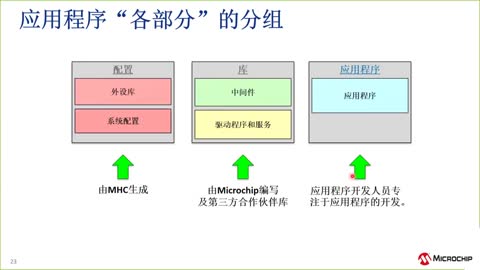
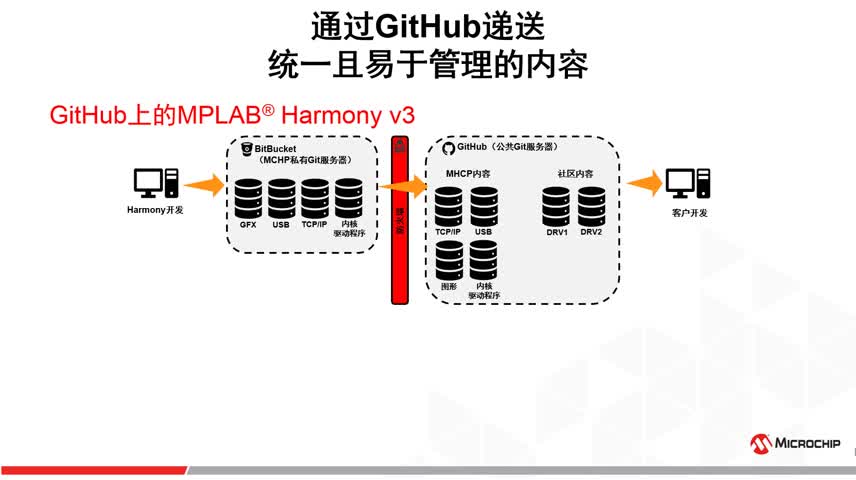



网友评论