面向偏压温度不稳定性分析的即时VTH 测量(一)
发布时间:2012-9-10 15:13
发布者:majake2011
关键词:
VTH
|
引言 在微缩CMOS和精密模拟CMOS技术中对偏压温度不稳定性——负偏压温度不稳定性(NBTI)和正偏压温 度不稳定性(PBTI)——监测和控制的需求不断增加。 当前NBTI1 的JEDEC标准将“测量间歇期的NBTI恢复” 视为促进可靠性研究人员不断完善测试技术的关键。 简单来说,当撤销器件应力时,这种性能的劣化就开始“愈合”。这意味着慢间歇期测量得出的寿命预测 结果将过于乐观。因此,劣化特性分析得越快,(劣 化)恢复对寿命预测的影响越小。此外,实验数据显示被测的劣化时间斜率(n)很大程度取决于测量时 延和测量速度。2 因此,为了最小化测量延时并提高 测量速度开发了几种测量技术。 什么是BTI? 偏压温度不稳定性(BTI)指当MOS FET受温度应 力影响时阈值电压(VTH)不稳定的现象。通常在125℃、 漏极和源极接地的条件下,升高栅极电压来测试FET。 随时间推延,VTH 将增大。对于逻辑器件和存储器件等 应用而言,VTH 出现10%的偏移就会使电路失效。对于匹配双晶体管等模拟应用而言,出现更小的偏移就会 使电路失效。影响FET匹配的许多工艺偏差可以通过 增大晶体管面积来缓和,剩下的限制因素是BTI。 即时(OTF)法 Denais等人3 提出了一种用VTH 偏移相关的间接测量将间歇期测量的恢复减至最小的方法。间歇期测量 序列通过仅3次测量缩短“无应力”时间,如图1所示。 这种方法几乎能用任何一种参数测量系统实现,只是 实现的程度有所不同。但大多数GPIB控制的仪器都缺 乏灵活性并受限于GPIB通信时间和仪器内部速度;因此在测量过程中器件仍会保持将近100ms的无应力时 间。这些局限性不便于观测在时间极限(约100ms) 内劣化和恢复的情况。吉时利2600系列源表独特的架 构能在约2ms的时间内完成Denais的OTF间歇期测量并使测试结构回至应力状态。 经过一段时间,形成、提出了Denais理念的各种变化 形式,甚至将其应用于常规使用中以监测工艺引起的BTI 偏移。这里的每一种方法都有优缺点。本应用笔记将探讨 BTI应用实际实现有关的仪器要求,并且将检查用于劣化 和恢复分析的几种方法。 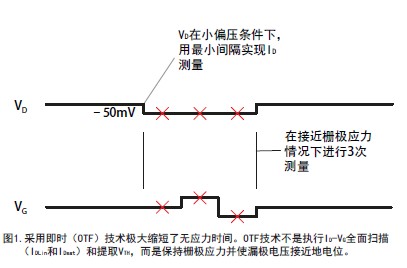
高速源和测量 实现OTF技术的关键要素是采用高速源测量单元或SMU。 高速SMU具有许多关键性能: • 连续测量速度快,连续测量的间隔小于100μs。 • 微秒分辨率时间戳确保正确的定时分析。 • 精密电压源满足漏极小偏压的要求。 • 源快速建立实现了源-测量最高速度。 • 大数据缓冲区确保连续监测器件的劣化和恢复。 想与吉时利测试测量专家互动?想有更多学习资源?可登录吉时利官方网站http://www.keithley.com.cn/ |


网友评论