ЛуДКПЦММЁЊЁЊаОЦЌЗтзАжЊЖрЩй
ЗЂВМЪБМфЃК2019-4-25 10:43
ЗЂВМепЃКyspring
|
ЕБЧАЩчЛсе§ДІгкаТММЪѕгыаТгІгУШЋУцБЌЗЂЕФБГОАЯТЃЌЪЕЪЉЁАжаЙњжЦдь2025ЁБ,вЦЖЏгІгУЁЂШЫЙЄжЧФмЁЂ5GЁЂжЧФмЦћГЕЁЂЙЄвЕ4.0ЕШаТаЫвЕЮёЃЌНЋЕпИВАыЕМЬхВњвЕЗЂеЙЃЌЯШНјЗтзАММЪѕЪЧТњзуИїжжашЧѓЕФРэЯыбЁдёЁЃ ФІЖћЖЈТЩЕФбгЩьЪмЕНЮяРэМЋЯоЁЂОоЖюзЪН№ЭЖШыЕШЖржибЙСІЃЌЦШЧаашвЊБ№ПЊѕшОЖбгајЙЄвеНјВНЁЃЖјЭЈЙ§ЯШНјЗтзАМЏГЩММЪѕЃЌПЩвдИќЧсЫЩЕиЪЕЯжИпУмЖШМЏГЩЁЂЬхЛ§ЮЂаЭЛЏКЭИќЕЭЕФГЩБОЁЃ ФПЧАРДПДЃЌЩШГіаЭЗтзА(FOWLP)ЁЂЯЕЭГМЖЗтзА(SiP)ЁЂ3DЗтзАЪЧзюЪмЙизЂЕФШ§жжЯШНјЗтзАММЪѕЁЃ ЯШНјЗтзАММЪѕ1ЃКЩШГіаЭЗтзА 
ЩШГіаЭЗтзАЪЧОЇдВМЖЗтзАжаЕФвЛжжЃЌЯрЖдгкДЋЭГЗтзАОпгаВЛашвЊв§ЯпПђЁЂЛљАхЕШНщжЪЕФЬиЕуЃЌвђДЫПЩвдЪЕЯжИќЧсБЁЖЬаЁЕФЗтзАЁЃЩШГіаЭЗтзАЕФжївЊгХЕуЪЧдкИќБЁЕФГпДчЯТСщЛюЕиНЋаОЦЌМЏГЩдквЛЦ№ЁЃЩШГіаЭПЩвдгУЛљАхЩЯОЋЯИL/SЩШГіаЭЗтзАШЁДњ2.5DжаНщВуЁЃЫќЛЙПЩвдШЁДњЕЙзАаОЦЌКЭЯШНјЛљАхЁЃетЪЧЩШГіаЭЗтзАММЪѕЕФЧБСІЁЃ ЯШНјЗтзАММЪѕ2ЃКЯЕЭГМЖЗтзА 
ЯЕЭГМЖЗтзАЮЊНЋЖрИіОпгаВЛЭЌЙІФмЕФгадДЕчзгдЊМўгыПЩбЁЮодДЦїМўЃЌвдМАжюШчMEMSЛђепЙтбЇЦїМўЕШЦфЫћЦїМўгХЯШзщзАЕНвЛЦ№ЃЌЪЕЯжвЛЖЈЙІФмЕФЕЅИіБъзМЗтзАМўЃЌаЮГЩвЛИіЯЕЭГЛђепзгЯЕЭГЁЃ ИїРрЮЂЯЕЭГжаЕФДЋИаЦїБГКѓЛЙгаЯЕЭГЕЅаОЦЌ(SoC)ЃЌдкHPCЧїЪЦЯТвЊЧѓЕФЙІФмдНРДдНИпЁЂдНРДдНЖрЁЃвЕНчЛсЫМПМвЊдѕбљАбВЛЭЌаОЦЌЗХдкЭЌвЛЯЕЭГЩЯЃЌАбВЛЭЌЙІФмЕФВЛЭЌаОЦЌЗтзАЕФИќЖЬаЁЃЌетаЉЩшМЦЖМПЩгУSiPЗтзАРДНтОіЃЌСюЖРЬиадЁЂВювьЛЏЬсЩ§ЁЃЭЌЪБПЫЗўСЫSoCжажюШчЙЄвеМцШнЁЂаХКХЛьКЯЁЂдыЩљИЩШХЁЂЕчДХИЩШХЕШФбЬтЁЃПЩвдНЕЕЭГЩБОЃЌЫѕЖЬЩЯЪаЪБМфЁЃ ЯШНјЗтзАММЪѕ3ЃК3DЗтзА вЛЫЕЕН2DЛђеп3DЃЌзмЪЧШУШЫЯыЕНЪгОѕСьгђжаЕФаЇЙћЃЌШЛЖјдкАыЕМЬхСьгђЃЌ3DММЪѕДјРДЕФИяУќИќЬОЮЊЙлжЙЁЃ3DЗтзАЭЈЙ§ОЇдВМЖЛЅСЌММЪѕЪЕЯжаОЦЌМфЕФИпУмЖШЗтзАЃЌПЩвдгааЇТњзуИпЙІФмаОЦЌГЌЧсЁЂГЌБЁЁЂИпадФмЁЂЕЭЙІКФМАЕЭГЩБОЕФашЧѓЃЌБЛДѓЖрАыЕМЬхГЇЩЬШЯЮЊЪЧзюОпгаЧБСІЕФЗтзАЗНЗЈЁЃ 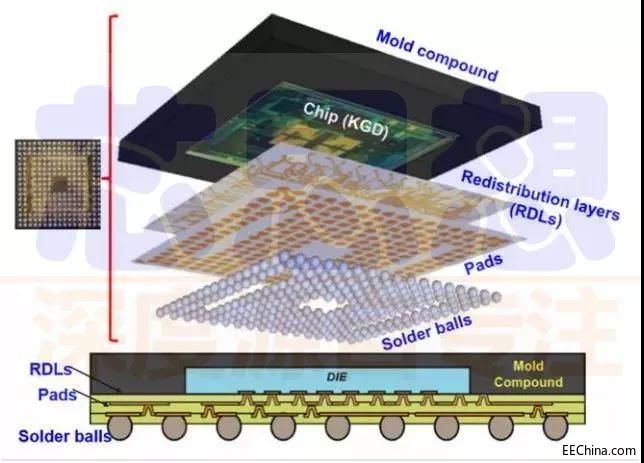
НќМИФъжаЙњМЏГЩЕчТЗЗтВтВњвЕЪЕЯжСЫИпЫйЗЂеЙЃЌгаСЫГЄзуЕФНјВНЃЌШЛЖјЙњФкМЏГЩЕчТЗЗтВтВњвЕСДећЬхММЪѕЫЎЦНВЛИпвВЪЧВЛељЕФЪТЪЕЁЃжаЙњЕФЗтзАВтЪдЪЧМЏГЩЕчТЗШ§вЕ(ЩшМЦЁЂжЦдьЁЂЗтВт)жаЦ№ВНзюдчЕФЃЌгыЙњМЪЫЎЦНВюОрвВБШНЯаЁЃЌвђДЫЭъШЋгаФмСІЗЂеЙЦ№РДЁЃ ЗтзАаавЕНЋдкМЏГЩЕчТЗећЬхЯЕЭГећКЯжаАчбнИќживЊЕФНЧЩЋЃЌвВНЋЖдВњвЕЕФИёОжаЮГЩИќЖргАЯьЁЃЫцзХЯШНјЗтзАЕФЭЦНјЃЌМЏГЩЕчТЗВњвЕНЋеЙЯжГівЛаЉаТЕФЗЂеЙЧїЪЦЃЌгаЯШНјЗтзАЕФМЏГЩЕчТЗВњвЕбљиНЋЛсгаЫљВЛЭЌЁЃ |


ЭјгбЦРТл