下一代超快I-V测量技术
发布时间:2010-12-31 10:30
发布者:嵌入式公社
|
与直流电流-电压(I-V)和电容-电压(C-V)测量一样,是否能够进行超快I-V测量对于从事新材料、器件或工艺研发特征分析实验室的所有人都变得十分必要。进行超快I-V测量需要产生高速脉冲波形,并且在待测器件可能发生松弛之前测量产生的信号。 早期实现的高速I-V测试,通常是指脉冲式I-V测试系统,是针对某些特定应用而开发的,例如高k介质的特征分析和绝缘体上硅(SOI)恒温测试,或者生成Flash存储器特征分析所需的短脉冲。采用脉冲式I-V测量技术是必需的,因为当采用传统直流I-V技术进行测试时,它们的绝缘衬底使得SOI器件保持了测试信号自身产生的热量,使测得的特征曲线发生偏斜;采用脉冲式测试信号能够将这种影响降至最小。 过去,高速脉冲/测量测试系统通常由脉冲发生器、多通道示波器、互连硬件以及用于集成和控制仪器的软件构成。不幸的是,这些系统由于存在延迟问题,使得信号源和测量函数之间的协同变得非常复杂。根据仪器的质量以及它们集成的情况,这种方式还可能会限制脉冲的宽度及其占空比。即便有这些限制,这些早期脉冲式I-V测试系统的用户已经开始想办法将其用于其它一些特征分析工作,包括非易失性存储器测试、超快NBTI可靠性测试和很多其它应用。不过,考虑到这些系统的动态量程有限,但是它们仍然保留了一些专业技术。 为了成为主流测试技术,下一代超快I-V 测试系统必须能够提供很宽的信号源和动态量程。这意味着它们必须能够提供Flash存储器特征分析所需的充足电压,以及测量最新CMOS工艺所需的足够低的电压。例如,对于CMOS工艺下的嵌入式Flash器件,这种Flash器件可能需要高达20V的编程电压,但是CMOS工艺的工作电压是3V,因此所使用的测试系统必须能够提供所需的两种电压。它还要能够提供足够宽的电流范围以处理最新的工艺,以及足够快的上升时间和足够长的脉冲宽度以满足多种应用的需求。它必须简单易用,具有能够使系统可靠提交精确测量结果的互连系统。 当前,超快I-V源和测量功能正被集成到参数式分析仪中,用于对越来越多的器件特性进行特征分析,尤其是负偏温不稳定性(NBTI)和正偏温不稳定性(PBTI)退化。超快I-V测量工具通过使研究人员能够快速而一致地进行这类器件可靠性测量,提高了设计内可靠性(DIR)寿命测量精度,其支持器件和电路设计建模。 近来,某些研究人员被迫配置他们自己的超快BTI测试系统。这些自己内部开发的系统通常包含一台脉冲发生器或任意波形发生器,和一台配备了电流探针或某种类型互阻抗放大器的示波器,用于测量低电流。虽然经过仔细选择仪器和互连电路,完全可能构建一个BTI系统,去满足特定电气条件下的测量需求,但是其仍然具有多个关键的技术挑战: 波形发生。标准脉冲发生器和任意波形发生器以固定的循环时间间隔产生波形,而不是大多数可靠性测试所需的Log(time)标度,包括NBTI和PBTI测试。 测量时间和数据存储器。尽管示波器经过配置可以根据波形特征(例如下降沿)进行触发,但是它们无法针对波形的特定部分有选择地存储样本。这就需要保存很大的数据集进行后处理。只有最昂贵的示波器或者那些具有存储器扩展功能的示波器,才能保存足够多的数据弥补这些缺陷。 准确性、精度和灵敏度。偏温不稳定性是一种高度动态的现象,需要灵敏、高速的测量操作才能进行准确的特征分析。假设所有其它因素都保持不变,测量的物理过程在很大程度上决定了测量速度和灵敏度之间的关系。当进行亚毫秒级测量时,必须把所有的噪声源考虑在内;对于亚微秒级应用,连量子效应也不能被忽略。示波器、电流探针和互阻抗放大器都有各自特定的性能指标,它们不一定会针对协同工作而进行优化。我们很难在很宽的动态量程上,按照一种能够提供最佳性能的方式将这些部件组合起来,以实现高速下的精确测量。 互连。自建的系统通常采用分线器和T型头,它们都会限制测试配置的性能。例如,T型头会限制带宽为100ns到10μs。尽管这适合进行高速测量,但是它无法在应力测量序列中进行任何有效的预应力和后应力直流测量。它也无法在10μs到直流的中间时序范围内进行测量。 测试控制与数据管理。传统的示波器不支持数据流,因此必须等到测试结束后才能传输结果。当测试结束时,大量的数据必须传输到控制计算机上进行后处理,需要将复杂的波形解析为单个的测试结果,然后才能进一步减少数据进行实际的测量。 测试终止。既然测试结果要等到从示波器上传输回数据之后才能进行分析,那么测试持续时间在测试开始之前就确定了。这使得我们不可能根据参数偏移情况或者实时检测到的灾难性故障终止测试过程。 自动化。晶圆级或晶匣级自动测试需要同时控制测试仪器和晶圆探针台,自建的系统通常无法做到。此外,合成一些高级的功能,例如带条件的测试终止,将会大大增加运行这类系统所需的定制软件的复杂性。 更多的通道数。 即使自建的系统最初安装时运行很好,系统集成者也可能需要增加通道或者测试系统的数量以满足应用的发展需求,这时定制系统的升级是极其复杂的。典型的测试系统维护问题,例如校准、操作和这些自定义设置的关联,也需要大量的技术资源,而这些资源通常都是有限的。 最新的参数分析仪经过配置可以最大限度减少或者消除很多与自建的BTI特征分析系统相关的缺陷问题。与单独的脉冲或波形发生器以及示波器不同,它们能够将这些功能集成在高速源测量模块中实现紧凑的时序协同。由于这些模块与参数分析仪完全集成,它们能够利用系统的数据存储和自动测量功能。机架式系统在增加高速通道的数量时也比较容易,只需添加更多的模块即可。 最新的参数分析仪能够将超快I-V、直流I-V和C-V测量功能集成到同一个测试序列中。这种功能对于越来越多的涉及多种测量类型的应用来说是非常有用的,例如电荷泵(CP),它通常需要产生一个栅电压脉冲,同时测量直流衬底电流;或者判断光伏电池的电气特征,通常需要测量电流和电容与所加载直流电压的函数关系。 
吉时利的4200-SCS半导体特征分析系统(如图1所示)始终支持精确的直流I-V测量(采用集成的SMU)和C-V测量(采用可选的C-V模块)。采用最新推出的4225-PMU超快I-V模块和4225-RPM远程放大器/开关,可以增加超高速源和测量功能,构建针对新兴实验室应用而优化的测量系统,例如超快通用I-V测量;脉冲式I-V和瞬态I-V测量;Flash、PCRAM和其它一些非易失性存储器测试;中等功率器件的恒温测试;缩放CMOS工艺的材料测试,例如高k介质;以及NBTI/PBTI可靠性测试。(图2将很多这类新兴的应用映射到4200的直流I-V和超快I-V源与测量范围内。) 
注意传统的SMU设计如何能够提供并测量高达1A和低至1pA左右的电流。尽管通过增加远程前置放大器能够解析低至0.1fA的信号,但是这些仅支持直流 I-V测试配置的最佳速度是10毫秒左右。相比之下,超快I-V方案能够进行最快10ns的测量,这对于涉及器件恢复特征分析的应用是非常关键的。特别针对超快I-V测试而设计的可选远程放大器,将这类新型解决方案的电流分辨率向下扩展到了几十皮安,仅仅稍高于待测器件产生的约翰逊噪声施加的限制。将超快 I-V源和测量仪器与远程放大器集成在一起的系统,在单个机架内支持比以往任何时候都更广泛的特征分析应用,包括测试相变存储器、单脉冲电荷俘获/高k介质测试、LDMOS或砷化镓中等功率放大器的特征分析、SOI恒温测试、超快负偏温不稳定性(NBTI)测试、基于电荷的电容测量(CBCM)、MEM电容测试和越来越多的其它一些测试。 图3给出了支持日益增长的超快I-V测试应用的四种扫描类型:瞬态I-V扫描,其中电压和 /或电流被连续数字化;快速脉冲式I-V,其中电压和/或电流在脉冲稳定后被采样;滤波式脉冲,其中包括要产生一个可变的脉冲电压,同时利用直流SMU测量产生的电流;脉冲应力/直流测量,其中施加电压脉冲,然后接一次直流SMU测量。除了这些传统的扫描类型,4225-PMU还具有完整的任意波形发生功能,以及分段式ARB模式,能够方便地创建、保存和产生最多由2048条用户自定义线段组成的波形。每条线段可以有不同的持续时间,从而具有极大波形生成灵活性。 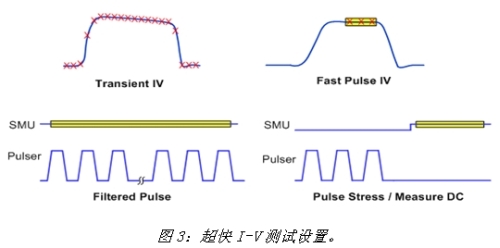
本文小结 随着新型器件和测试应用的出现以及半导体实验室研究人员需求的不断发展,超高速源/测量功能将变得越来越重要。采用具有适应这些变化需求灵活性的高性价比测试系统,研究人员既能够延续之前的工作,同时又能够跟上测量技术发展的趋势。 作者:吉时利仪器公司高级技术专家Lee Stauffer |







网友评论