3D IC技术领风潮 逻辑IC、存储器模块应用成主流
发布时间:2010-12-14 09:51
发布者:admin
|
随著可携式装置功能益趋复杂多元,同时体积要求轻薄、资料传输快速等要求,芯片线路设计也走向高阶的3D IC,全球相关厂商间的3D IC策略联盟亦纷纷成立。根据估计,3D IC在手机应用的产值将会在2015年增加到新台币1,100亿元,届时逻辑IC/存储器堆叠模块所占的产值将超过一半成主流。 DIGITIMES Research表示,由于4C汇流逐渐普及下,网络逐渐走向无线化,从上游云端运算和服务器,中间的WiMAX、4G等网络通讯技术,到下游的智能型手机、平板计算机、电子书等各式各样的手持装置,未来10年即将形成另一兆元产业的新科技产业链和新商机。 4G通讯技术需要更高的频宽,然而为了处理装置上更多的功能,频宽也成为瓶颈。3D IC关键技术的矽穿孔(TSV)制程将能使元件体积缩小35%,功耗降低50%,频宽增加8倍,提振市场对3D IC的需求。 根据工研院IEK估算,2015年全球3D IC应用于手机的产值可达新台币1,100亿元,其中又以逻辑IC/存储器堆叠市场的规模最大。目前短期而言,3D IC以应用在影像传感器(CIS)、微机电(MEMS)居多,中期将扩展至逻辑IC/存储器系统级封装(SiP)模块应用为主,该趋势将在2014年显现,并估计到2015年其产值就会超过所有3D IC应用的一半。 逻辑IC/存储器SiP模块采取直接堆叠,因而散热、重布线、Pitch连接及制造成本仍是现阶段的大问题,在上述问题尚未解决或技术未趋成熟时,采用矽介质的2.5D IC就成为过渡期的方法。 为抢攻3D IC商机,各式的合作模式相继出现,先有联电、尔必达(Elpida)和力成等逻辑IC和记忆厂进行策略联盟,后续尚有诺基亚(Nokia)和星科金朋(STATS ChipPAC)合作开发逻辑IC/存储器模块。 各厂的策略联盟可以避免供应链上责任归属不清的问题,增加系厂商采用3D IC的信心。惟自上游的芯片厂到后段的封测厂,由谁主导供应链整合皆可,但主导者必须具备整合供应链及取得系统厂订单的能力。 来源:Digitimes |




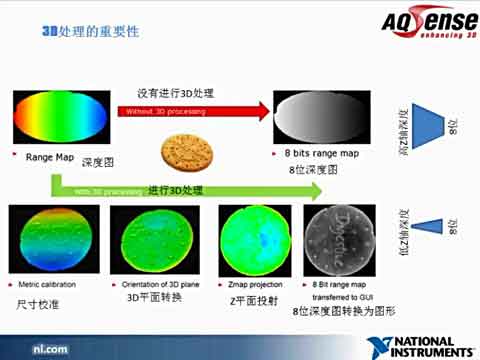


网友评论