ЙшЙІТЪMOSFETдкЕчдДзЊЛЛСьгђЕФгІгУ (1)
ЗЂВМЪБМфЃК2010-11-17 12:44
ЗЂВМепЃКconniede
|
ЙІТЪMOSFETзїЮЊЫЋМЋОЇЬхЙмЕФЬцДњЦЗзюдчГіЯжгк1976ФъЁЃгыФЧаЉЩйЪ§диСїзгЦїМўЯрБШЃЌетаЉЖрЪ§диСїзгЦїМўЫйЖШИќПьЁЂИќМсЙЬЃЌВЂЧвОпгаИќИпЕФЕчСїдівцЁЃвђДЫПЊЙиаЭЕчдДзЊЛЛММЪѕЕУвдеце§ЩЬгУЛЏЁЃдчЦкЬЈЪНЕчФдЕФAC/DCПЊЙиЕчдДЪЧзюдчЪЙгУЙІТЪMOSFETЕФХњСПЯћЗбВњЦЗжЎвЛЃЌЫцКѓГіЯжСЫБфЫйЕчЛњЧ§ЖЏЁЂгЋЙтЕЦЁЂDC/DCзЊЛЛЦїЕШЪ§ЧЇжжШчНёвбОЩюШыЮвУЧШеГЃЩњЛюЕФЦфЫќгІгУЁЃ ЙњМЪећСїЦїЙЋЫОгк1978Фъ11дТЭЦГіЕФIRF100ЪЧзюдчЕФЙІТЪMOSFETЦїМўжЎвЛЁЃетжжЦїМўОпга100VЕФТЉМЋ-дДМЋЛїДЉЕчбЙКЭ0.1ІИЕФЕМЭЈЕчзшЃЌЪїСЂСЫФЧИіЪБДњЕФЛљзМЁЃгЩгкТуЦЌГпДчГЌЙ§40mm2ЃЌМлИёИпДя34УРдЊЃЌвђДЫетжжВњЦЗУЛгаСЂМДЙуЗКЕиЬцДњДЋЭГЕФЫЋМЋОЇЬхЙмЁЃ ЖрФъРДаэЖржЦдьЩЬГжајЭЦГіСЫаэЖрДњЙІТЪMOSFETВњЦЗЁЃ30ФъЖрРДЃЌЛљзМЛљБОЩЯУПФъЖМЛсИќаТЁЃжСаДетЦЊЮФеТЪБЃЌ100VЛљзМЙЋШЯЮЊЪЧгЂЗЩСшЕФIPB025N10N3GЫљБЃГжЁЃгыIRF100ЕФ4ІИЈCmm2ЦЗжЪвђЪ§(FOM)ЯрБШ(1)ЃЌIPB025N10N3GЕФFOMВЛЕН0.1ІИЈCmm2ЁЃетИіжЕМИКѕвбОДяЕНЙшЦїМўЕФРэТлМЋЯо(2)ЁЃ ВЛЙ§ИФНјШддкГжајЁЃР§ШчЃЌCoolMOSЦїМўКЭIGBTЕФЕМЭЈадФмвбОГЌЙ§СЫМђЕЅДЙжБаЭЖрЪ§диСїзгMOSFETЕФРэТлМЋЯоЁЃетаЉДДаТдкЯрЕБГЄвЛЖЮЪБМфФкПЩФмЛЙЛсМЬајЃЌВЂЧвЛсГфЗжРћгУЙІТЪMOSFETЕФЕЭГЩБОНсЙЙКЭбЕСЗгаЫиЕФЩшМЦЪІЃЌЖјетаЉЩшМЦЪІОЙ§ЖрФъЪЕМљКѓвбОбЇЛсШчКЮгааЇЗЂОђЕчдДзЊЛЛЕчТЗКЭЯЕЭГЕФадФмЁЃ 1 ПЊЦєGaNаТЪБДњ HEMT(ИпЕчЧЈвЦТЪОЇЬхЙм)GaNОЇЬхЙмзюдчГіЯжгк2004ФъзѓгвЃЌЕБЪБШеБОЕФEudynaЙЋЫОЭЦГіСЫвЛжжКФОЁаЭЩфЦЕОЇЬхЙмЁЃЭЈЙ§дкЬМЛЏЙшЛљАхЩЯЪЙгУGaNЃЌEudynaЙЋЫОГЩЙІЩњВњГіЮЊЩфЦЕЪаГЁЩшМЦЕФОЇЬхЙм(3)ЁЃHEMTНсЙЙЛљгкЕФЪЧ1975ФъзюЯШгЩT Mimura et al (4)УшЪіЃЌВЂЧвдк1994ФъдйДЮгЩM. A. Khan et al (5)УшЪіЕФвЛжжЯжЯѓЃЌетжжЯжЯѓеЙЪОСЫНгНќAlGaNКЭGaNвьжЪНсЙЙНчУцжЎМфНгПкДІвьГЃИпЕФЕчЧЈвЦТЪЁЃНЋетжжЯжЯѓгІгУгкЬМЛЏЙшЩЯЩњГЄЕФЕЊЛЏяиЃЌEudynaЙЋЫОГЩЙІЩњВњГідкЪ§езКезШЦЕТЪЗЖЮЇФкЕФЛљзМЙІТЪдівцЁЃ2005ФъЃЌNitronexЙЋЫОЭЦГіЕквЛжжКФОЁаЭЩфЦЕHEMTОЇЬхЙмЃЌетжжОЇЬхЙмРћгУЙшЛљЩЯЩњГЩЕФGaN(6)ОЇдВжЦдьЃЌВЩгУЕФЪЧЙЋЫОздМКЕФSIGANTIC?ММЪѕ(7)ЁЃ ЫцзХСэЭтМИМвЙЋЫОВЮгыЪаГЁЃЌGaNЩфЦЕОЇЬхЙмдкЩфЦЕгІгУСьгђМЬајРЋВНЧАНјЁЃЕЋетИіЪаГЁжЎЭтЕФНгЪмадЗЧГЃгаЯоЃЌжївЊдвђЪЧЦїМўГЩБОКЭКФОЁаЭВйзїЕФВЛЗНБуЁЃ гк2009Фъ6дТЃЌвЫЦеЙЋЫОЭЦГіСЫЪзПюдіЧПаЭЙшЛљGaNЙІТЪОЇЬхЙмЃЌетжжОЇЬхЙмзЈУХЩшМЦгУгкЬцДњЙІТЪMOSFETЁЃетаЉВњЦЗПЩвдЪЙгУБъзМЙшжЦдьММЪѕКЭЩшБИЕЭГЩБОЕиДѓХњСПЩњВњ, ЦфНсЙЙБШНЯМђЕЅЃЌМћЭМ1ЁЃ 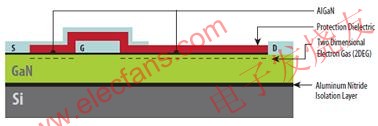 ЭМ1ЃКЙшЛљGaNЦїМўОпгагыКсЯђаЭDMOSЦїМўРрЫЦЕФЗЧГЃМђЕЅНсЙЙЃЌПЩвддкБъзМCMOSДњЙЄГЇжЦдьЁЃ 2 ЭЛЦЦЦСеЯ 30ФъЕФЙшЙІТЪMOSFETРњЪЗИцЫпЮвУЧЃЌПижЦЭЛЦЦадММЪѕЕФЦеМАТЪгаЫФДѓЙиМќвђЫиЃК 1.етжжММЪѕФмЗёжЇГжжиДѓЕФаТЙІФм? 2.етжжММЪѕЪЧЗёШнвзЪЙгУ? 3.етжжММЪѕЖдгУЛЇРДЫЕЪЧЗёМЋОпГЩБОаЇвц? 4.етжжММЪѕЪЧЗёПЩПП? дкНгЯТРДЕФеТНкжаЮвУЧНЋИљОнЩЯЪіЫФЬѕзМдђеЙПЊЬжТлФмЙЛЬцДњжїСїЙшЙІТЪMOSFETЕФЙшЛљАхGaNЙІТЪОЇЬхЙмжЎЯжзДЁЃШЛКѓЮвУЧЛсНјвЛВНСЫНтGaNЕФНќЦкПЊЗЂМЦЛЎЃЌВЂдЄВтЫќУЧЖдЕчдДзЊЛЛаавЕЕФгАЯьЁЃ 3 GaNЙІТЪОЇЬхЙмжЇГжЕФаТЙІФм діЧПаЭGaN HEMTЦїМў(eHEMT) ФмжЇГжЕФзюДѓаТЙІФмЪЧПЊЙиадФмКЭећИіЦїМўДјПэЕФЭЛЦЦадИФЩЦ(МћЭМ2)ЁЃGaNгЕгаБШЙшИпЕУЖрЕФЙиМќЕчГЁЃЌвђДЫетжжаТЦїМўЕФТЉМЋжСдДМЋжЎМфПЩвдГаЪмИпЕУЖрЕФЕчбЙЃЌЖјЖдЕМЭЈЕчзшЕФИКУцгАЯьШДКмаЁЁЃ  ЭМ2ЃКвЫЦеЙЋЫОдіЧПаЭGaNЙІТЪОЇЬхЙмЕФдівцгыЦЕТЪЙиЯЕЧњЯпЁЃ дкЙІТЪMOSFETжаЃЌдкЦїМўДгЕМЭЈЕНЙиЖЯ(ЛђДгЙиЖЯЕНЕМЭЈзДЬЌ)ЫљашЕФЦїМўДЋЕМТЪКЭЕчКЩЪ§СПжЎМфашвЊзівЛИіЛљБОЕФШЈКтЁЃДгетжжШЈКтПЩвдЭЦЕМГіГЦЮЊRQГЫЛ§ЕФЦЗжЪвђЪ§ЁЃетИіжИБъБЛЖЈвхЮЊЦїМўЕФЕМЭЈЕчзшГЫвддке§ГЃЙЄзїЕчбЙКЭЕчСїЬѕМўЯТПЊЙиЦїМўЫљБиашЕФЯђеЄМЋЬсЙЉЕФзмЕчКЩСПЁЃЪТЪЕБэУїЃЌетвЛжИБъЕФИФЩЦгажњгкЬсИпИпЦЕDC/DCзЊЛЛЦїЕФзЊЛЛаЇТЪЁЃRQЕФОјЖджЕвЛАувВЗДгГСЫЪЕМЪЕчТЗжаПЩвдЪЕЯжЕФзюаЁТіПэЁЃЫфШЛЙ§ШЅМИФъжаRQГЫЛ§ЕУЕНСЫКмДѓЕФИФЩЦЃЌЕЋЙшЙІТЪMOSFETЕФЦЗжЪвђЪ§ШдЮДеце§НгНќЪаГЁЩЯвбОЭЦГіЕФЕквЛДњeHEMTЦїМўЁЃЭМ3ЖдЖюЖЈЕчбЙЮЊ100VКЭ200VЕФЛљзМЙшЦїМўКЭGaNЦїМўзїСЫБШНЯЁЃ 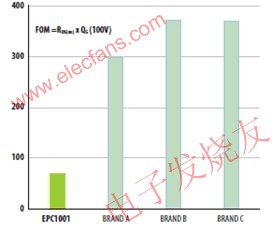 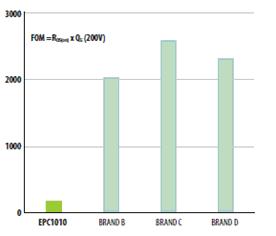 ЭМ3ЃК100VКЭ200VЕФЛљзМЙшЙІТЪMOSFETКЭGaNЕФRQГЫЛ§БШНЯЁЃ 3.1 DC/DCзЊЛЛЦї ФмЙЛПьЫйПЊЙиВЂЧвУЛгаЬЋЖрЙІТЪЫ№ЪЇвтЮЖзХгУЛЇдкЕчдДзЊЛЛЕчТЗжаПЩвдВЩгУИќаЁЕФТіГхПэЖШЁЃашвЊетжжФмСІЕФвЛжжживЊаТаЫгІгУЪЧЗЧИєРыаЭDC/DCзЊЛЛЦїЁЃЙшЙІТЪMOSFETЕФЛљБОМЋЯоадФмЯожЦСЫЕЅМЖЗЧИєРыаЭНЕбЙзЊЛЛЦїЕФжИБъЃЌЦфЪЕМЪЕФЪфШыЕчбЙгыЪфГіЕчбЙжЎБШзюДѓжЕжЛФмДяЕН10:1ЁЃГ§СЫетИіБШжЕЭтЃЌНЕбЙЕчТЗЖЅЖЫОЇЬхЙмвЊЧѓЕФЖЬТіПэвВНЋЕМжТВЛПЩНгЪмЕФИпПЊЙиЫ№КФКЭгЩДЫв§Ц№ЕФЕЭзЊЛЛаЇТЪЁЃGaNОЇЬхЙмЭъШЋДђЦЦСЫетвЛадФмПђМмЃЌШчЭМ4КЭЭМ5ЫљЪОЁЃ 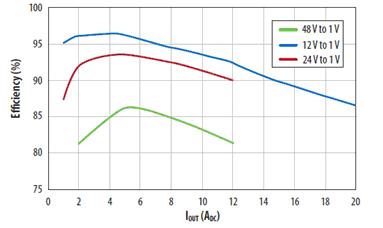 ЭМ4ЃКВЛЭЌЪфШыЕчбЙЯТНЕбЙзЊЛЛЦїаЇТЪгыЕчСїЕФЙиЯЕЁЃетжжзЊЛЛЦїжаЕФЖЅВПКЭЕзВПОЇЬхЙмгУЕФЖМЪЧЕЅТЗ100V EPC1001ЁЃЖдгкЙшЦїМўРДЫЕЃЌЪфШыЪфГіЕчбЙБШГЌЙ§10:1ЭЈГЃБЛШЯЮЊЪЧВЛПЩФмЪЕЯжЕФЁЃ 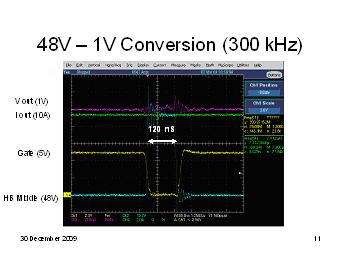 ЭМ5aЃКдкНЕбЙЭиЦЫжаЪЙгУEPC1001ОЇЬхЙмЪЕЯжЕФ300kHz 48VжС1VзЊЛЛВЈаЮЁЃ 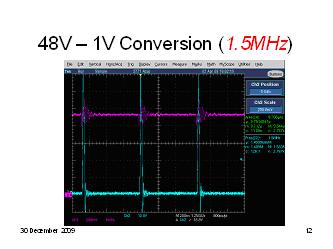 ЭМ5bЃКПЊЙиЦЕТЪЮЊ1.5MHzЕФ48VжС1VзЊЛЛВЈаЮЁЃ 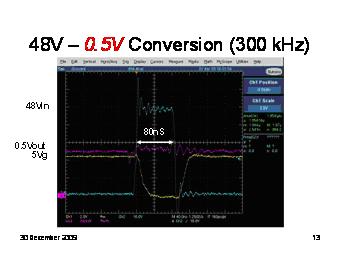 ЭМ5cЃК48VжС0.5VзЊЛЛВЈаЮЁЃ GaNГ§СЫФмдіМгVIN/VOUTБШжЕЗЖЮЇЭтЃЌЛЙФмЯджјНЕЕЭНЕбЙзЊЛЛЦїдкШЮКЮVIN/VOUTБШжЕЪБЕФПЊЙиЫ№КФЁЃБШНЯ12VжС1VзЊЛЛЦїОЭПЩвдЗЂЯжетжжадФмЕФЯджјИФЩЦЃЌМћЭМ6ЁЃ  ЭМ6ЃКЖдШ§жжСїааЕФИКдиЕузЊЛЛЦїКЭВЩгУEPC1014/EPC1015 GaNОЇЬхЙмПЊЗЂЕФзЊЛЛЦїдкVIN=12VКЭVOUT=1VЁЂЕчСїЮЊ5AКЭПЊЙиЦЕТЪЮЊ600kHzЪБЕФЙІТЪЫ№ЪЇБШНЯЁЃ ЫцзХаТЕФGaNОЇЬхЙмПьЫйКИЧЕБЧАЙІТЪMOSFETКЭIGBTЕФЕчСїКЭЕчбЙЗЖЮЇЃЌAC/DCзЊЛЛЁЂЭЌВНећСїКЭЙІТЪвђЫиаЃе§ЖМНЋФмЪЕЯжУїЯдЕФадФмЬсИпЁЃ 3.2 DРрвєЦЕЗХДѓЦї DРрвєЦЕЗХДѓЦїОГЃУцСйзХГЩБОЁЂЬхЛ§КЭЩљвєЪЇецжЎМфЕФелждПМТЧЁЃгАЯьЪЇецЕФзюДѓвђЫиЪЧЫРЧјЪБМфКЭЪфГіТЫВЈЦїЕФЯрвЦЁЃ DРрвєЦЕЗХДѓЦїгаШ§жжИљОнЫРЧјЪБМфИФБфЪфГіТіПэЕФЖРЬиВйзїФЃЪНЁЃе§ЯђЕчИаЕчСїФЃЪНЪЧЛљгкИпВрПЊЙиНјааећСїЃЌЗДЯђЕчИаЕчСїФЃЪНЪЧЛљгкЕЭВрПЊЙиНјааећСїЃЌЖјЫЋЯђЕчСїдђЛљгкУПИіПЊЙиНјааећСїЁЃетаЉФЃЪННЋЫРЧјЪБМфЗжБ№ЩшжУдкЩЯЩ§биЁЂЯТНЕбиЛђМШВЛЪЧЩЯЩ§бивВВЛЪЧЯТНЕбиЕФЕиЗНЁЃЫРЧјЪБМфГЄЖЬОіЖЈСЫгыетжжЯжЯѓгаЙиЕФЪЇецЖШЁЃгаЯоПЊЙиЫйЖШКЭЬхЖўМЋЙмЧАЯђЕчбЙНЋНјвЛВНдіЧПетвЛаЇгІЁЃдіЧПаЭGaNОЇЬхЙмОпгаЗЧГЃЕЭЕФеЄМЋЕчКЩЃЌвђДЫОпгаЗЧГЃЖЬЕФбгЪБКЭЗЧГЃПьЕФПЊЙиЫйЖШЁЃИпОЋЖШЕФПЊЙидЪаэИќКУЕиПижЦПЊЙиЧщПіЃЌНјвЛВНЫѕЖЬЫРЧјЪБМфЃЌДгЖјЪЕЯжИќЕЭЕФЪЇецЁЃ ЪфГіТЫВЈЦїЕФГпДчКЭЗДРЁдівцгЩПЊЙиЦЕТЪОіЖЈЁЃдкЕЭПЊЙиЦЕТЪЪБЃЌБиаыЪЙгУДѓЕФТЫВЈЕчШнКЭЕчИаЃЌвдБуДгЯывЊЕФаХКХжаЯћГ§диВЈЦЕТЪЁЃДѓжЕЕФТЫВЈдЊМўВЛНідіМгСЫЗХДѓЦїЕФГЩБОКЭГпДчЃЌЛЙЛсдьГЩЯрвЦЃЌДгЖјНЕЕЭЯЕЭГЕФЮШЖЈадЃЌЯожЦгУгкВЙГЅаэЖрдЊМўЪЇецЕФЗДРЁдівцЃЌзюжегАЯьЯЕЭГЕФБЃецЖШЁЃВЩгУДЋЭГЙшMOSFETЪБПЊЙиЦЕТЪЗЧГЃгаЯоЃЌвђЮЊЙІКФЛсгЩгкИпПЊЙиЫ№КФЖјбИЫйЩЯЩ§ЁЃ GaNОЇЬхЙмФмЙЛЭЌЪБЬсЙЉЕЭЕФRDS(ON)КЭЕЭЕФеЄМЋЕчКЩ(QG)ЃЌвђДЫдкЪ§MHzЗЖЮЇФкЖМФмЬсЙЉГіЩЋЕФаЇТЪЁЃетЪБЗХДѓЦїПЩвдЪЙгУИќаЁжЕЕФТЫВЈдЊМўЃЌДгЖјМѕЩйЫќУЧЖдГЩБОЁЂГпДчКЭЪЇецЕФгАЯьЃЌВЂдЪаэИќИпЕФдівцЗДРЁЃЌМѕаЁПЊЙиЗХДѓЦїЖдЪЇецЕФгАЯьЁЃЪЧвддіЧПаЭGaNОЇЬхЙмПЩвдИјDРргІгУДјРДУїЯдИќИпЕФБЃецЖШКЭИќЕЭЕФГЩБОЁЃ 4 діЧПаЭGaNОЇЬхЙмвзгкЪЙгУТ№? ЦїМўЪЧЗёШнвзЪЙгУШЁОігкЖрЗНУцвђЫиЃЌАќРЈЪЙгУепММФмЁЂД§ПЊЗЂЕчТЗЕФФбвзГЬЖШЁЂгыгУЛЇЪьЯЄЕФЦїМўЯрБШгаЖрДѓЕФВювьвдМААяжњгУЛЇЪЙгУЦїМўЕФЙЄОпПЩгУадЕШЁЃ аТвЛДњдіЧПаЭGaNОЇЬхЙмЕФааЮЊгыЯжгаЙІТЪMOSFETЗЧГЃЯрЫЦЃЌвђДЫгУЛЇПЩвдГфЗжРћгУвбгаЕФЩшМЦОбщЁЃгаСНИіЙиМќСьгђашвЊЬиБ№МгвдЙизЂЃКНЯЕЭЕФеЄМЋЕчНщЧПЖШ(МАдкгаЯоеЄМЋТЉЕчСїгкУПКСУзеЄМЋПэЖШКСАВЪ§СПМЖ)КЭНЯИпЕФЦЕТЪЯьгІЁЃетСНжжВювьжаЕФЕквЛжжЁЊЁЊНЯЕЭеЄМЋЕчНщЧПЖШНЋЫцзХММЪѕЕФГЩЪьЖјВЛЖЯЬсИпЁЃЭЌЪБЃЌашвЊВЩШЁвЛЖЈЕФДыЪЉЯћГ§ЙЄзїЧјЕФОВЕчЗХЕчЯжЯѓЃЌВЂЧвЩшМЦЕчТЗЪБвЊБЃГжVGSЕЭгкЪ§ОнЪжВсжаЕФзюДѓжЕ(8)ЁЃЕкЖўжжВювьЁЊЁЊНЯИпЦЕТЪЯьгІВЛНіЪЧжИНздОКЏЪ§адФмБШвдЧАШЮКЮЙшЦїМўвЊИпЃЌЖјЧвгУЛЇдкЩшМЦЕчТЗАцЭМЪБашвЊЖрМгПМТЧЁЃР§ШчЃЌЩйСПЕФдгЩЂМФЩњЕчИаПЩФмЕМжТеЄМЋжСдДМЋЕчбЙЗЂЩњНЯДѓЕФЙ§ГхЯжЯѓЃЌНјЖјгаПЩФмЫ№ЛЕЦїМўЁЃ СэвЛЗНУцЃЌвВгаМИжжЬиадЪЙЕУетаЉЦїМўБШЫќУЧЕФЧАДњЙшЦїМўИќМгШнвзЪЙгУЁЃР§ШчЃЌуажЕЕчбЙЪЕМЪЩЯдкКмПэЗЖЮЇФкЖРСЂгкЮТЖШ(8)ЃЌЕМЭЈЕчзшЕФЮТЖШЯЕЪ§вВБШЙшаЁЕУЖр(8,9)ЁЃ GaNОЇЬхЙмвВФмЙЛдкИпДя300ЁцЕФЮТЖШЯТе§ГЃЙЄзїЃЌЕЋдк125ЁцвдЩЯ,PCBЕФКИНгЛсгАЯьЪЕМЪгІгУЁЃвђДЫЕквЛПюЩЬгУдіЧПаЭЦїМўЕФЙЄзїЮТЖШзюИпЮЊ125ЁцЁЃ |


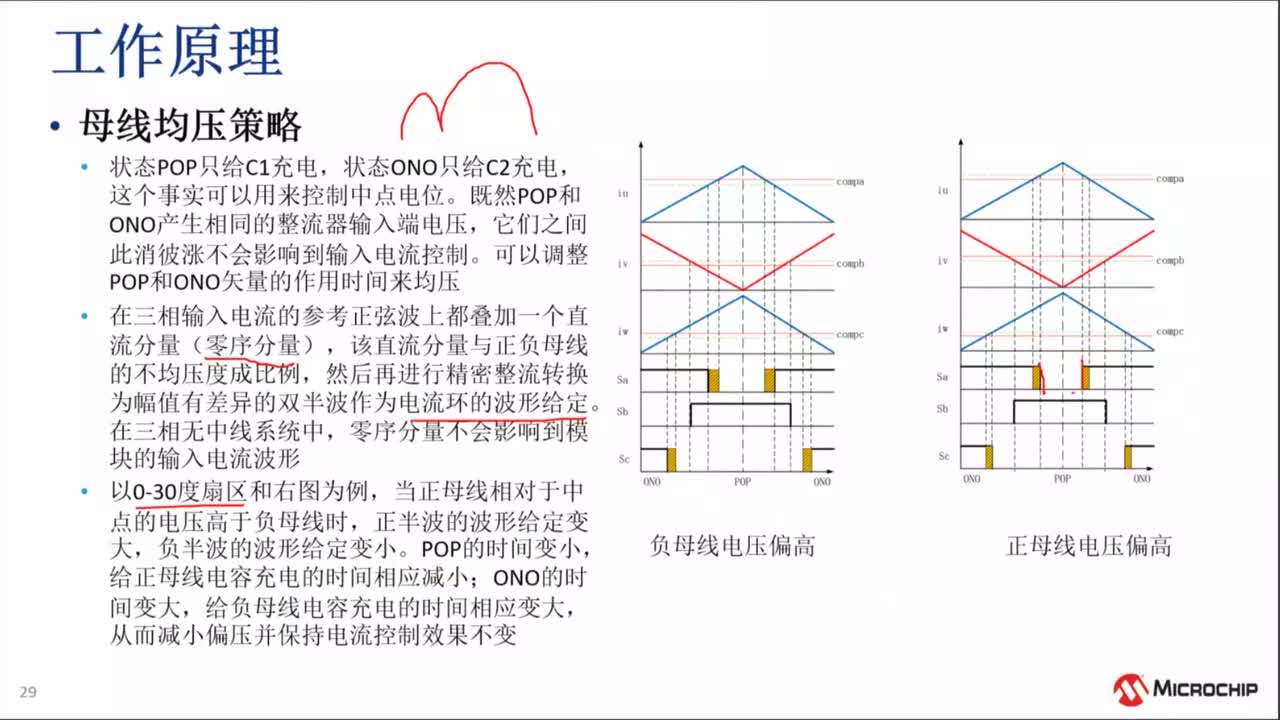




ЭјгбЦРТл