ЕЭkМЏГЩЕФЪяЙт
ЗЂВМЪБМфЃК2010-10-10 14:23
ЗЂВМепЃКconniede
|
ЫцзХЖдаТЛЏбЇЦЗКЭМЏГЩЗНАИСЫНтЕФМгЩюЃЌЮвУЧВЛЕЋПЩвдМѕЧсНщЕчВуПзЯЖТЪдіМгв§Ц№ЕФИКЕЃЛЙПЩвдНЕЕЭЙЄвеЖдГЌЕЭkБЁФЄЕФЫ№ЩЫЁЃ дкПЊЗЂаТаЭГЌЕЭkЃЈULKЃЉНщЕчВФСЯЕФЙ§ГЬжаЃЌгаСНИіжївЊЮЪЬтвЛжБРЇШХзХвЕНчЃКULKВФСЯЕФПзЯЖТЪВЛЖЯдіМгЃЌвдМАЙЄвеМЏГЩЙ§ГЬжаПЩФмдьГЩЕФБЁФЄЫ№ЩЫЁЃБОЮФЖдетСНИіЮЪЬтзіСЫЩюШыЬНЬжЃЌВЂЭЈЙ§ВЩгУЛљгкН№ЪєгВбкФЄВуКЭаТаЭЕШРызгЬхЛЏбЇЕФМЏГЩЗНАИЃЌеЙЪОГіЦФОпЧАОАЕФНсЙћЁЃЛЙНщЩмСЫвЛжжЬиБ№СюШЫИааЫШЄЕФULKВФСЯЃКSiOC:HЛљЕФгаЛњН№ЪєЙшЫсбЮВЃСЇЃЈOSGЃЉЁЃ 1 ПзЯЖТЪЮЪЬт жкЫљжмжЊЃЌНщЕчБЁФЄжадіМгЕФПзЯЖТЪЖдВФСЯЕФШШ-ЛњаЕадФмЛсДјРДВЛРћЕФгАЯьЁЃДЫЭтЃЌЫцзХПзЯЖТЪЕФдіМгЃЌВФСЯЕФЕЏадФЃСПКЭЕМШШЯЕЪ§ЕФЭЫЛЏЫйЖШЃЈУнжИЪ§ЙцТЩЃЉвЊБШЦфВФСЯУмЖШКЭkжЕЕФНЕЕЭЫйЖШвЊПьЃЌКѓСНепЪЧвдЯпадЙцТЩЯТНЕЕФЁЃШЛЖјзюНќЕФбаОПжЄУїЃЌетжжЫЅЭЫФмБЛЫцКѓЕФаоИДММЪѕЫљВЙГЅЃЌАќРЈШШЁЂЕШРызгЬхЁЂзЯЭтЯпКЭЕчзгЪјЗНЗЈЃЌЖМПЩвдГЩЙІЕиЬсИпВФСЯЕФШШ-ЛњаЕадФмЁЃ вдзЯЭтЯпаоИДЮЊР§ЃЌзЯЭтЯпееЩфвдМАвђДЫЗЂЩњЕФШШЛюЛЏЪЙOSGБЁФЄжаSiOC:HЛљЬхЕФМќНсЙЙЗЂЩњжиХХЃЌДгЖјЬсИпСЫБЁФЄгВЖШЃЌВЂЧвБЃСєСЫБЁФЄЕФЪшЫЎадКЭГѕЪМЕФПзЯЖТЪЁЃ зЯЭтЯпаоИДКѓВФСЯНсЙЙЗЂЩњжиХХЃЌДѓНЧЖШЕФSi-O-SiМќЯђИќМгЮШЖЈЕФаЁНЧЛђепЁАЭјТчЁБНсЙЙзЊБфЃЌЭЌЪБНЛСЊГЬЖШвВЕУЕНЬсИпЁЃвђДЫЃЌЮЊСЫПЊЗЂзюМбЕФзЯЭтаоИДЙЄвеЃЌашвЊЩюШыРэНтбЁдёадЕФЙтЗжНтКЭЛљЬхНсЙЙЕФСДЧЈвЦТЪЁЃ 2 ПзКЯВЂ ЮЊЕУЕННЯДжВкЕФЕЭkБЁФЄЃЌЮвУЧЗЧГЃЯЃЭћдкУЛгаПзОлМЏЛђепСЊКЯЕФЧщПіЯТНЕЕЭБЁФЄУмЖШЁЃШЛЖјЃЌЕБПзЯЖТЪдіМгЪБЃЌЗЂЩњПзКЯВЂЕФМИТЪЛсдіМгЃЌвђДЫдіМгСЫКЯГЩаТаЭULKНщЕчВФСЯЕФИДдгадЁЃ ПзКЯВЂдкаэЖрЗНУцЪЧгаКІЕФЁЃжБОЖаЁгк2nmЕФгаађПзЃЌБЛжЄУїЖдЕЏадФЃСПгае§УцгАЯьЃЌШЛЖјФЧаЉЫцЛњСЌЭЈЕФПзЛсНЕЕЭЛњаЕадФмЁЃДЫЭтЃЌПзЕФСЌЭЈдіМгСЫДѓПзЕФаЮГЩМИТЪЃЌЗДЙ§РДЛсдкЭзшЕВВуЕШБШР§ЮЂЫѕЪБЫ№КІЬЈНзИВИЧЁЃзюжеЃЌПзЕФСЌЭЈЛЙЛсЮЊЦјЬхЮлШОЮяЁЂЪЊЦјЁЂЪЊЗЈЧхЯДЛЏбЇЦЗЁЂЛЏбЇЛњаЕЦНЬЙЛЏЃЈCMPЃЉНЌСЯКЭгУгкзшЕВВуЕэЛ§ЕФдзгВуЕэЛ§ЃЈALDЃЉЧАЧ§ЬхЬсЙЉРЉЩЂЭЈЕРЃЌвђДЫашвЊЖдЦфМгвдПижЦЃЌЪЙЮЂСЌЭЈЖШаЁгк2.0 nmЁЃ 3 гІгУЕМЯђ Г§етаЉЦеЭЈЕФПМТЧЭтЃЌЕЭkВФСЯЕФПЊЗЂгыгІгУЕФЙиЯЕЗЧГЃУмЧаЃЌЭљЭљвЊТњзувЛаЉЖюЭтЕФашЧѓЁЃР§ШчЃЌдкТпМЦїМўгІгУЗНУцЃЌРэЯыЕФБЁФЄгІИУЪЧПзЯЖТЪгаЯоЕФULKБЁФЄЁЃШЛЖјЃЌЕБЧАЕФПЊЗЂжаЃЌЮЊДяЕНЦкЭћЕФkжЕЃЌШДВЛЕУВЛдіМгПзЯЖТЪЁЃ ДцДЂЦїгІгУИњЫцзХТпМЦїМўЕФТЗОЖЃЌВЂгаДѓдМ5ФъЕФбгГйЁЃдкетжжЧщПіЯТЃЌЕЭkБЁФЄБиаыФмОЪмзЁНЯИпЕФЕчбЙВйзїЃЌЕфаЭЕФЕчбЙдМЮЊ15VЃЌВЂЧвашвЊНЯИпЕФЛњаЕадФмКЭГЌЙ§15GPaЕФЕЏадФЃСПЁЃЬиЪтДцДЂЦїЕФгІгУШчЩСДцЃЌИљОнЫљВЩгУЕФЙЄвеЖјЖЈЃЌПЩФмашвЊИпШШЮШЖЈадКЭИпГЁЧПЯТЕФОЪБОјдЕЛїДЉЃЈTDDBЃЉадФмЁЃ 4 МЏГЩЗНАИ ЭКЭЕЭkБЁФЄЕФМЏГЩБфЕУИќМгИДдгЃЌвђЮЊМЏГЩЙЄвеЖдЭЕчзшЯЕЪ§КЭгааЇkжЕЖМгагАЯьЃЌдкДЫЙ§ГЬжаЃЌЙЄвеВЮЪ§ЭГМЦВЈЖЏЕФЯрЖдживЊадГжајЩЯЩ§ЁЃДЫЭтЃЌЖЈвхе§ШЗЗНЗЈЕФФбЖШВЛПЩКіЪгЃЌДЫЗНЗЈНЋЮЪЬтЕФЛљБОЗНУцгыВЛЭъУРЕФЙЄвеЗжРыЃЌвђДЫПЩФмЕУЕНЖд ЁАЛЅСЌЁБЕФецЪЕЦРЙРЁЃЖдКЯЪЪЕФICКѓЕРЃЈBEOLЃЉМЏГЩЗНАИРДЫЕЃЌбЁгУУПжжЬиЖЈЕФГѕЪМВФСЯЖМашвЊПМТЧетаЉвђЫиЁЃ ШчЙћжЛЪЧДПДтПМТЧЭДѓТэЪПИяМЏГЩжаЙЄвев§Ц№ЕФЕЭkФЄЕФЫ№ЩЫЃЌЮвУЧжЊЕРЫцзХkжЕЕФНЕЕЭЃЌБЁФЄЖдЮяРэКЭЛЏбЇЫ№ЩЫИќМгУєИаЁЃЙЄвеЕМжТЕФЫ№ЩЫБЛжЄУїЪЧМЏГЩНсЙЙжаkжЕОжВПдіМгКЭ/ЛђПЩППадНЕЕЭЕФдвђЃЌетЛсЯћШѕВЩгУkЕчНщВФСЯЕФгХЪЦЁЃЙЄвев§ЗЂЕФЕЭkФЄЫ№ЩЫжївЊЗЂЩњдкЕШРызгЦиЙтЙ§ГЬжаЁЊЁЊАќРЈПЬЪДЁЂШЅНККЭCMPКѓЕШРызгЬхЧхЯДЁЃ 5 Н№ЪєгВбкФЄВу ЬиЖЈЕФВФСЯаджЪКЭЕШРызгЬхдьГЩЦЦЛЕЕФГЬЖШжЎМфгаЪВУДбљЕФЙиЯЕЃЌФПЧАЩаВЛЧхГўЁЃдкIMECЃЌжївЊЪЧЭЈЙ§аоИФМЏГЩЗНАИРДМѕЧсПЬЪДКЭШЅНКЕШРызгЬхВйзїЕМжТЕФЕчНщжЪЭЫЛЏЃЌЦфжаАќРЈеЄЕўВубЁдёЃЌЕШРызгЬхЛЏбЇЕФбЁдёЃЌвдМАПЬЪДгыШЅНКЕФЙЄвеЫГађЁЃЖдгкПзЯЖТЪаЁгк10%ЕФЕЭkБЁФЄЃЌгІгУЙтПЬНКбкФЄЃЈRMЃЉМЏГЩЗНАИЃЛЖдгкПзЯЖТЪБШНЯИпЕФВФСЯЃЌIMECзЊЯђН№ЪєгВбкФЄЃЈMHMЃЉМЏГЩЗНАИЃЈЭМ1ЃЉЁЃ 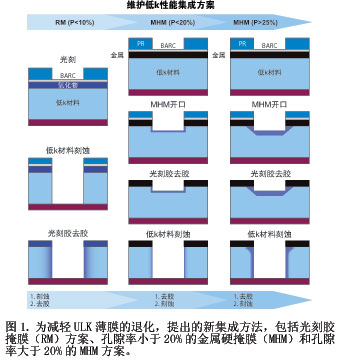 АДДЫМЏГЩЗНЗЈЃЌдкЭМаЮЛЏЙ§ГЬжаЫ№ЩЫЛсДяЕНзюаЁЃЌНгЯТРДЃЌCMPКЭ/ЛђЭЛЙдКѓЕФCMPКѓЕШРызгЬхЧхЯДЙ§ГЬЃЌвдМАВаСєЕФЮЂСЃЧхГ§Й§ГЬвВПЩФмЫ№ЩЫНщЕчБЁФЄЁЃ дкДЫЧАЕФбаОПжаЃЌбаОПШЫдБжЄУїСЫНщЕчВФСЯЕФЛњаЕаджЪдкCMPКѓШБЯнВњЩњЙ§ГЬжаАчбнживЊНЧЩЋЁЃЫћУЧЕФбаОПЛЙБэУїЃЌЮЊМѕЧсCMPЕМжТЕФЛњаЕЫ№ЩЫЃЌЬсИпULK БЁФЄБэУцЕФЛњаЕаджЪЛсЪЧвЛжжПЩааЕФЗНЗЈЁЃвђДЫдкMHMЕэЛ§жЎЧАЃЌГСЛ§вЛВуКмБЁЕФSiCВуЃЈдМ5nmЃЉвддіЧПБЁФЄЕФЛњаЕадФмЁЃЦфЫћаЁзщгУSiO2зїЮЊMHM ЕэЛ§жЎЧАЕФГСЛ§ВФСЯЃЌетвЛВуЭЈГЃБЛГЦЮЊНщЕчБЃЛЄВуЃЈDPLЃЉЁЃMHMЗНАИгІгУгкИпПзЯЖТЪКЭжаПзЯЖТЪЕФЕЭkБЁФЄЪБЃЌЦфkжЕЃЈkeffЃЉгыЬхВФСЯkжЕЃЈИеЭъГЩГСЛ§ЃЉЕФВювьЗжБ№МѕаЁжС0.0КЭ0.2ЁЃЃЈМЏГЩЗНАИЕФЦЗжЪвђЪ§ЪЧЪЙЁїk = keff/kОЁПЩФмЕФаЁЁЃЃЉ НЋMHMМЏГЩЗНАИвЦжВЕНИпПзЯЖТЪВФСЯВЂВЛШнвзЁЃН№ЪєгВбкФЄЯТЕФЫ№ЩЫПЩФмЛсРЉеЙЃЌЕМжТkeffЕФдіМгКЭКѓајЪЊЗЈЧхЯДжаЕФЯпЬѕХЄЧњЁЃетжжЯжЯѓБэУїЃЌОЋаФбЁдёЕФПЬЪДЁЂШЅНККЭЩцМАЕНЕШРызгЬхВЮЪ§КЭЙЄвеЫГађЕФЪЊЗЈЧхЯДЛЏбЇЦЗЃЌЪЧОіЖЈзюгХЛЏНтОіЗНАИЕФЙиМќЁЃ ЬсИпеЯпЬѕЕФЭМаЮЛЏадФмЃЌАќРЈЫ№ЩЫКЭЯпЬѕТжРЊПижЦЁЃНгЯТРДЕФВПЗжНЋвЊНщЩмгыЕЭkБЁФЄгаЙиЕФЕШРызгЬхЁЂЪЊЗЈЧхЯДКЭCMPЙЄвеЕФНјеЙЁЃ 6 ЕШРызгЬхЫ№ЩЫ дкДѓТэЪПИяМЏГЩжаЃЌБмУтЯпЬѕТжРЊХЄЧњЁЂИїЯђвьадПЬЪДЯжЯѓЁЂkжЕНЕЕЭЁЂГЩЦЗТЪЫ№ЪЇКЭЕЭПЩППадЖМЪЧеНсЙЙПЬЪДЕФзюДѓЬєеНЁЃе§ШчЧАЮФЬсЕНЕФЃЌетаЉЮЪЬтДѓВПЗжЦ№дДгкЕЭkВФСЯЕФПЬЪДКЭШЅНКЕШРызгЬхЙ§ГЬЃЌВЂдкBEOLЙЄвеСїГЬжаБЛЗХДѓЁЃФПЧАе§дкПМТЧЖржжЪжЖЮРДПЫЗўетИіЮЪЬтЁЃ вЛжжЪЙгУН№ЪєЛђгаЛњВФСЯзїЮЊЮўЩќгВбкФЄВуЕФЗНЗЈе§дкПЊЗЂжаЃЌПЩвдЬцДњДЋЭГЕФSiO2КЭSiCЮоЛњгВбкФЄВуЁЃгыЖрПзSiOCHЯрБШЃЌН№ЪєКЭгаЛњВФСЯШч TiNЁЂTaNКЭИЛЬМВуОпгаЭъШЋВЛЭЌЕФЛЏбЇаджЪЃЌвђДЫдкбЁдёадКЭИїЯђвьадПЬЪДЗНУцЃЌБШДЋЭГгВбкФЄгаИќКУЕФадФмЁЃЕЋДЫЗНАИВЛФмЭъШЋзшжЙЭМаЮЛЏЙ§ГЬжаЕШРызгЬхЫ№ЩЫЕФЗЂЩњЃЌЫљвдашвЊИќМгИљБОЕиРэНтЫ№ЩЫЛњжЦЁЃ 7 ЕЭkГСЛ§КЭЙтПЬНКЛвЛЏ ЪЕМЪЩЯЃЌдкЭ/ЕЭkМЏГЩжаЕФШЅНКЙЄвеПЩвдЛЎЗжЮЊСНРржївЊЗНЗЈЁЃЕквЛжжЪЧЛљгкбѕЛЏКЭЛЙдЕШРызгЬхЛЏбЇЮяжЪЕФЕЭЮТЁЂЕЭбЙЁЂИїЯђвьадЙтПЬНКШЅНКЁЃЕШРызгЬхжаЕФЛюадЮяжЪПЩвдЭъГЩЕЭЮТЯТШЅНКЁЃШЛЖјЃЌЛюадЮяжЪЛсСїЖЏЩјЭИЕНЖрПзЕФКЌЬМЕЭkБЁФЄЃЌЕМжТЬМЫ№КФКЭКѓРДЕФЧзЫЎЛЏЁЃ ЕкЖўжжШЅНКЗНЗЈЪЧдк270-320ЁцЕФИпГФЕзЮТЖШЯТЃЌРћгУЛЙдадЕФЛЏбЇЮяжЪЃЌЭЈЙ§ЕШРызгЬхСїЭъГЩИїЯђЭЌадШЅНКЁЃЖдгкетжжЗНЗЈЃЌЮвУЧдкЯШНјЕЭkВФСЯЩЯбаОПСЫHe/H2ЕШРызгЬхдкИїжжГФЕзЮТЖШЪБЕФаЇЙћЃЈЭМ2КЭ3ЃЉЁЃЕЭkБЁФЄЭЈЙ§ЛљгкжТПзМСЕФPECVDЗНЗЈГСЛ§ЃЌШШИЈжњзЯЭтаоИДШЅГ§СЫжТПзМСЃЌВњЩњГіСЫПзЯЖЁЃ  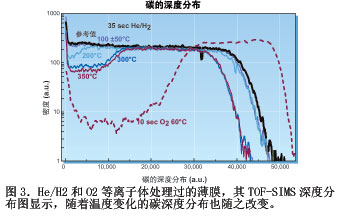 ЕЭkБЁФЄШдШЛЪЧЪшЫЎадЕФЃЌвђДЫHe/H2ЕШРызгЬхЛвЛЏДІРэВЂУЛгадьГЩШЮКЮЫ№КІЁЃНсЙћБэУїЃЌЫљбаОПЕФБЁФЄУЛгаЧзЫЎЛЏзЊБфЁЃДЫЭтЃЌHe/H2ЕШРызгШЅНКЙ§ЖШПЩФмЛсЬсИпПзЯЖТЪЃЌЖјИФадВуВЛЛсЗЂЩњЧзЫЎЛЏзЊБфЃЌвђДЫЛсНјвЛВННЕЕЭВФСЯЕФkжЕЁЃПзЯЖТЪЕФдіМггыЪЃгржТПзМСЕФШЅГ§гаЙиЃЌВЂЧвУЛгаГѕЪМВФСЯжажТПзМСЪЧЗёЭъШЋШЅГ§ЕФБъжОЁЃШЛЖјЃЌвђЮЊПзЯЖТЪдіМгФмЕМжТБЁФЄkжЕЕФНЕЕЭЃЌЭЌЪБЛњаЕЧПЖШЕФЫ№ЪЇЯрЖдНЯЩйЃЌвђДЫетжжИФадЗЧЕЋУЛгаКІДІЃЌЗДЖјЪЧгавцЕФЁЃ 8 ЕЭkПЬЪДКЭЪЊЗЈЧхЯД ЛљгкMHMЭМаЮЛЏЕФЪЕжЪЪЧдкПЬЪДЕЭkНщЕчВФСЯжЎЧАЃЌНЋЙтПЬНКШЅНКгыЕШРызгЬхПЬЪДКЭЛвЛЏЗжРыПЊЁЃдкЙтПЬНКбкФЄЗНАИжаЃЌЕЭkНщжЪЪзЯШБЛПЬЪДШЛКѓНјааЙтПЬНКШЅНКЃЌБиаыбЯИёзёбетИіДЮађЁЃЯрЗДЃЌдкMHMЗНАИжаЃЌдЄЦкЕФЭМАИБЛзЊвЦЕНMHMЩЯЃЌШЛКѓдкПЬЪДЕЭkНщжЪжЎЧАОЭПЩвдШЅГ§ЙтПЬНКЃЌЛђепЯШПЬЪДЕЭkВФСЯШЛКѓШЅГ§ЙтПЬНКЁЃдкКѓвЛЗНАИжаЃЌСНИіЙЄвеВНжшЪЧЖРСЂЕФЁЃЙтПЬВНжшЕФВЮЪ§гыНщЕчВФСЯЮоЙиЁЃ 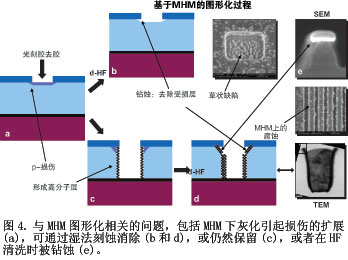 етжжЗНЗЈЯожЦСЫБЁФЄБЉТЖдкЕШРызгЬхжаЕФДЮЪ§ЃЌЭЌЪБЕЭkБЁФЄдкШЅНКЙ§ГЬжаБЛЫ№ЛЕЕФВПЗжЃЌвВдкПЬЪДЙЄвежаБЛШЅГ§СЫЁЃШЛЖјЃЌЫцзХПзЯЖТЪЕФдіМгЃЌЛвЛЏв§Ц№ЕФЫ№ЩЫдкMHMЯТж№НЅРЉДѓЃЌЖјЮоЗЈБЛПЬЪДШЅГ§ЃЈЭМ4aЃЉЁЃЫ№ЩЫВПЗждкПЬЪДКѓШдЛсБЃСєЯТРДЃЈЭМ4cЃЉЃЌЛђЪЧдкЪЊЗЈЧхЯДЙ§ГЬжаБЛШЅГ§ЃЈЭМ4bКЭ 4dЃЉЃЌетШЁОігкЫљЪЙгУЕФЛЏбЇЦЗЁЃР§ШчЃЌдкЪЙгУHFЧхЯДЪБЃЌзъЪДЕФГіЯжЃЈЭМ4fЃЉЛсгАЯьЯпЬѕаЮУВКЭзшЕВВуЬЈНзИВИЧЁЃЫ№ЩЫадНЯЕЭЕФПЬЪДЛЏбЇЦЗПЩФмЛсдкЙЕВлЕФВрБкКЭMHMЩЯСєЯТОлКЯЮяВуЁЃ БиаыЖдетаЉИпЗжзгВуМгвдзЂвтЃЌНЋЦфЭъШЋЧхГ§ВХФмзшжЙЕчСМТЪЕФНЕЕЭЃЌГпДчЕЭгк100nmЕФЧщПігШЦфШчДЫЁЃЭМ5еЙЪОСЫЯпЬѕГпДчДг150nmНЕЕЭЕН90nmЪБЃЌГЩЦЗТЪЫ№ЪЇЕФЧщПіЁЃетжжЯжЯѓФмЗёЕУЕНдіЧПЃЌжївЊШЁОігкЕЭkНщЕчВФСЯЕФЛЏбЇаджЪЁЃЖдгквЛИіkжЕдМЮЊ 2.5ЁЂЛљгкжТПзМСЁЂВЩгУPECVDЩњГЄЕФULKБЁФЄРДЫЕЃЌетИіЮЪЬтПЩвдЭЈЙ§ПЬЪДКѓЕФЧхЯДВНжшМгвдНтОіЁЃгЩгкЕЭkНщжЪЕФЕШБШР§ЮЂЫѕЃЌашвЊПМТЧИќИпаЇЕФЪЊЗЈЧхЯДЛЏбЇЦЗЁЃ 9 ЛЏбЇЛњаЕЦНЬЙЛЏЕМжТЕФЫ№ЩЫ ЮЊбаОПCMPв§ЗЂЕФЫ№ЩЫЃЌашвЊПЊЗЂГіПЩППЕФВтСПЗНЗЈЃЌЪзЯШЪЧевЕНКЯЪЪЕФВтЪдЙЄОпЁЃРэЯызДЬЌЯТЃЌВтЪдЙЄОпБиаыЭЌЪБПМТЧCMPКФВФЁЂзшЕВВуКЭЭвдМАНщЕчБЁФЄЁЃвЛжжЭООЖЪЧЭЈЙ§ВПЗжЭМаЮЛЏЗНЗЈВњЩњРрЫЦЙњМЪЯѓЦхЦхХЬЕФНсЙЙЃЌдкОЇдВЕФжааФКЭБпдЕЧјгђСєЯТДѓЦЌПЊРЋЧјгђЁЃетжжНсЙЙдЪаэдкЭЌвЛОЇдВЩЯБэеїЮоЭМаЮЕФПеАзБЁФЄКЭгаЭМаЮЕФМЏГЩНсЙЙЁЃ 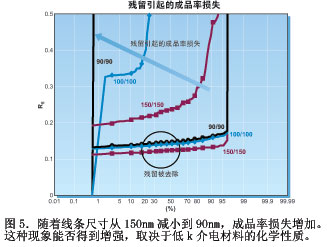 гыЕЭkВФСЯБэУцЯрНгДЅЕФН№ЪєВуЃЌПЩвдЪЧЭзшЕВВуЛђепMHMЃЌетНЋгАЯьЕНCMPКѓШБЯнЕФаЮГЩКЭЫцКѓЕФЧзЫЎЛЏЙ§ГЬЁЃШЛЖјЃЌетжжЫ№КІЕФЛњжЦЪЧПЩФцЕФЁЃгааЉЗНЗЈПЩвдаоИДОЙ§БъзМCMPКЭCMPКѓЧхЯДЙЄвеЕФЕЭkВФСЯЁЃ жБНгCMPЃЈЮогВбкФЄБЃЛЄЃЉжЎКѓЃЌЖдгкШЅГ§ВаСєЕФгаЛњЮяКЭЮќИНдкULKВФСЯБэУцЕФЫЎЃЌЭЫЛ№ЗНЗЈБЛжЄУїЪЧЪЎЗжгааЇЕФЁЃШЛЖјЃЌвђЮЊХзЙтБэУцЕФЧзЫЎадШдУЛгаИФБфЃЌЫќВЛФмзшжЙЫЎЗжЮќИНв§Ц№ЕФkжЕдіМгЁЃвђДЫЃЌЮЊЛжИДЪшЫЎадКЭЮШЖЈБэУцЃЌКЌгаТШ ЙшЭщЗДгІЛљЃЈ-SiMenCl3-nЃЉЛђепЪшЫЎМзЛљЙйФмЭХЕФгаЛњЗжзгБЛвдвКЯрЁЂЦјЯрЛђжТУмЖўбѕЛЏЬМЯрЕФаЮЪНв§ШыЕНЫ№ЩЫЕФULKВФСЯжаЁЃ етаЉгаЛњДІРэЖдгкЛжИДCMPДІРэКѓЕФULKВФСЯБэУцЕФЪшЫЎадЖМЪЎЗжгааЇЁЃШЛЖјЃЌЫќУЧжажЛгавЛжжФмЙЛЮЌГжЕЭkжЕЃЈгыЬхULKВФСЯЕФkжЕЯрБШЃЉЃЌВЂЧвФмЙЛБЃГжГЄЪБМфЮШЖЈЖјВЛЕМжТПзЯЖТЪЕФжиДѓБфЛЏЁЃ жЕЕУжИГіЕФЪЧЃЌетаЉаоИДШмвКжЛФмгУгкCMPЕМжТЕФЫ№ЩЫЁЃЭЦМіЕФЬиБ№НтОіЗНАИЪЧгЩзЯЭтаоИДЗНЗЈЬсИпULKВФСЯЕФаджЪЁЂдкULKНщжЪ/Н№ЪєНчУцЧЖШыЁАгВЁББЃЛЄВуКЭзаЯИбЁдёН№ЪєВузщГЩЁЃ гШЦфЬиБ№ЕФЪЧЃЌШчЙћгУTaNзїЮЊЭзшЕВВуКЭ/ЛђMHMВуЃЌдђЭЦМіЪЙгУИпЛњаЕЧПЖШЕФНщЕчБЃЛЄВувдзшжЙCMPв§ЗЂЕФЫ№ЩЫЁЃЭЈГЃЃЌНщЕчБЃЛЄВугЩkжЕДѓдМЮЊ 3.1-3.5ЁЂбюЪЯФЃСПдМЮЊ23GPaЕФжТУмSiCO:HБЁФЄЛђепPECVD ЩњГЄЕФSiO2БЁФЄзщГЩЁЃPECVDЩњГЄЕФжаПзЯЖТЪULKБЁФЄвбОжЄУїСЫTaN MHMКЭDPLСЊКЯЪЙгУЕФгХЕуЁЃDPLЖдЩјТЉКЭЛїДЉадФмОпгае§УцгАЯьЃЌдкШШбЛЗжаУЛгаЙлВьЕНТЉЕчСїЗЂЩњжиДѓБфЛЏЁЃетПЩЙщвђгкCMPХзЙтЙ§ГЬжаЪЊЦјдкULK ВФСЯРяЕФЮќИНКЭНтЮќИНЃЌЫќЪЧCMPХзЙтЙ§ГЬжаЙЮВСКЭЧзЫЎЛЏЕФНсЙћЁЃИУНсЙћБэУїDPLБЃЛЄULKБЁФЄУтЪмCMPв§ЗЂЕФЫ№ЩЫЁЃ дкДцдкКЭВЛДцдкDPLЕФЧщПіЯТЗжБ№НјааTDDBВтСПЁЃДцдкDPLЪБЃЌВтЪдБэУїЪЙгУЪйУќПЩДя10ЖрФъЁЃЖјЮоDPLЪБКђЃЌОКмЖЬЕФЪБМфБуЪЇаЇСЫЁЃ 10 CMPКѓЧхЯДдьГЩЕФЫ№ЩЫ зюжеЃЌПЩвджЄУїгУгкCMPКѓЧхЯДЕФЕШРызгЬхгаРћгкЬсИпЛЅСЌПЩППадЁЃЫќЪЙЭБэУцБЛЛЙдЃЌЬсИпСЫЖдЕчНщжЪВуЕФеГИНСІЃЌВЂШЅГ§СЫЪЃгрЕФЮЂСЃЁЃЖджТУмЕФЕЭkБЁФЄРДЫЕЃЌАБЕШРызгЬхЪЧвЛИіБъзМбЁЯюЁЃШЛЖјЃЌдкЕЭkНщжЪЕШБШР§ЮЂЫѕЪБЃЌДПАБЕШРызгЬхЛсдьГЩбЯжиЕФГЁЫ№ЩЫЃЈЭМ6ЃЉЁЃ 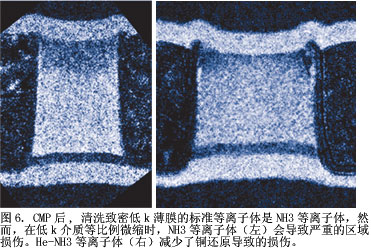 ЮЊаоИДЭЛЙдЕМжТЕФЫ№ЩЫЃЈЕШРызгЬхЫ№ЩЫЕФжЄОнЃЉЃЌЪЙгУСЫHe-NH3ЛљЕФЕШРызгЬхЃЌгааЇМѕЩйСЫЙЕВлМфЕФЬМЫ№КФЁЃ дкCMPКѓЧхЯДжаЃЌЪЙгУДЋЭГNH3ЕШРызгЬхдкПзЯЖТЪГЌЙ§25%ЪБЛсДяЕНМЋЯоЃЌвђДЫNH3ЕШРызгЬхжЎЧАгУКЄЕШРызгЬхЖдНщЕчВФСЯБэУцНјаадЄДІРэЪЧИіКмКУЕФЗНЗЈЃЌПЩвдЛёЕУзюаЁЕФЫ№ЩЫКЭНЯКУЕФгыНщЕчВФСЯГФЕцЕФеГИНСІЁЃ 11 НсТл бЁдёвЛИіЛЅСЌЗНАИЪБЃЌашвЊНсКЯВФСЯаджЪгыЕЅдЊЙЄвеНјааЩюШыбаОПЁЃзюживЊЕФЪЧЃЌашвЊдкЦфЯрЛЅзїгУЁЂЦїМўадФмМАПЩППаджЎМфНЈСЂЧхЮњЕФСЊЯЕЁЃНёЬьЃЌЖдгкkжЕЮЊ 3.0-2.5ЕФОјдЕВуЃЌФПБъЪЧНЕЕЭCDЃЌЧвЮЌГжадФмКЭПЩППадЁЃЖдгкk<2.5ЕФОјдЕВуЃЌжиЕудкгкЗЂеЙПзЯЖТЪаЁгк25%ЕФULKБЁФЄЁЃ |


ЭјгбЦРТл