关于MOSFET的双峰效应量化评估研究
发布时间:2010-10-8 12:47
发布者:eetech
|
金属氧化物半导体场效应晶体管(Metal-Oxide-Semiconductor Field-Effect Transistor,MOSFET)是由一个金氧半(MOS)二机体和两个与其紧密邻接的P-n接面(p-n junction)所组成。自从在1960年首次证明后,MOSFET快速的发展,并且成为微处理器与半导体记忆体(memory)等先进集成电路中最重要的元件。随着超大型集成电路(VLSI)的快速发展,浅沟槽隔离(STI)技术在MOSFET制成中得到了广泛的应用。当MOSFET的有效通道长度(L)和宽度(W)的尺寸越来越小时,一种MOS器件的失效模式:双峰效应(double-hump)也越来越受到人们的重视。 1 双峰效应 图1是典型的双峰效应示意图。在图中虚线方框中,电流Id在阀极电压Vg很小的时候出现了一个峰值。在整个Id-Vg曲线中出现两个峰值,称之为双峰效应。它的表现是在次临界区(sub-threshold),MOS还没有开启时(Vg<Vt),晶体管出现了明显的漏电(I-leakage)。这种漏电的提前出现,会直接导致晶体管的失效和产品的低良品率。 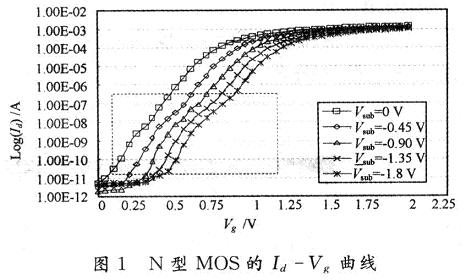 图1中,NMOS的W和L分别为10μm和0.18μm;Vsource=0;Vdrain=0.1 V;Vsub=0,-0.45 V,-0.9 V,-1.35 V,-1.8 V;Vg从0升到1.8 V。近几年,人们对这种失效现象做了大量的研究。人们普遍接受,晶体管的侧壁寄生晶体管的预先开启是漏电的根本原因。理论上讲,由于粒子注入的有效掺杂浓度在晶体管的中心区域和侧壁位置的不同,导致了侧壁寄生晶体管的预先开启。在MOS的基板加有反向电压时,双峰现象特别明显。图2中TrenchrecesS和Corner out-doping这两种现象可以被用来解释为什么晶体管的侧壁位置粒子注入的掺杂浓度会不同于晶体管中心位置(通道正下方)。由于Trenchrecess和Corner ou-doping这两种现象是不可避免的,所以人们尝试了很多种方法去优化掺杂的有效浓度分布,以期降低和消除双峰效应。 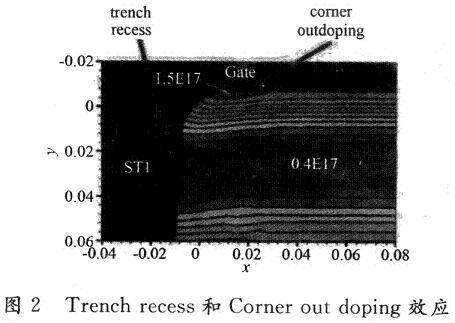 本文将介绍一种双峰效应的简单评估方法,使双峰效应的程度得以量化。并且通过对量化数字的评估,可以定性和定量地了解和确定最优化的掺杂浓度条件。 2 实验条件 本文分别对N型MOS的Vt和Punch-through的粒子注入掺杂浓度进行了正交试验。其中,Vt注入的浓度分别为:4.55×1012cm-2;6.55×1012cm-2和8.55×1012cm-12。,注入能量为25 kev,杂质成分为硼(Boron);Punch-through注入的浓度分别为:4.0×1012cm-2;7.13×1012cm-2和1.0×1013cm-2,注入能量为170 kev,杂质成分为铟(Indium);通过对不同注入条件的MOS器件的Jd-Vg曲线的测量和分析,以期能得到掺杂浓度分布和双峰效应的关系。 3 双峰效应的评估方法 图3(a)是N型MOS器件的Id-Vg测量曲线。MOS器件的W和L分别为10 μm和0.18μm,测量条件为:Vsource=O;Vdrain=0.1V;Vsub=-1.8 V;Vg从0升到1.8 V;图中实线表示Id的测量值,可以看到很明显的双峰现象。由于Vg很小的区间,测试电流值很小,而且不准确,所以取Vg在O.5~1.OV这个区间作为双峰效应的评估区间。图3(b)中的虚线为理想的Id-Vg曲线。可以根据MOS在(Vg比较高)线性区和饱和区的测量值,采用多项式近似曲线拟合法(Polynomi-al Regression Fitting)反向推导得出。图中实线测量值和虚线拟合值的阴影部分表明了MoS器件的漏电程度,用阴影面积来作为双峰效应的量化评估值。 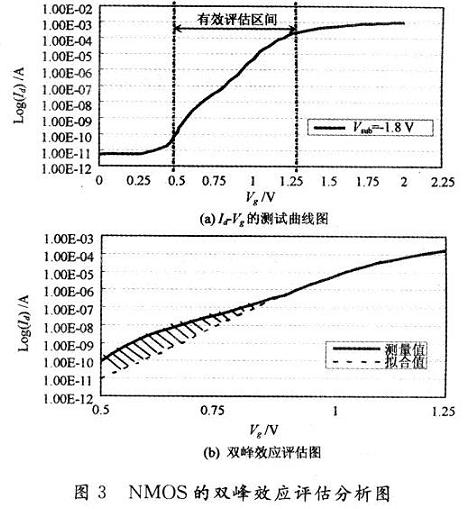 4 试验分析 通过对各种实验条件的Id-Vg曲线的测量和双峰效应的评估,以粒子注入的浓度变化作为变量,双峰效应的量化值作为结果,建立了两者变化关系的模型。图4和图5分别是模型的精确度评估图和注入浓度对双峰效应的变化模型图。 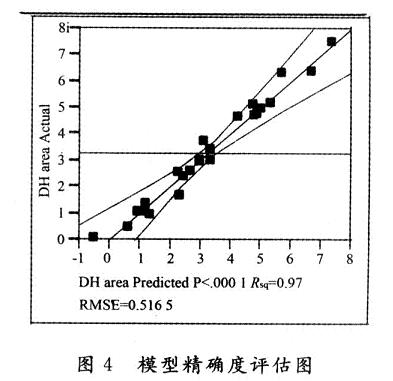  从图4可以看出模型的精确度(Rsquare)为O.97。这表明,粒子注入浓度和双峰效应具有非常强的相关性。图5显示,双峰效应对Vt的注入浓度非常敏感。随着浓度的上升,双峰效应越来越明显。这个现象和现有的理论相吻合。由于Vt的注入能量为25 kev,有效掺杂浓度的峰值靠近MOS通道的表面。并且硼的吸出效应(out-doping)明显,随着粒子注入浓度的升高,通道正下方的有效掺杂浓度上升,但侧壁位置的有效浓度变化不大,致使这两个位置的浓度差异增加。同时,硼的有效浓度的增加,会导致通道正下方的阈值临界电压Vt的上升。这个变化会使得MOS通道下方开启时间延迟,从而侧壁寄生晶体管的预先开启时间变长,进一步导致漏电量的增加。同理,采用的双峰效应的量化评估值就会增加,双峰效应明显。与Vt注入相比,Punch-through注入的浓度变化对双峰效应的影响不明显。这是因为铟元素的吸出效应不明显,所以铟的有效浓度的变化对通道正下方和侧壁位置的有效掺杂浓度的差异贡献不大,从而双峰效应对铟的浓度变化相对不敏感。 本文的模型可以用于定性和定量的分析,但是对于MOSFET来说,V的粒子注入条件也影响晶体管整体的电学特性。所以,在确定最优化的掺杂浓度条件时,要综合考虑。 5 结 语 MOSFET的中心区域和侧壁位置的有效掺杂粒子浓度的均匀分布是解决双峰效应的根本条件。不论这两个位置的有效掺杂浓度差异的形成原因,理论上都可以找到一个比较优化的工艺条件,使得有效掺杂浓度分布均匀,从而减少或消除双峰效应的影响。通过对双峰效应的量化评估,建立掺杂浓度和双峰效应相互关系的模型,从定性和定量的角度进一步了解和确定优化条件。 |






网友评论