16纳米及以下制程节点的良率与成本
发布时间:2016-4-21 15:32
发布者:designapp
|
为以16纳米以下的制程节点生产IC设备,半导体制造商整合了许多新技术,包括多重图形、隔离层间距分割、3D逻辑与内存结构、新材料与复杂光罩。与这些创新技术相关的挑战为半导体业界带来了巨大的成本压力。在这样的环境中,高良率与快速提升良率在帮助半导体制造商保持盈利能力方面至关重要。 制程控制(process control)在过去30年,透过提供早期识别严重制程问题所需的检测与度量技术帮助IC制造商提升良率。随着IC设备设计节点随时间收缩,制程控制系统透过实现支持检测抑制良率与可靠性的缺陷及制程变化的创新技术跟上步伐。 例如KLA-Tencor的光学晶圆检测系统在过去的30年已从使用钨卤素(tungsten-halogen)光源、现成的显微物镜和传感器,发展成利用比太阳更亮的雷射激发宽带光源、与步进机应用相同复杂的光学组件,以及比数字相机快1,000倍的客制化传感器。 目前的宽带电浆光学图形化晶圆检测设备,能够检测到10纳米的缺陷─那只比DNA链的直径大四倍;要在12吋(300mm)晶圆片上的所有晶粒中检测这些缺陷,困难度相当于在像是美国加州那么大的区域范围中,寻找散落距离可达数英哩的数百个硬币─而且是在1小时之内。 用于生产目前尖端设备的多种技术为制程控制带来了挑战。检测与度量系统需能从较小的缺陷和制程/图样变化中撷取讯号,这些撷取通常在具有高长宽比特征的复杂 3D结构上进行。随着新材料的使用和制程变化性的增加,讯号撷取需要在背景噪声更强的环境中进行。此外,随着使用多重图形和更多的制程步骤,检测与度量工 具需要提高生产率,以便能执行足够用于检测偏差的生产监控。 例如,使用多重图形技术生 产的FinFET晶体管需要使用借助于先进检测和度量系统的制程控制策略,这些系统整合了设计信息并能够产生应对较小的严重缺陷、3D结构和窄制程容许范围(process window)所需的灵敏度。此外,检测与度量解决方案也必须提高生产率,以便经济有效地监控使用多重图形制造FinFET晶体管相关的、越来越多的制程步骤。 这些挑战推动了创新,催生能早期发现设计、图形化或制程问题的独特制程控制技术和解决方案;这类方案对于IC制造商至关重要,因为它能够实现今日的尖端技术,以及未来能以更低风险与成本达到最大化提升良率与组件性能的技术。 制程控制的价值 做为制程控制核心的检测与度量系统并不是用来制造IC设备,因为它们不会添加/移除材料或者制作图形;但制程控制对制造具备高良率的可靠组件至关重要,并非多余步骤。 透过查找缺陷和测量关键参数,检测与度量系统可监控制造组件所需的数百个步骤。这些制程控制措施可帮助晶圆厂的工程师在出现偏差时确定制程问题并解决问题。制程控制从根本上与良率相关联,因为晶圆厂不透过检测与度量,几乎无法查明影响良率的制程问题。 快速提高良率从而快速将产品推向市场,对芯片制造商至关重要─良率提升有任何延误都会影响营收,并有可能影响用于研发的未来投资以及下一代产品的发表。透过实施诸如强大的制程控制策略等步骤,晶圆厂能缩短开发时间、加快生产速度和提高产品良率。 事实上,芯片制造商可从制程控制获得的价值有多种形式,包括:强大的投资回报、更低的制造成本与风险、更高的营收、更快的获利速度、改善的产品周期、更高的利润以及业务连贯性。 为让读者对制程控制价值有更进一步了解,我们收集了“制程控制的十个基本事实”(图1)。透过这十个事实来了解制程控制的基本特性,晶圆厂可以实施用于确定严重缺陷、查找偏差和减少变异来源的策略。  图1 制程控制对半导体 IC 产业的十个基本事实。 有鉴于先进组件和制程整合日益升高的复杂度,晶圆厂在发展时必须考虑的最关键的事实为:制程控制需求会随着设计规则演进而增加。如图 2所示,制程步骤数量从16/14纳米节点开始急遽增加;随着制程步骤的增加,所有步骤都必须为偏差、缺陷密度和变化性设定更高的标准。 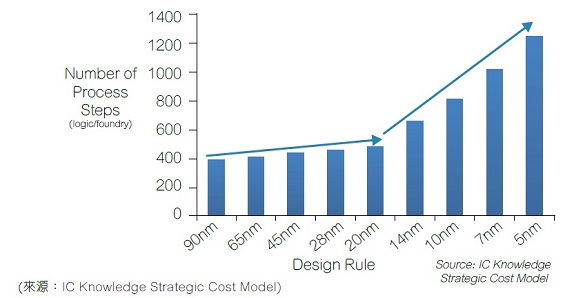 图2 制程步骤从16/14纳米节点开始随设计规则微缩而急遽增加。 若每一个步骤的良率均保持在28纳米节点的水平,那么每个较小设计节点的预测累积良率将降低(图3)。考虑到这种良率损失的复合性质,晶圆厂须在每个独立的制程步骤中保持更严格的控制和更低的缺陷密度。  图3 随着制程步骤的增加,如果每步骤良率均保持在28纳米的水平,则先进设计节点的预测累计良率将降低。 这驱动对新制程控制策略的需要,这些策略不仅可检测出严重影响良率的缺陷和微妙的制程变化,还可让工程师增加检测与度量样本。此类制程控制能力支持对越来越多制程步骤的直接监测,以及快速检测对晶圆制造成本具有显著影响的偏差。 应对未来制程控制挑战的策略 在朝16纳米以下设计节点进军时,半导体制造商面临摩尔定律(Moore's Law)的诸多挑战。在技术层面上,存在与整合新技术相关的诸多复杂因素(如多重图形、3D结构、新材料、复杂光罩、制程步骤的数量增加)。在经济层面 上,这些多种技术融合让晶圆厂控制成本的压力更大;晶体管成本与比例因子(scaling factor)、制造成本和良率有关。随着制造、设计、开发和微影成本的增加,半导体制造商取得摩尔定律成本目标的最佳解决方案为快速提升良率。 在尝试快速提升良率时,IC制造商必须克服围绕设计强韧度与制程容许范围的诸多问题。在设计层面上,工程师必须能够发现和评估设计缺点,以便推动改进,从而确保设备设计与制造技术在生产中是稳定的。 在 16纳米以下的设计节点中,所需的图形重迭预算(pattern overlay budget)为小于等于4.5纳米,临界尺寸规格为~2纳米,制程容许范围极窄。为推动满足这些严格的图形化规格(图4)所需的变更,工程师需要了解图 形化错误的整厂性来源(fab-wide sources)和变异性对制程容许范围的影响。  图4 对于先进多重图形技术,图形化错误的来源是整厂性的─同时发生在微影单元的内部与外部。为满足极为严格的重迭与临界尺寸规格,工程师必须设法减少制程变化的整厂性来源。 对于在成本目标中应对复杂技术挑战的这一环境,制程控制至关重要。开发必要的制程控制解决方案具有挑战─这需要巨大的创新和在半导体业界多个部门之间的密切 协作。这不仅对开发可提供先进的检测与度量系统效能的新技术很重要,也对追求朝向全面性制程控制解决方案的创新至关重要─这些策略将制程控制系统结合在一 起,从而使它们可以在晶圆厂中连同智能分析系统共同处理所产生的大量复杂资料。这些制程控制“系统中的系统”,可帮助晶圆厂透过快速设计验证和制程容许范围发现、扩展和控制快速提升良率。 缺陷发现的目标为检测和识别严重影响良率的缺陷,以突显开发阶段的设计问题和生产阶段的制程漂移。发现系统(discovery system)凭借宽带电浆光学缺陷检测系统上的NanoPoin技术利用设计信息发现最严重影响良率的图样缺陷。 Surfscan SP5无图形(unpatterned)晶圆检测系统透过检测微小的原片缺陷来帮助避免良率问题,这些缺陷可能扭曲先进3D组件(如FinFET晶体管和 垂直NAND闪存)的后续薄膜与图形结构。最后,eDR-7110电子束审查与分类系统可以确定2920系列与Surfscan检测器所检测到的缺 陷。透过生成有关严重纳米级缺陷的综合信息,缺陷发现解决方案可帮助晶圆厂的工程师描述、优化和监控先进制程,以便缩短上市时间。 5D 图形化解决方案的目标是帮助IC制造商在先进组件上实现最佳的图形化。借助目前复杂的多重图形与隔离层间距分割技术,图形化错误不再与微影单元有关。图形 化错误可能来自整厂性来源,如与扫描仪焦点错误直接有关的CMP所导致的晶圆变形。5D解决方案利用多种类型的度量系统来确定和控制图形化变异的整厂性来源,并透过智能分析系统来处理产生的数据。 该系统解决方案的关键组成部分为回馈(feed back)和前馈(feed forward)度量资料能力(图5)。回馈回路已用于多个设计节点。  图 5 KLA-Tencor的5D图形化控制解决方案透过实施多个数据回路来帮助优化图形化。现有的回馈回路(蓝)已存在于多个设计节点中,并对制程变化进行检测和补偿。经过优化的新回馈回路(绿)可以更早地侦测制程变化。创新的前馈回路(橙)利用度量系统从源头测量变更,然后将该数据前馈至后续制程步骤。 这种利用整厂性全面测量值与智能回馈组合以及前馈控制回路的5D解决方案,可帮助晶圆厂的工程师扩大制程容许范围并减轻这些窗口中的变化,最终获得更好的图形化结果。 这些综合制程控制解决方案对IC业界的成功至关重要,它们透过使工程师可以更快和更经济有效地解决广泛的制程问题来实现高良率并快速提高良率。在发展时必须维持创新与协作生态系统,以确保可以开发出能够应对IC制程与成本挑战的新制程控制系统与解决方案。 |


网友评论