功率循环测试助力车用IGBT性能提升
发布时间:2015-12-16 13:27
发布者:designapp
|
汽车功率电子组件(例如IGBT)的设计必须能负荷数千小时的工作时间和上百万次的功率循环,同时得承受高达 200℃的温度。因此产品的可靠性特别关键,而同时故障成本也会是一个很大的问题。随着工业电子系统对能量需求的增加,汽车功率电子设备和组件的供货商所面临的最大挑战就是提供汽车OEM业者所需更高可靠度的系统。 随着越来越高的能量负载压力,功率电子创新带来了一些新的技术,例如使用能够增加热传导系数的直接键合铜基板、优越的互连技术(粗封装键合线、带式键合等)和无焊料芯片粘贴技术,都是用来增强模块的循环能力。这些新的基板有助于降低温度,金属带可负载更大的电流,而且无焊料芯片粘贴可以是烧结的银,具有特别低的热阻。 所有的技术都有助于改善组件中的热传路径。但是,功率循环过程和热效应所产生的热及热机械应力仍然会造成系统故障。这些应力可能会导致很多问题,如封装键合线降级、黏贴层疲劳、堆栈脱层以及芯片或基板破裂。 结点位置的热消散是影响IGBT芯片可靠性的主要因素之一,特别是芯片的粘贴层材料。功率循环测试是仿效模块生命周期的理想方式,因根据所应用的领域,IGBT模块的切换次数是可被预测。 本文主要描述结合功率循环测试和热瞬态测试的测量研究,在此试验中主要是利用功率循环测试造成组件故障,同时在不同的稳态之间进行热瞬态测量,用以确定IGBT样品的故障原因。这类型的测试能适当协助重新设计模块的物理结构,此外根据需求,它还可以模拟热机械应力的输入。 测试的主要目的是利用可重复性的流程来研究当前IGBT模块中常出现的故障模式。然而,这些测试的数量并不足以预测产品的寿命期,但我们能藉此了解并试验IGBT芯片中的降级过程。我们首先对样品进行热瞬态测试,测量结果显示,组件在热瞬态试验过程中,不同稳态之间所需要的时间为180秒。组件在输入10A的驱动电流时可达到最高温,接着在开始测量时则切换至100mA的感测电流。 图1显示样品在最初「健康」状的校准基础。结构函数是一维、纵向态下的热瞬态函数。此曲线和相对应热传的模型。在许多常用的三维几何的结构函数可作为封装结构详细数值形状中,结构函数是「实质」的一维热传模型,例如圆盘中的径向扩散(极坐标系中的一维流)、球面扩散、锥形扩散等。  图1 IGBT的热瞬态反应。 因此结构函数可概括地辨认出外型/材料参数。结构函数可藉由加热或冷却曲线的数学计算直接转换求得。这些曲线可从实际测量结果或利用详细的结构模型仿真热传路径来获得。 创建热仿真模型 接着我们建立并验证详细的三维(3D)模型以便分析结构内部的温度分布。所有的几何参数都会在组件发生故障并拆解后进行测量。图2是仿真模型的外观(图3是其剖面结构)。我们藉由调整材料参数,直到瞬态仿真结果所产生的结构函数与测量结果的结构函数相重合,如此一来我们可以确保所建立的模型运作方式与实际组件完全相同。此流程需要进行多次的反复计算。  图 2 仿真模型的外观。 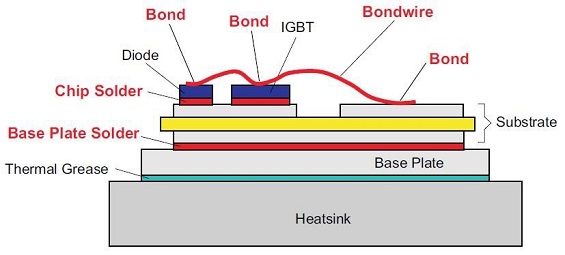 图3 IGBT模块结构图。 依据所测量的几何外型以及对材料参数的猜测所创建的基础模型显示,热瞬态的传递路径与实际组件有明显差异。此类偏差可藉由校准模型且不断地改善模型参数予以排除。最后可将瞬态仿真所获得的结构函数(图4中的红色曲线)与实际组件的测量结果产生的结构函数(蓝色曲线)相互重迭。 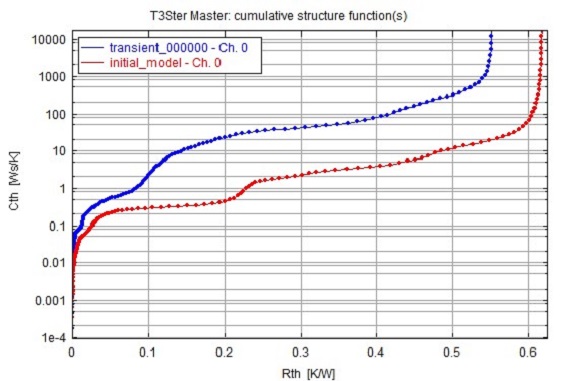 图4 基础模型的仿真结果。 接着利用合适的封装内部特征来校准组件,然后沿着向外的热传路径方向,不断地拟合不同区域的热容和热阻值。为了正确地校正热容值,我们需确保芯片的实体尺寸正确无误,且热源区域的设定正确。在这种情况下,需要增加受热面积直到芯片区域的热容值在结构函数中互相重迭。 此外还需确保陶瓷层的热阻设定在适当的范围。随着陶瓷的热传导系数升高,结构函数中相对应的热阻区域可能需降低以达到另一部份的重迭。下一步则是将组件与冷板间的铜底层和接口材料(TIM)设定在适当的热传导系数,使曲线能正确地相互匹配(图5)。 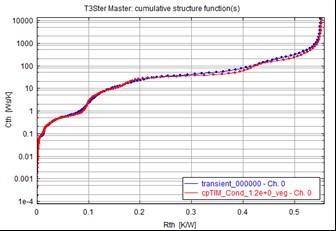 图5 模型校准后的所得到的结构函数。模拟值(蓝色)、测量值(红色)。 在功率测试设备中试验组件 一旦IGBT热结构的初始状态被记录后,组件就可以进行可靠性测试来评估其长时间的表现。我们利用导热贴片将所选的IGBT模块固定在水冷式冷板上。导热贴片的导热性比起大部分的导热膏和导热胶还差,但是它在先前的实验中显示出了极佳的热稳定性,因此不会影响测试的结果。此时冷板温度设置为25℃。 测试中的模块包含两个半桥模块,即四个IGBT。将组件的闸级连接到汲极,同时半桥模块使用独立的驱动电流供电(见图6)。所有IGBT分别连接到热瞬态测试设备的通道。  图 6 用于功率循环和热瞬态测试的 IGBT电路图。 为了加速功率循环测试的流程,我们迫使组件产生100℃的温差变化。选择此数值是为了确保结温最高可达125℃,这是组件所允许的最高温度。同时我们也输入最大的功率以缩短循环时间,并选择适当的时间来达到100℃的温度变化。此IGBT模块可负载最大80A的电流,但是由于组件的压降过高,额定功率就变成了限制因素。根据先前的测试结果,此试验选择25A作为加热电流。 测试过程输入200W的功率并加热3秒使芯片升温到125℃。所需的冷却时间则应确保芯片有足够的时间冷却下来,且平均温度在测试过程中不会发生变化。图7显示了时间和温度的分布图。  图7 功率循环期间的功率和结温变化图。 不论是压降产生变化还是热阻升高,所输入的加热电流和时间在整个测试过程中均保持不变。在每次循环测试中,组件冷却过程的瞬态变化都被记录下来以便能够连续地监测结温的变化。而每经过200次的循环,都会使用10A的加热电流来测量完整的瞬态变化以检查热流路径的结构完整性。 闸级氧化层损坏所引发的故障——非封装键合线的缺陷 在测试过程中,功率循环测试会一直持续直到达到失效标准,即组件完全损坏(短路或断路)。在受测的四个IGBT组件中,其中之一(样品3)发生故障的时间明显地早于其他组件,只有10,158次的功率循环(图8)。过早损坏发生的原因可能是组件放在冷板上时贴附不当,或其他随机的错误。其他三个组件,即样品0、1和2显示出相似的表现,分别在经过40,660、41,476和43,489次循环后发生故障。  图8 组件故障所经过的功率循环次数。 在所有IGBT都发生故障之后,模块会被拆除并检查芯片和封装键合线的状况。图9是其中一个测试芯片的照片,显示出在测试期间有多条封装键合线断裂,芯片表面有一个区域发生烧毁,这可能是在输入高电流时线路脱落而产生电弧所造成。 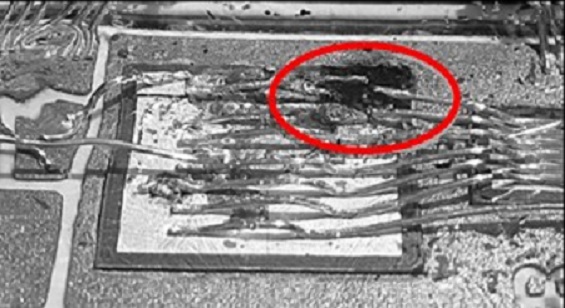 图9 封装键合线断裂和芯片表面烧毁。 尽管封装键合线出现明显的缺陷,但是断裂的封装键合线并未造成器件故障。所有芯片失效的原因都是因为过热和闸级氧化层损坏导致。这些效应随后都可经电性测试来进行检查和追踪─封装键合线破裂会可由VCE(集极-射极)电压升高显现,闸级氧化层损坏可造成IG(闸级漏电流)升高。在设计IGBT功率循环设备时,这些参数都应当需要测量。 此外为了解过热的原因,基板和底板之间的连接点以及芯片黏贴层都需要加以研究,这也是为何需要校准仿真模型的原因。图10显示两个相邻IGBT的温度分布图,此图是使用校准后的详细模型来仿真加热后的温度现象。相邻芯片之间的热耦合影响忽略不计,因此每个芯片可以单独地测试。 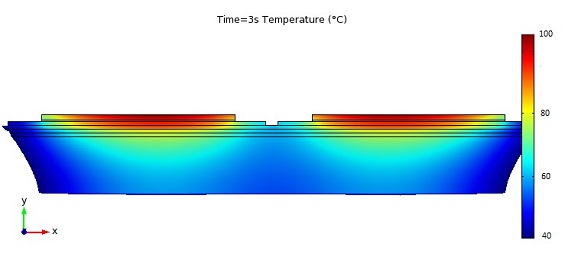 图 10 仿真单一半桥模块在加热 3 秒钟之后的温度分布。 由于加热时间短,基板-底板连接点的最大温升仅为71℃,但是芯片粘贴层温度升高超过100℃。结果显示,结构中最易受损的地方是芯片粘贴层的材料。 定期测量所获得的热瞬态值会依据不同的功率循环次数来产生不同的结构函数。图11显示每5,000次循Power Cycles 环测试后所对应结构函数的影响。在第一阶热容值后,平坦区域对应的是芯片粘贴层材料。组件结构在17,000次循环之前仍很稳定;但是在此之后,芯片粘贴层材料明显发生降级,且其热阻持续升高直到组件发生故障。 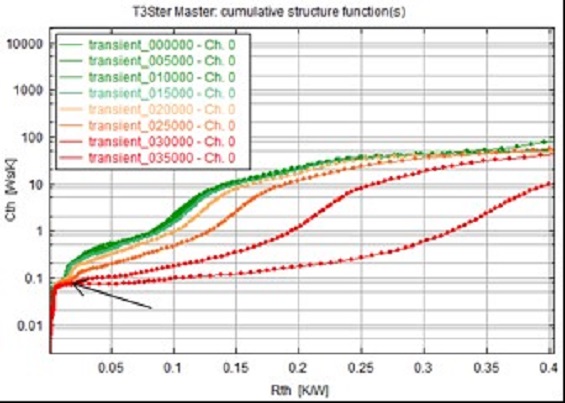 图11 样品0在不同时间点下所测量的结构函数。 图12所显示的是芯片粘贴层的热阻除以系统的初始总热阻,并依功率循环测试的次数所绘制的图形。此结果可确认该黏贴层在15,000次循环之后迅速产生降级。因为芯片粘贴层材料发生了极大的变化导致热传路径明显改变,使其无法研究后一层的结构。但后一层结构中的降级也可合理预测,只不过它们与芯片粘贴层材料的问题相比可忽略不计。 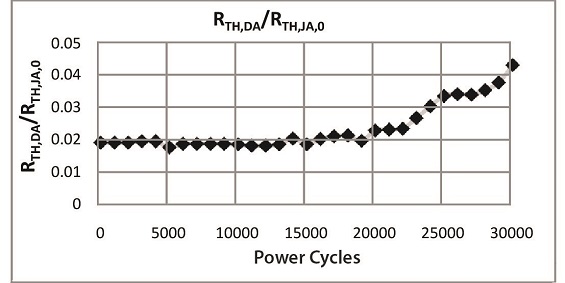 图12 芯片粘贴层热阻与初始总热阻的相对比值。 大约20,000次循环后,芯片粘贴层的降级影响越趋明显,而在接下来的10,000次循环内,组件节点至环境的总热阻因循环而倍增。在30,000次循环后,因为热传递路径发生了变化,我们已无法确定芯片粘贴层的正确热阻。 |







网友评论