用晶圆与掩模SEM轮廓,通过加权评估改进OPC模型质量
发布时间:2014-12-17 13:41
发布者:designapp
|
引言 日立高新技术公司(Hitachi High-Technologies)一直在开发“用扫描电镜(SEM)轮廓提取方法以改进光学邻近校准(OPC)模型质量的技术”。表1和参考文献1~5中给出了主要的挑战。所开发的先进SEM轮廓提取技术结合了无关键尺寸(CD)间隙轮廓提取(参考文献4)、精密SEM边缘(FSE)技术(参考文献3)、任意结构的对准与均化方法(参考文献3),以及全景式掩模SEM轮廓提取技术等。  2011年的SPIE先进光刻技术研讨会上提出了一种先进的混合式OPC建模方法,它采用CD-SEM做1D CD测量,而用先进SEM轮廓提取技术与全景掩模SEM轮廓做2D轮廓创建,结果对1D和2D都表现出了高可预测性,虽然在1D和2D校准之间存在着权衡的关系。在混合校准情况下,OPC模型质量的关键是优化1D和2D数据的权重,因为在模型的可预测性方面,1D和2D数据的权重设定是一种取舍的关系。 不过,我们并不知道哪种1D与2D权重比可以获得最佳的OPC模型质量。Calibre ContourCal中的加权功能在评估时使用的是SPIE2011中相同的OPC数据集,以确定在增加了2D权重的情况下,CD和轮廓errRMS(均方根误差值)是否得到了改进,拐角拟合是否得到了改进。本文将重点讨论加权评估的结果。 混合建模的加权功能采用混合技术的OPC模型校准 图1给出了针对1D和2D结构的CD数据与轮廓数据的OPC模型校准特性。1D结构的校准可以用给出的值作为CD数据,因为1D结构包含的是直线部分。因此从产量的角度而言,对1D结构用CD法要优于轮廓法。另一方面,基于CD的校准无法获得精确的2D结果,因为2D结构有任意的形状,包括圆形拐角。不过,基于轮廓的数据具有关于形状的丰富信息,可以同时校准直线与圆角部分。因此,轮廓法在校准2D结构时要比CD法更精确。 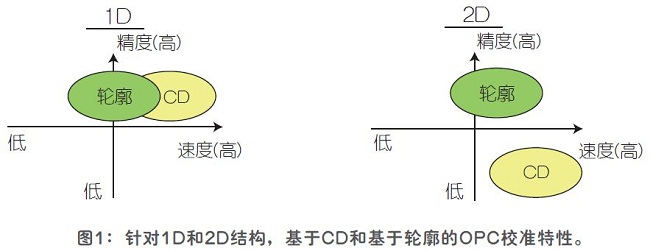 现已开发出兼具CD测量与SEM轮廓的混合技术,它能提供更精确的OPC模型,减少OPC校准的运行时间。SEM轮廓用于2D,而CD点则提供了高精度的1D测量。为保持这种1D的精度,可采用混合的校准技术,在OPC校准中同时包含CD与SEM轮廓。很多文献(参考文献1、2)都讨论了采用混合技术校准方法的优点与挑战。 Calibre ContourCal的加权功能 1D结构使用CD测量,而2D结构使用SEM轮廓。Calibre ContourCal的加权功能可针对CD测量和轮廓分别设定,见图2。每次OPC校准运行时,加权参数可以设为0至1.0的变量,步长为0.1。式(1)用于计算CDerror。而所有OPC建模结构的ErmsCD计算则用式(2)。 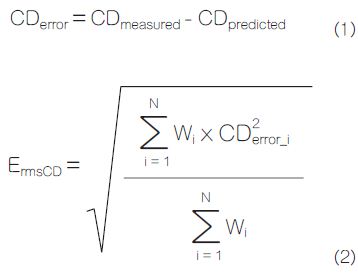 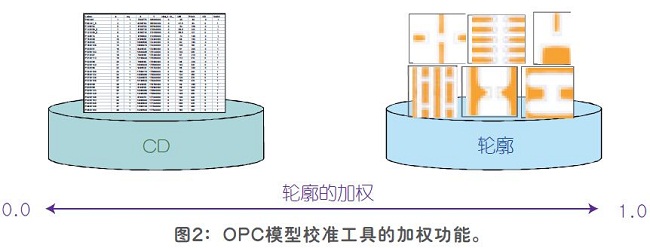 轮廓误差的计算是通过比较SEM轮廓与OPC模型的预测轮廓进行的,如图3所示(参考文献3)。首先,在Calibre ContourCal上将预测轮廓与SEM轮廓对准。对SEM轮廓的每个点,SEM轮廓都能在预测轮廓上找到最接近的点,反之从预测轮廓到SEM轮廓也是一样。预测轮廓与SEM轮廓之间的距离Di由式(3)确定。所有偏差的RMS ErmsContour由(4)式计算。  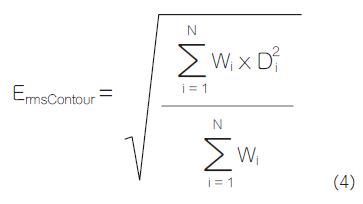 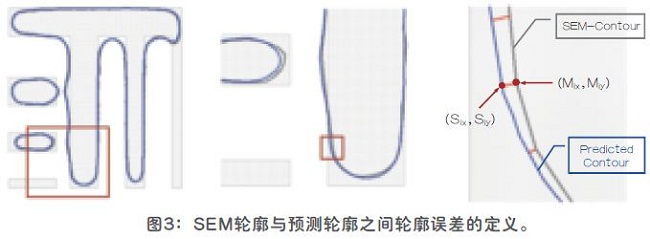 评估OPC模型质量的实验方法OPC模型的校准与验证结构 imec(校际微电子研究中心)采用一个6%衰减的相移掩模(PSM)测试掩模原版(reticle),用ASML XT:1900Gi做了一个晶圆的曝光(使用NA=135,σouter/σinner=0.96/0.60,XY极化的cQuad20照明)。我们定义了一个积极的22nm随机逻辑多模型的结构集,它包括了不同结构的最大变化,选自于数量有限的结构。校准数据包括63个CD和228个轮廓块。验证数据包括227个CD和136个轮廓块。CD数据在多种跨节距密线(through pitch dense line)、2杆和3杆结构上进行测量。图4给出了用于OPC建模的一些2D结构的例子。 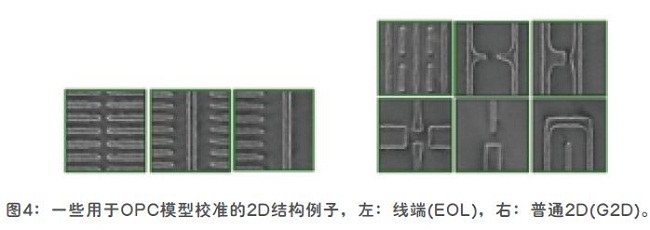 晶圆与掩模轮廓提取流程 图5给出了基于设计的计量综合系统,用于包含CG4500(掩模CD-SEM)、CG4100 (晶圆CD-SEM),以及RecipeDirector的SEM图像轮廓提取。RecipeDirector用于自动地创建CD-SEM配方(recipe), 而DesignGauge-Analyzer则用于创建SEM轮廓。首先,要准备OPC建模的设计数据,以及包含有测量信息的HSS (日立数据表)。把设计数据与HSS输入到RecipeDirector中,就自动生成了CD-SEM配方。然后,CD-SEM配方被输出给CG4500和CG4100。用FSE(精密SEM边缘)功能获取SEM图像。最后,获得的SEM图像被输出给DesignGauge-Analyzer。然后,用相同算法,从掩模SEM图像和晶圆SEM图像中提取出SEM轮廓。  在SEM轮廓提取的同时, DesignGauge-Analyzer中完成SEM轮廓的对准与均化。在对准与均化以后,可以将晶圆SEM轮廓创建为MBAC(基于测量的平均轮廓),而MBAC以GDSII格式,送入Mentor Graphics模型校准流程。另一方面,掩模SEM轮廓则创建为全景型FOV(视场)的MBC(基于测量的轮廓),同样,MBC以GDSII格式送入Mentor Graphics模型校准流程。 OPC校准与验证流程 OPC模型由CD测量数据、晶圆MBAC及2D全景掩模MBC进行校准,2D全景掩模MBC用来代替表2所示的设计数据。  图6给出了实验流程。首先,由CG4500和CG4100获得的SEM图像,用DesignGauge-Analyzer(日立高新技术)创建1D CD测量、2D晶圆MBAC以及2D掩模MBC,并输入到Calibre ContourCal(Mentor Graphics)中。其次,使用Calibration数据集,做OPC模型的校准。在本次研究中,权重W的选择范围从0.1至0.9,输出9个OPC模型。然后用9个校准后的模型,为验证结构生成预测轮廓。再次,获取验证结构的SEM图像,并为验证结构生成验证MBAC。最后,为了比较模型的质量,用CD和轮廓验证数据集做9个OPC模型拟合良好性的评估。验证的权重设为恒定的W=0.5。另一方面,每个预测轮廓拐角拟合要与验证MBAC作比较。  实验建模的结果OPC模型校准结果 OPC模型的校准结果见附图1,OPC模型的验证结果见附图2。在这些附图中, 蓝线代表CD errRMS,红线代表轮廓errRMS。  在OPC模型校准和验证结果中,轮廓施加较高权重有助于改善轮廓的errRMS, 但本实验并未确认CD errRMS与权重之间的相关性。此现象可解释为,本实验使用无CD偏移的轮廓。由于自顶向下的CD 与所提取SEM轮廓测得的CD值之间的偏差小到可忽略不计,即使采用了较大的权重,CD errRMS也几乎不受影响。 本实验建模中还可以确认,0.6至0.7 的权重可提供良好的CD与轮廓errRMS。 结论 本文研究了加权功能在OPC建模中的作用。结果证明,具有用先进轮廓提取系统所获轮廓数据的、包含加权功能的混合模型校准是一种有效的方案。这种方案具有良好的2D可预测性,而几乎不影响1D可预测性。本文还确证了采用较高权重可改善拐角的拟合。 由于无CD偏移的轮廓不会影响CD的可预测性,在先进的结点上,采用轮廓做OPC建模即为一种有效而重要的技术。 除OPC建模以外,还有很多应用可以使用SEM轮廓,例如开发光刻工艺。我们相信,先进的SEM轮廓技术应非常适合于开发计算光刻中的LSI制造工艺。 参考文献 1. Y. Granik, I. Kusnadi, “Challenges of OPC Model Calibration from SEM Contours”, Proc. of SPIE 6922, 69221H- 1 (2008) 2. P. Filitchkin, T. Do, I. Kusunadi, J.L. Sturtevant, P. De Bisschop, J. Van de Kerkhove, “Contour Quality Assessment for OPC Model Calibration”, Proc. of SPIE 7272, 72722Q-1-7 (2009) 3. D. Hibino, H. Shindo, Y. Abe, Y. Hojyo, G. Fenger, T. Do, I. Kusnadi, J.L. Sturtevant, P. De Bisschop, J. Van de Kerkhove, “High accuracy OPC-modeling by using Advanced CD-SEM Based Contours in the next generation lithography”, Proc. of SPIE 7638, 76381X-1-11 (2010) 4. T. Shibahara, T. Minakawa, M. Oikawa, H. Shindo, H. Sugahara, Y. Hojyo “A CD-gap-free contour extraction technique for OPC model calibration”, Metrology, Inspection, and Process Control for Microlithography XXV,Proc. of SPIE 7971, 79710O-1-8 (2011) 5. D. Hibino, H. Shindo, Y. Hojyo, T. Do, Aasutosh Dave, Timothy Lin, I. Kusnadi, J. L. Sturtevant, “The assessment of the impact of mask pattern shape variation on the OPC-modeling by using SEM-Contours from wafer and mask”, Proc. of SPIE 7971, 79712G-1-9 (2011) |







网友评论