ЖржиЭМАИЮЂгАММЪѕЕФЮДРДЗЂеЙЧАОА
ЗЂВМЪБМфЃК2013-10-17 14:04
ЗЂВМепЃКeechina
|
зїепЃКУїЕМИпМЖЮяРэбщжЄЗНЗЈЯюФПОРэDavid Abercrombie дјОЃЌЮвЛЈСЫДѓСПЪБМфЬИТлЫЋжиЭМАИЮЂгАММЪѕЁЃЮвШЯЮЊЪЧЪБКђПЊЪМеЙЭћЖржиЭМАИЮЂгАЕФЗЂеЙЧАОАСЫЃЈВЛвЊОЊЛХЃЁЃЉЁЃе§ШчФњПЩФмЬ§Й§ЛђепЖСЙ§ЕФвЛбљЃЌМЋзЯЭтЙтЮЂгА(EUV Lithography)ММЪѕЫЦКѕИЯВЛЩЯ10nmНкЕуЕФНјЖШЃЌЩѕжСЮоЗЈДяЕН7nmЁЃетвтЮЖзХЮЊСЫБЃГжаавЕЯђЧАЗЂеЙЃЌБиаыВЩгУЬцДњаЭЗНЗЈРДЭиеЙЯжгаЕФЮЂгАЙЄОпМЏЁЃ 20nmЙЄвеНкЕуЪзДЮЯђЩшМЦНчЭЦГіСЫЖржиЭМАИЮЂгАММЪѕЁЃЛюадВуЁЂНгДЅВуЁЂЙ§ПзВуКЭЯТУцЕФН№ЪєВуПЊЪМдкетИіНкЕуРћгУЫЋЮЂгАЪДПЬ(LELE)МфОрЗжИюЗЈЫЋжиЭМАИЮЂгА(DP)ЙЄвеЁЃетОЭЪЧЮвЕФЫљгаЦфЫќВЉПЭЬИТлЕФDPЙЄвеСїГЬЁЃLELEашвЊНЋDPВуЗжИюЃЈЗжРыЃЉГЩСНИіЙтежНјааЩњВњжЦдьЁЃдквЛаЉОЇдВГЇЃЌЩшМЦЪІашвЊаЮГЩетСНИіЗжРыЕФЙтежВуЃЌетЪЧОЇдВГЇСїЦЌЙЄвеЕФвЛВПЗжЁЃдкЦфЫќОЇдВГЇЃЌЩшМЦЪІЮоашНјааЗжРыЃЌЕЋЪЧЫћУЧНјаабЯИёВПЪ№ЪББиаыНјаазЈУХЕФЫЋжиЭМАИЮЂгАМьВщЃЌШЗБЃЕБЩшМЦдкОЇдВГЇСїЦЌЪБФмЙЛНјааЫЋВуЗжРыЁЃЮоТлФФжжЧщПіЃЌЩшМЦЪІЖМБиаыНјаагыетаЉНЋвЊЗжРыГЩСНИіЙтежЕФВуЯрЙиЕФШЮЮёЃЌЖјжЎЧАЕФНкЕуВЂВЛашвЊетаЉСїГЬЁЃ гаШЄЕФЪЧ20nmЙЄвеНкЕуЕФЖрОЇЙшЃЈУХЃЉВувВЪЙгУСНИіЙтежЃЌЕЋЪЧЗжРыЕФЗНЪНгыЦфЫќDPВуЫљашЕФLELEСїГЬВЛЭЌЁЃЫќЪЙгУвЛИіЯпЬѕ/ЧаИюСїГЬЁЃЖрОЇЙшВуБиаыбЯИёАќКЌЕЅЯђдЫааЯпТЗЁЃетаЉЯпЬѕШЋВПЪЙгУЕквЛИіЁАЯпЬѕЁБЙтежЖЈвхЁЃЮоТлЯпЬѕРяФФЖљгаПеЯЖЃЈМфИєЃЉЃЌдђЪЙгУЕкЖўИіЁАЧаИюЁБЙтежРДЖЈвхетаЉПеЯЖЁЃЭМвЛЪЧетИіЯпЬѕ/ЧаИюЫЋЙтежЗжРыСїГЬЕФЪОР§ЁЃ 
ЭМ1ЃКЯпЬѕ/ЧаИюЫЋЙтежЗжРыСїГЬЪОР§ етИіЙЄвеЩшМЦШЫдБПДВЛЕНЃЌвђЮЊЫћУЧВЛЛетСНИіЙтежЛђепЖдетИіСїГЬНјааШЮКЮРраЭЕФЬиЪтЗжРыМьВщЁЃбЯИёЕФЗжВуЩшМЦЙцдђШЗБЃдкОЇдВГЇЩњГЩетСНИіЙтежГЩЮЊПЩФмЁЃвђЮЊетИіЫЋжиЭМАИЮЂгАЩшМЦЪІИљБОПДВЛМћЃЌвђДЫФуКмЩйЬ§ЕНгаШЫЬИМАЁЃ дкЖржиЭМАИЮЂгАЗНУцЃЌ16/14nmММЪѕНкЕуЕФЧщПіЫЦКѕгы20nmНкЕуЗЧГЃЯрЫЦЁЃетжжвЛжТаджївЊгЩгкетИіНкЕуВЂЗЧДг20nmеце§ЫѕжС16/14nmЁЃФкВПСЌНгВуИњ20nmвЛбљЃЌвђДЫЯрЭЌЕФDPСїГЬПЩвдгУгкЩњВњЫћУЧЁЃЮЈвЛживЊЕФБфЛЏЪЧаТЕФfinFETОЇЬхЙмЃЌЫќВЛНіЪЧвЛИіаТаЭЕФОЇЬхЙмЖјЧвГпДчгаЫљЫѕаЁЁЃГ§СЫЛюадВуКЭЖрОЇЙшВужЎЭтЃЌетИіОЇЬхЙмашвЊвЛИіШЋаТЕФВуЃЈРпЦЌВу ЃЉЁЃРпЦЌВуБОжЪЩЯЪЧвЛЯЕСагыЖрОЇЙшВуДЙжБЕФЦНааЯпЁЃЪТЪЕжЄУїетаЉЯпЬѕЕФЧПЖШЃЈЯпЬѕ/МфИєЃЉЛЙашвЊвЛаЉDPРраЭНјааЩњВњЁЃОЇдВГЇЭЦГіСЫвЛПюаТЕФDPЙЄвеspacer-is-mask(МђГЦЁАSIMЁБ)ЃЌЫќЪЧвЛжжздЖЏаЃзМЫЋжиЭМАИЮЂгАММЪѕЁЃгыLELEМфОрЗжИюКЭЯпЬѕ/ЧаИюЙЄвеРрЫЦЃЌSIMвВашвЊСНИіЙтежНјааЩњВњЃЌЕЋЪЧЙЄвегыLELEЛђепЯпЬѕ/ЧаИюЫЋжиЭМАИЮЂгАММЪѕгаКмДѓВЛЭЌЁЃЭМ2ЪЧSIMСїГЬЕФвЛИіЪОР§ЁЃ 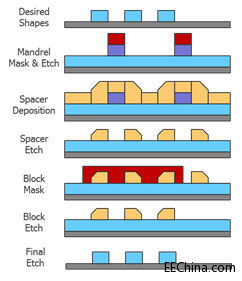
ЭМ2ЃКгУгкРпЦЌВуЕФSIM SADPЙЄвеСїГЬЪОР§ е§ШчФудкЙЄвеСїГЬЭМЩЯПДЕНЕФвЛбљЃЌСНИіЙтежЃЈЁАаФжсЁБКЭЁАекЕВЁБЃЉПДЦ№РДКЭзїЮЊЩшМЦЪІВМОжВнЭМвЛВПЗжЕФзюжеРэЯыаЮзДМЋЮЊВЛЭЌЁЃетжжВювьЪЧвђЮЊзюжеаЮзДВЂВЛЪЧжБНггЩЙтежаЮзДНчЖЈЁЃИєРыВуГСЛ§КЭЪДПЬжЎМфЕФВаВюаЮГЩСЫзюжеЕФЁАЙтежЁБФЃЪНЁЃавдЫЕФЪЧЃЌЖдгкНјаа16/14nmВМОжЕФЩшМЦЪІЖјбдЃЌећИівЛДњРпЦЌВуЪЧвўВиЕФЁЃЩшМЦЪІжЛашЛГіДЋЭГЕФжїЖЏЧјКЭЗЧжїЖЏЧјЃЈЁАеЄМЋЁБЃЉВуЁЃОЁЙмдквдЧАНкЕужаУЛГіЯжЕФетаЉВугаЦфЫќЯожЦЃЌетаЉжїЖЏЧјВужЛФмЪЧВЛЭЌГЄЖШЕФРыЩЂЕЅдЊЃЌетаЉЯожЦИљОнДЋЭГЕФЩшМЦЙцдђЪЕЪЉЁЃетаЉбЯИёЪмЯоЕФВМОжВуЯожЦШЗБЃСЫОЇдВГЇФмЙЛЧсЫЩЕМГіЭъГЩаТОЇЬхЙмНсЙЙЫљашЕФЯргІРпЦЌВуЁЃ жСгк10nmЙЄвеНкЕуЃЌЖржиЭМАИЕФБфЛЏВЂВЛРћгкЩшМЦЪІЁЃГ§СЫ16/14nmжаЪЙгУЕФЫљгаММЪѕЃЌ10nmНкЕуДјРДСЫжСЩйСНИіаТЕФЖржиЭМАИММЪѕЁЃЕквЛИіММЪѕЪЧШ§жиЫЋЮЂгАЪДПЬМфОрЗжИюЗЈШ§жиЭМАИЮЂгАЙЄвеЁЃЪЧЕФЃЌСНИіВЛЙЛЕФЪБКђЃЌЮЊЪВУДВЛгУШ§ИіФиЃПетИіЙЄвегы20/16/14nmжаЪЙгУЕФЫЋЮЂгАЪДПЬМфОрЗжИюЗЈЙЄвеЪЎЗжРрЫЦЃЌГ§СЫШ§жиЭМАИЮЂгАЙЄвеашвЊдЪМВудкШ§ИіВЛЭЌЕФЙтежжаЗжНтетЕуЁЃгыЫЋжиЭМАИЮЂгАЙЄвевЛбљЃЌЕБФуНсКЯШ§ИіЙтежжаЕФЫљгааЮзДЪБЃЌЫќПДЦ№РДгжЯёдЪМЕФЕЅВуСЫЁЃШ§жиЭМАИЮЂгАЙЄвеПЩгУгкНгДЅЁЂдйЗжХфЛЅСЊКЭ/ЛђM1етбљЕФВуЁЃЭМ3ЯдЪОСЫШ§жиЭМАИЮЂгАЙЄвеЗжНтЪОР§ЁЃ 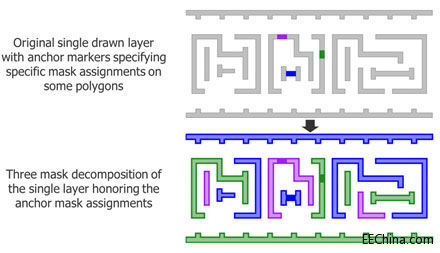
ЭМ3ЃКШ§ИіЙтежШ§жиЭМАИЮЂгАЙЄвеЗжНт гЩгкетИіЙЄвеРрЫЦгк20/16/14nmЫЋжиЭМАИЮЂгАЙЄвеЃЌЩшМЦЪІПЩФмЛсЗЂЯжКмЖрРрЫЦжЎДІЃЌетЛсЪЙзЊБфЕНШ§жиЭМАИЮЂгАЙЄвеИќШнвзЁЃМДЪЙЪЧЪЙгУЗьКЯетбљЕФЙЬЖЈНтОіЗНАИЃЌЖдгкетИіЙЄвеЖјбдРэТлЩЯвВЪЧПЩааЕФЁЃЭМ4ЯдЪОСЫвЛИіВМОжЪОР§ЃЌетИіВМОждкШ§ИіЙтежжаВЛФмздШЛЗжНтЃЌЕЋПЩвдЭЈЙ§РћгУЗьКЯГЩЙІЗжНтЁЃ 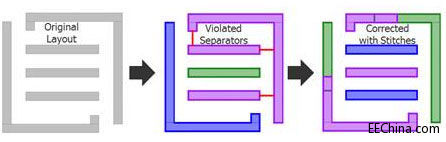
ЭМ4ЃКШ§жиЭМАИЮЂгАЙЄвеЗжНтДэЮѓРћгУЗьКЯНјааОРе§ ОЁЙмШ§жиЭМАИЮЂгАКЭЫЋжигаЯрЫЦжЎДІЃЌЕЋвВгаКмЖрВЛЭЌЃЌвђДЫЖдЩшМЦЪІЁЂДњЙЄГЇКЭЕчзгЩшМЦздЖЏЛЏЙЄОпЖјбдДјРДСЫОоДѓЕФЬєеНЁЃЮвНЋдкНёКѓЕФЮФеТКѓЯъЯИНщЩметаЉЬєеНЁЃ 10nmЙЄвевВДјРДСЫSIDАцSADPЃЌетПЩгУгкВПЗжН№ЪєЛЅСЊВуЁЃе§ШчSIMАцSADPгУгк16/14nmЙЄвевЛбљЃЌетСНИіЙтежКЭВМОжжадЪМВнЭМаЮзДВЛвЛбљЃЌЕЋРћгУСЫИєРыВуГСЛ§КЭЪДПЬжЎМфЕФВаВюРДНчЖЈаЮзДЁЃЕЋдкSIDАцSADPжаЃЌИєРыВуВЂВЛНчЖЈааЪ§ЃЌЖјЪЧааЪ§жЎМфЕФМфОрЁЃЭМ5ЯдЪОСЫРћгУSIDАцSADPЕФН№ЪєЙЄвеЪОР§ЁЃ 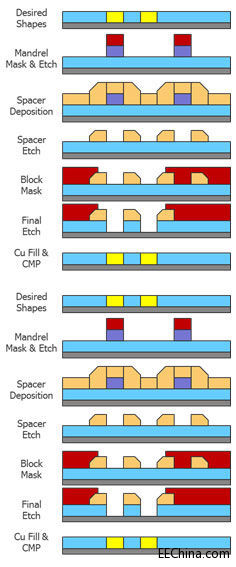
ЭМ5ЃКгУгкН№ЪєЛЅСЊВуЕФSID SADPЙЄвеЁЃ гыгУгк16/14nmРпЦЌВуЕФSIM SADPЙЄвеВЛЭЌЃЌИќИДдгЕФЫЋЯђВуЃЈР§ШчН№ЪєЛЅСЊВуЃЉЫљВЩгУЕФSID SADPЙЄвеЖдгкЩшМЦЪІЖјбдЪЧВЛШнКіЪгЕФЁЃетЯюЙЄвеНЋашвЊЩшМЦЪІСЫНтВЂЪЪгІвЛаЉаТвЊЧѓЁЃДЫЭтвВИјОЇдВДњЙЄКЭEDAЙЄОпДјРДСЫаТЕФЬєеНЁЃБ№ЕЃаФЁЊЁЊЮвдкНгЯТРДЕФЮФеТжаНЋНјвЛВНЬжТлетаЉЬєеНЁЃЯждкЃЌШУЮвУЧМђЕЅРДПДПДвЛИіН№ЪєВМОжЪОР§вдМАЫќШчКЮЗжНтГЩСНИіЙтежЃЈЭМ6ЃЉЁЃ 
ЭМ6ЃКН№ЪєВМОжЗжНтГЩSID SADPЕФСНИіЙтежЁЃ ДгетИіЪОР§жаПЩвдПДГіЙтежЗжНтЙ§ГЬЗжЮЊШ§ИіжївЊВНжшЃК дЪМЕФЕЅВуБЛВ№ЗжЮЊСНжжЁАбеЩЋЁБЁЊЁЊаФжсКЭЮоаФжсЁЃ аТдіЕФЁАащФтаФжсЁБЖрБпаЮБЛЗжХфИјаФжсбеЩЋЁЃзюжеЕФаФжсКЭащФтаФжсаЮзДзщКЯаЮГЩЕквЛИіЁАаФжсЙтежЁБЁЃ аЮГЩЕФБЃГжВузюжеНЋЕЙзЊЙ§РДЃЌаЮГЩзюжеЕФЁАекЕВЙтежЁБЁЃЯждкРДПДЃЌаФжсКЭекЕВЙтежШчКЮаЮГЩРрЫЦОЇдВдЪМЕМГіВуЕФЖЋЮїПЩФмЛЙВЛУїЯдЃЌЕЋЯраХЮвЃЌЫќПЩвдЕФЁЃЮвУЧНЋдкСэвЛЦЊЮФеТжаЛЈИќЖрЪБМфРДНщЩметИіЙ§ГЬЁЃ ЮвжЛЯыЫЕЃЌШчЙћФњЯывЊзХЪжНјааШЮКЮ10nmЩшМЦЙЄзїЃЌФњПЩФмашвЊдйбЇЯАвЛаЉгаЙиЖржиЭМАИЮЂгАЕФжЊЪЖЁЃКмавдЫЃЌЮвПЩвдЮЊФњХХгЧНтФбЁЃжСЩйЃЌЙигкПЩдЄМћЕФЮДРДЃЌЮвгаКмЖрЯыЗЈПЩвдгыФњЗжЯэЃЁЮвЦкД§АяжњФњЭъГЩетИібЇЯАЕФЙ§ГЬЁЃЯждкЃЌШУЮвРДМђЕЅИХРЈвЛЯТЖржиЭМАИЮЂгАСьгђУПИіЙЄвеНкЕуЕФЯрЙижЊЪЖЁЃ Ёё20nmЃК гУгкЖрОЇВуЕФЯпЬѕ/ЧаИюЫЋЙтежЙЄвеЃЈЖдЩшМЦЪІЮогАЯьЃЉ гУгкЛюадВуЁЂНгДЅВуЁЂЭЈПзВуКЭН№ЪєВуЕФLELE DPЙЄвеЃЈЖдЩшМЦЪІгагАЯьЃЉ Ёё16nmЃК гУгкРпЦЌВуЕФSIM SADPЃЈЖдЩшМЦЪІЮогАЯьЃЉ Ёё10nmЃК гУгквЛаЉНгДЅВуКЭЛЅСЊВуЕФLELELE TPЙЄвеЃЈЖдЩшМЦЪІгагАЯьЃЉ гУгквЛаЉН№ЪєЛЅСЊВуЕФSID SADPЃЈЖдЩшМЦЪІгагАЯьЃЉ |


ЭјгбЦРТл