博客
ESD/EOS管控对IC封装测试端的行业价值产出
||
1. IC封装测试阶段是IC最ESD最为敏感的
1>IC中的晶片(Die)从Wafer中分切出来,失去了原有Wafer级的ESD保护;
2>晶片在进行封装中,与封装体会发生必然的ESD事件;
3>IC封装后的功能测试,易于遭受ESD与EOS的双重侵袭。
2. 部分业内IC封装测试阶段的ESD/EOS解决实例
2.1 IC在自动测试中的ESD损坏解决
ESD背景:IC封测厂收到客户的IC(Low Pass Filter,低通滤波器)品质(Insertion Loss Failure,插入损失失效)投诉,IC封测厂追溯分析发现来自于单一测试机的ESD不良(10#管脚对地击穿)达1.8%。
IC ESD损坏分析与解决:此IC ESD敏感度较高(CDM耐压值仅为125V),IC在自动装入测试机测试插座中产生高静电,在装入插座中即发生CDM放电。ESD解决措施为调整IC装载处的离子化安装,将衰减时间缩短是3秒以内,IC的ESD不良率降至0.03%以下。
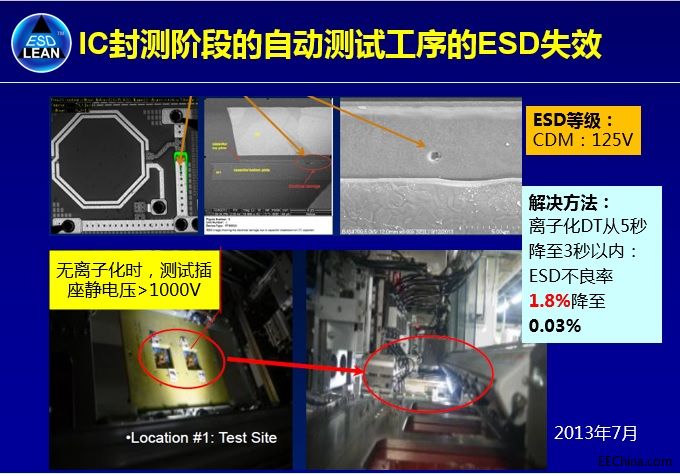
1>IC中的晶片(Die)从Wafer中分切出来,失去了原有Wafer级的ESD保护;
2>晶片在进行封装中,与封装体会发生必然的ESD事件;
3>IC封装后的功能测试,易于遭受ESD与EOS的双重侵袭。
2. 部分业内IC封装测试阶段的ESD/EOS解决实例
2.1 IC在自动测试中的ESD损坏解决
ESD背景:IC封测厂收到客户的IC(Low Pass Filter,低通滤波器)品质(Insertion Loss Failure,插入损失失效)投诉,IC封测厂追溯分析发现来自于单一测试机的ESD不良(10#管脚对地击穿)达1.8%。
IC ESD损坏分析与解决:此IC ESD敏感度较高(CDM耐压值仅为125V),IC在自动装入测试机测试插座中产生高静电,在装入插座中即发生CDM放电。ESD解决措施为调整IC装载处的离子化安装,将衰减时间缩短是3秒以内,IC的ESD不良率降至0.03%以下。